基本介紹
- 中文名:刻蝕技術
- 外文名:etching technique
- 用途:在半導體工藝
- 技術:X射線刻蝕、電子束刻蝕等
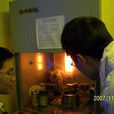
刻蝕技術(etching technique),是在半導體工藝,按照掩模圖形或設計要求對半導體襯底表面或表面覆蓋薄膜進行選擇性腐蝕或剝離的技術。刻蝕技術不僅是半導體器件和積體電路...
刻蝕技術主要分為乾法刻蝕與濕法刻蝕。乾法刻蝕主要利用反應氣體與電漿進行刻蝕;濕法刻蝕主要利用化學試劑與被刻蝕材料發生化學反應進行刻蝕。...
刻蝕,英文為Etch,它是半導體製造工藝,微電子IC製造工藝以及微納製造工藝中的一種相當重要的步驟。是與光刻相聯繫的圖形化(pattern)處理的一種主要工藝。所謂刻蝕,...
積體電路製造中利用光學- 化學反應原理和化學、物理刻蝕方法,將電路圖形傳遞到單晶表面或介質層上,形成有效圖形視窗或功能圖形的工藝技術。隨著半導體技術的發展,光刻...
乾法刻蝕是用電漿進行薄膜刻蝕的技術。當氣體以電漿形式存在時,它具備兩個特點:一方面電漿中的這些氣體化學活性比常態下時要強很多,根據被刻蝕材料的不...
凍刻蝕技術(freeze-etching technique)是透射電子顯微鏡觀察用試樣的制樣法之一。該法的特點是能較好地保持含水樣品如生物組織的自然狀態。在常壓下將樣品在-150℃...
等離子刻蝕機,又叫等離子蝕刻機、等離子平面刻蝕機、電漿刻蝕機、等離子表面處理儀、等離子清洗系統等。等離子刻蝕,是乾法刻蝕中最常見的一種形式,其原理是暴露在...
反應離子腐蝕技術是一種各向異性很強、選擇性高的乾法腐蝕技術。它是在真空系統中利用分子氣體等離子來進行刻蝕的,利用了離子誘導化學反應來實現各向異性刻蝕,即是...
刻蝕設備的發展和光刻技術,互連技術密切相關。High K / Low K材料,銅互連,Metal Gate,double Pattern等技術的發展都對刻蝕設備提出了新的需求·...
深電漿刻蝕,也稱大深寬比刻蝕(High Aspect Ratio Etching,HARE),一般是選用Si作為刻蝕微結構的加工對象,它有別於VLSI 中的矽刻蝕,因此又稱為先進矽刻蝕(...
刻蝕選擇比指的是在同一刻蝕條件下一種材料與另一種材料相對刻蝕速率快慢。它定義為被刻蝕材料的刻蝕速率與另一種材料的刻蝕速率的比(圖1)。...
薄膜刻蝕技術是一種使用物理或化學的方法使薄膜材料消蝕的技術。...... 薄膜刻蝕技術是一種使用物理或化學的方法使薄膜材料消蝕的技術。中文名 薄膜刻蝕技術 主題詞...
刻蝕修飾法是在定向自組裝工藝中實現中性襯底中部分區域非中性化的一種手段。...... 刻蝕修飾法是在定向自組裝工藝中實現中性襯底中部分區域非中性化的一種手段。...
離子束刻蝕也稱為離子銑,是指當定向高能離子向固體靶撞擊時,能量從入射離子轉移到固體表面原子上,如果固體表面原子間結合能低於入射離子能量時,固體表面原子就會被...
中文名稱 離子刻蝕 英文名稱 ion etching 定義 利用離子轟擊作用,對材料表面進行刻蝕的過程。 套用學科 材料科學技術(一級學科),材料科學技術基礎(二級學科),...
中文名稱 各向同性刻蝕 英文名稱 isotropic etching 定義 通常是指不同的結晶學平面呈現出相同腐蝕速率的腐蝕方法。 套用學科 材料科學技術(一級學科),半導體材料...
刻蝕剖面指的是被刻蝕圖形的側壁形狀。有兩種基本的刻蝕剖面:各向同性和各向異性刻蝕剖面。各向同性的刻蝕剖面是在所有方向上(橫向和縱向)以相同的刻蝕速率進行刻蝕,...
中文名稱 雷射刻蝕 英文名稱 laser corrosion 定義 採用高能脈衝雷射束在零件表面刻蝕出寬度為10~505m、深度為5~1001m的微細小槽,以改善材料表面潤滑特性的技術...
中文名稱 刻蝕作用 英文名稱 etching 定義 被風吹揚而起的沙粒對岩石和礦物...以上內容由全國科學技術名詞審定委員會審定公布V百科往期回顧 詞條統計 瀏覽次數...
是一種刻蝕方法,主要在較為平整的膜面上刻出絨面,從而增加光程,減少光的反射,刻蝕可用稀釋的鹽酸等 濕法刻蝕是將刻蝕材料浸泡在腐蝕液內進行腐蝕的技術。簡單來...
反應離子腐蝕技術是一種各向異性很強、選擇性高的乾法腐蝕技術。它是在真空系統中利用分子氣體等離子來進行刻蝕的,利用了離子誘導化學反應來實現各向異性刻蝕,即是...
刻蝕偏差是指刻蝕以後線寬或關鍵尺寸間距的變化(見圖1)。它通常是由於橫向鑽刻引起的(見圖2),但也能由刻蝕剖面引起。當刻蝕中要去除掩模下過量的材料時,會...
由較大範圍刻蝕夷平面或多個刻蝕夷平面相連結而形成的平地。常套用於地理學(一級學科)、地貌學(二級學科)。 ...
DRIE,全稱是Deep Reactive Ion Etching,深反應離子刻蝕,一種微電子乾法腐蝕工藝。...... 基於氟基氣體的高深寬比矽刻蝕技術。與反應離子刻蝕原理相同,通過化學作用...
雷射光刻是利用光學-化學反應原理等方法,將電路圖形刻印在介質表面,達到想要的圖形刻意功能的新型微細加工技術。...
MEMS製造工藝(Microfabrication Process)是下至納米尺度,上至毫米尺度微結構加工工藝的通稱。廣義上的MEMS製造工藝,方式十分豐富,幾乎涉及了各種現代加工技術。起源於...
