刻蝕偏差是指刻蝕以後線寬或關鍵尺寸間距的變化(見圖1)。它通常是由於橫向鑽刻引起的(見圖2),但也能由刻蝕剖面引起。當刻蝕中要去除掩模下過量的材料時,會引起被刻蝕材料的表面向光刻膠邊緣凹進去,這樣就會產生橫向鑽刻。
基本介紹
- 中文名:刻蝕偏差
- 外文名:Etch Bias
刻蝕偏差是指刻蝕以後線寬或關鍵尺寸間距的變化(見圖1)。它通常是由於橫向鑽刻引起的(見圖2),但也能由刻蝕剖面引起。當刻蝕中要去除掩模下過量的材料時,會引起被刻蝕材料的表面向光刻膠邊緣凹進去,這樣就會產生橫向鑽刻。計算刻蝕偏差的公式如下:
刻蝕偏差=Wb-Wa
其中,Wb=刻蝕前光刻膠的線寬
Wa=光刻膠去掉後被刻蝕材料的線寬
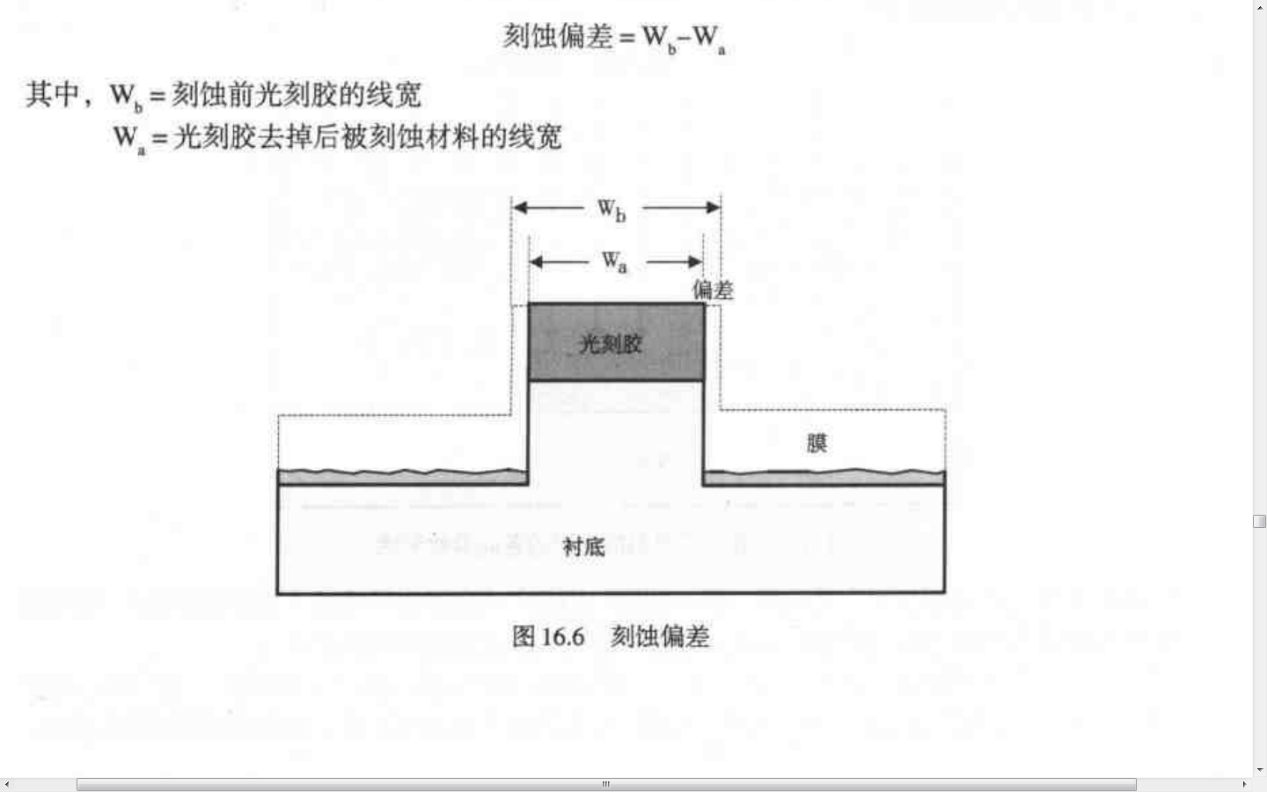
圖1 刻蝕偏差
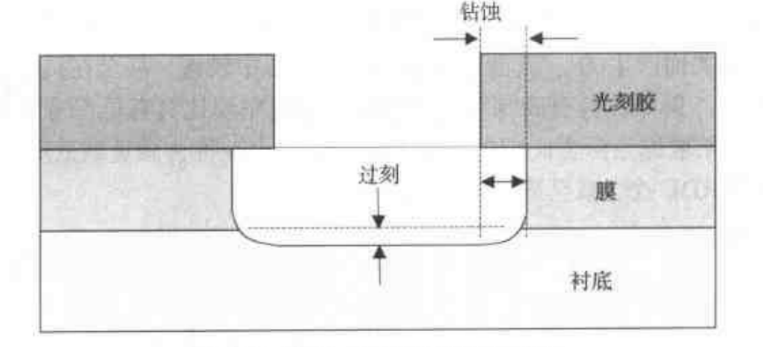
圖2 刻蝕中的橫向鑽刻和傾斜
刻蝕偏差的大小與很多因素有關:襯底材料、光刻膠上圖形的線寬、刻蝕工藝的參數等。目前額做法是對版圖上所有的邊緣添加(或減去)一個固定的線寬,被稱為全片刻蝕偏差(global etch bias)。顯然,這樣的做法比較粗糙,設有顧及刻蝕偏差是與光刻膠上的線寬有關的。精確地做法是,建立一個刻蝕的模型,首先對設計的版圖做修正;然後,在做光刻的OPC修正,如圖2所示。刻蝕修正可以使用模型,也可以是一些規則(類似於rules-based OPC)。也有嘗試把刻蝕修正與光學修正合成在一起的。
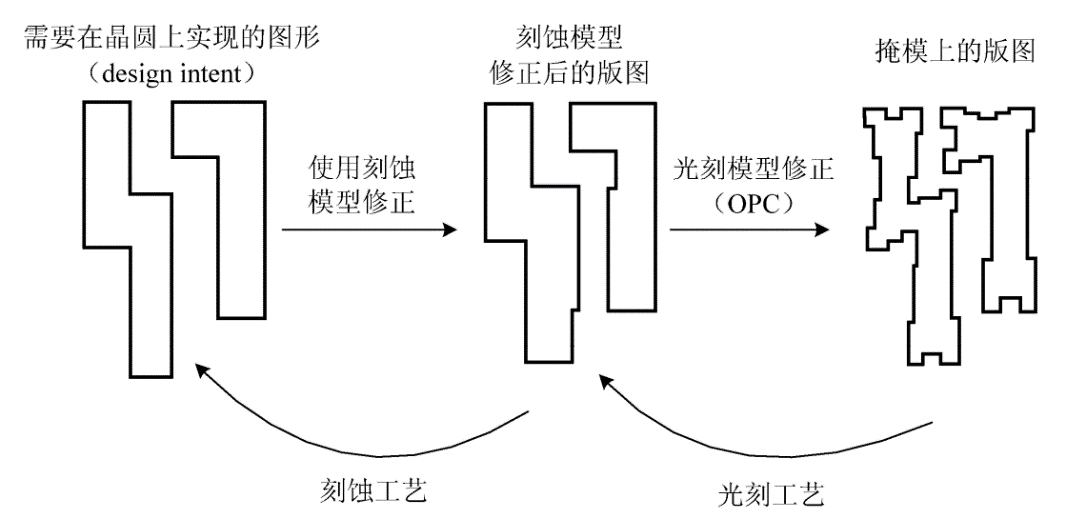
圖2 先做刻蝕修正,在做OPC修正的流程圖