產品介紹
原理
感應耦合電漿刻蝕法(Inductively Coupled Plasma Etch,簡稱ICPE)是化學過程和物理過程共同作用的結果。它的基本原理是在真空低氣壓下,ICP 射頻電源產生的射頻輸出到環形耦合線圈,以一定比例的混合刻蝕氣體經耦合
輝光放電,產生高密度的
電漿,在下電極的RF 射頻作用下,這些電漿對基片表面進行轟擊,基片圖形區域的半導體材料的
化學鍵被打斷,與刻蝕氣體生成揮發性物質,以氣體形式脫離基片,從真空管路被抽走。
結構
ICP 設備主要包括預真空室、刻蝕腔、供氣系統和真空系統四部分。
(1)預真空室
預真空室的作用是確保刻蝕腔內維持在設定的真空度,不受外界環境(如:粉塵、水汽)的影響,將危險性氣體與潔淨廠房隔離開來。它由蓋板、機械手、傳動機構、隔離門等組成。
(2)刻蝕腔體
刻蝕腔體是ICP 刻蝕設備的核心結構,它對刻蝕速率、刻蝕的垂直度以及粗糙度都有直接的影響。刻蝕腔的主要組成有:上電極、ICP 射頻單元、RF 射頻單元、下電極系統、控溫系統等組成。
(3)供氣系統
供氣系統是向刻蝕腔體輸送各種刻蝕氣體,通過壓力控制器(PC)和質量流量控制器(MFC)精準的控制氣體的流速和流量。氣體供應系統由氣源瓶、氣體輸送管道、控制系統、混合單元等組成。
(4)真空系統
真空系統有兩套,分別用於預真空室和刻蝕腔體。預真空室由機械泵單獨抽真空,只有在預真空室真空度達到設定值時,才能打開隔離門,進行傳送片。刻蝕腔體的真空由機械泵和分子泵共同提供,刻蝕腔體反應生成的氣體也由真空系統排空。
影響因素
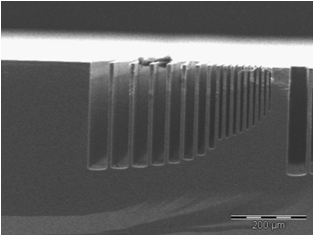 刻蝕率
刻蝕率–氣壓(Pressure)。
–溫度(Temperature)提高溫度會提高
刻蝕率。
–Micro-loading
–刻蝕後腐蝕(Post-etch corrosion)。
–殘留物(residual)。
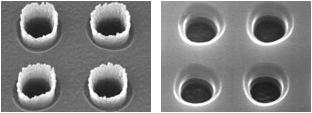 殘留物
殘留物缺點
1、 矽片水平運行,機片高(等離子
刻蝕去
PSG槽式浸泡甩乾,矽片受衝擊小);
2、下料吸筆易污染矽片(等離子刻蝕去PSG後甩乾);
3、傳動滾軸易變形(PVDF,PP材質且水平放置易變形);
4、成本高(化學品刻蝕代替等離子刻蝕成本增加)。
此外,有些等離子刻蝕機,如SCE等離子刻蝕機還具備“綠色”優勢:無
氟氯化碳和污水、操作和環境安全、排除有毒和腐蝕性的液體。
SCE等離子刻蝕機支持以下四種平面電漿處理模式:直接模式——基片可以直接放置在電極托架或是底座托架上,以獲得最大的平面
刻蝕效果。
定向模式——需要非等向性刻蝕(anisotropic etching)的基片可以放置在特製的平面托架上。
下游模式——基片可以放置在不帶電托架上,以便取得微小的電漿效果。
定製模式——當平面刻蝕配置不過理想時,特製的電極配置可以提供。
裝片
電漿系統效應的過程轉換成材料的
蝕刻工藝。在待
刻蝕矽片的兩邊,分別放置一片與矽片同樣大小的玻璃
夾板,疊放整齊,用夾具夾緊,確保待刻蝕的矽片中間沒有大的縫隙。將夾具平穩放入反應室的支架上,關好反應室的蓋子。
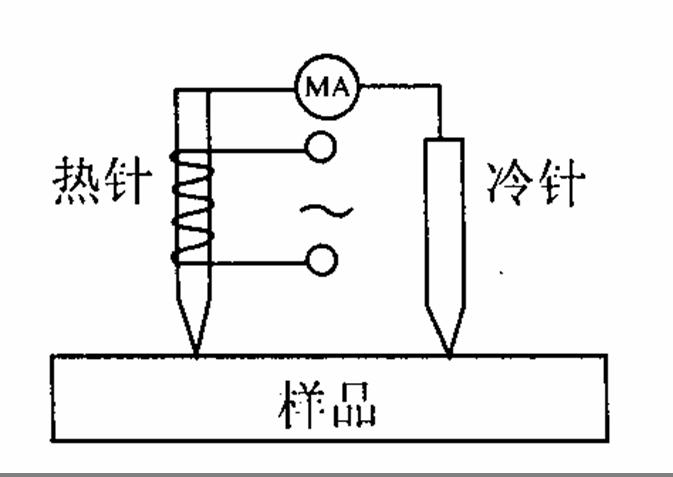 冷熱探針法
冷熱探針法等離子刻蝕檢驗原理為冷熱探針法,具體方法如下:
熱探針和
N型半導體接觸時,傳導電子將流向溫度較低的區域,使得熱探針處電子缺少,因而其
電勢相對於同一材料上的室溫觸點而言將是正的。
同樣道理,
P型半導體熱探針觸點相對於室溫觸點而言將是負的。
此電勢差可以用簡單的微伏表測量。
熱探針的結構可以是將小的熱線圈繞在一個探針的周圍,也可以用小型的電烙鐵。
測量與控制
由於等離子
刻蝕工藝中的過程變數,如
刻蝕率、氣壓、溫度、等離子阻抗,等等,不易測量,因此業界常用的測量方法有:
虛擬測量(Virtual Metrology)
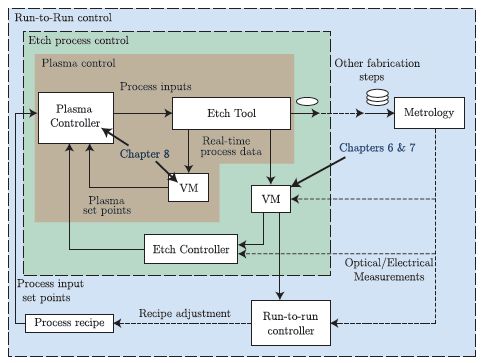 等離子刻蝕過程控制示意圖
等離子刻蝕過程控制示意圖光譜測量(Optical emission spectroscopy)
等離子阻抗監控(Plasma impedance monitoring)
終端探測(end-point detection)
遠程
耦合感測(remote-coupled sensing)
控制方法
run-to-run 控制(R2R)
操作及判斷
2.冷探針連線電壓表的正電極,熱探針與電壓表的負極相連。
3.用冷、熱探針接觸矽片一個邊沿不相連的兩個點,電壓表顯示這兩點間的電壓為正值,說明導電類型為P 型,刻蝕合格。相同的方法檢測另外三個邊沿的導電類型是否為P型。
4.如果經過檢驗,任何一個邊沿沒有刻蝕合格,則這一批矽片需要重新裝片,進行刻蝕。
檢測技術
高密度電漿刻蝕是當今超大規模積體電路製造過程中的關鍵步驟。已經開發出許多終點檢測技術,終點檢測設備就是為實現刻蝕過程的實時監控而設計的。
光學發射
光學發射光譜法(OES)是使用最為廣泛的終點檢測手段。其原理是利用檢測電漿中某種反應性化學基團或揮發性基團所發射波長的光強的變化來實現終點檢測。電漿中的原子或分子被電子激發到激發態後,在返回到另一個能態時,伴隨著這一過程所發射出來的光線。
光線的強度變化可從反應腔室側壁上的觀測孔進行觀測。不同原子或分子所激發的光波波長各不相同,光線強度的變化反應出電漿中原子或分子濃度的變化。被檢測的波長可能會有兩種變化趨式:一種是在刻蝕終點時, 反應物所發出的光線強度增加;另一種情形是光線強度減弱。
雷射干涉
雷射干涉終點法(IEP)是用雷射光源檢測透明薄膜厚度的變化,當厚度變化停止時,則意味著到達了刻蝕終點。其原理是當雷射垂直入射薄膜表面時,在透明薄膜前被反射的光線與穿透該薄膜後被下層材料反射的光線相互干涉。
預報式檢測
隨著主流半導體工藝技術由0.18 μm 逐漸轉移到0.13 μm工藝,以及最新的90 nm 工藝成功研發及投入使用。半導體器件的特徵尺寸進一步減小,柵氧層的厚度越來越薄。90 nm工藝中,柵氧層的厚度僅為1.2 nm。如果電漿刻蝕工藝控制不好, 則非常容易出現柵氧層的損傷;同時, 所使用的晶片尺寸增至300mm, 暴露在電漿轟擊下的被刻蝕面積不斷縮小,所檢測到的終點信號的強度下降,信號的信噪比降低。所有這些因素都對終點檢測技術本身及其測量結果的可靠性提出了更加嚴格的要求。在0.18 μm工藝時,使用單一的OES檢測手段就可滿足工藝需求;進入0.13 μm 工藝後,就必須結合使用OES 及IEP 兩種檢測手段。由於IEP技術可以在刻蝕終點到達之前進行預報,因而被稱為預報式終點檢測技術。
套用
電漿處理可套用於所有的基材,甚至複雜的幾何構形都可以進行電漿活化、電漿清洗,電漿鍍膜也毫無問題。電漿處理時的
熱負荷及機械負荷都很低,因此,低壓電漿也能處理敏感性材料。等離子刻蝕機的典型套用包括:
表面處理
包裝清洗
聚亞醯胺蝕刻
增強粘接力
生物醫學套用
混合物清洗
預結合清洗
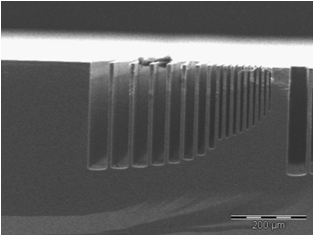 刻蝕率
刻蝕率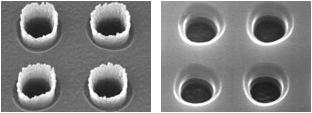 殘留物
殘留物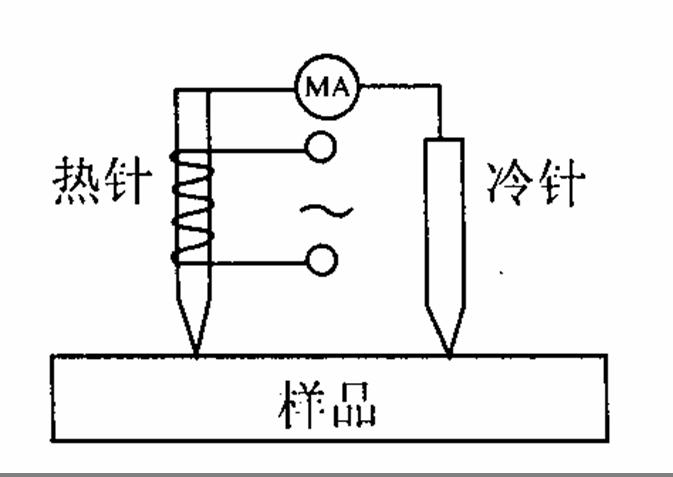 冷熱探針法
冷熱探針法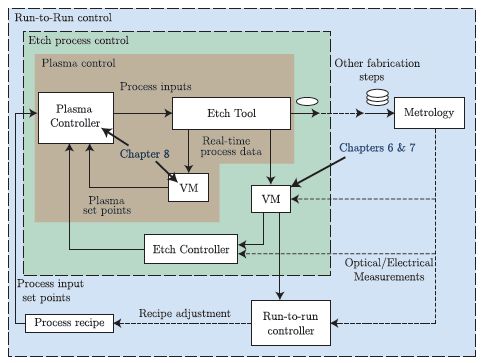 等離子刻蝕過程控制示意圖
等離子刻蝕過程控制示意圖
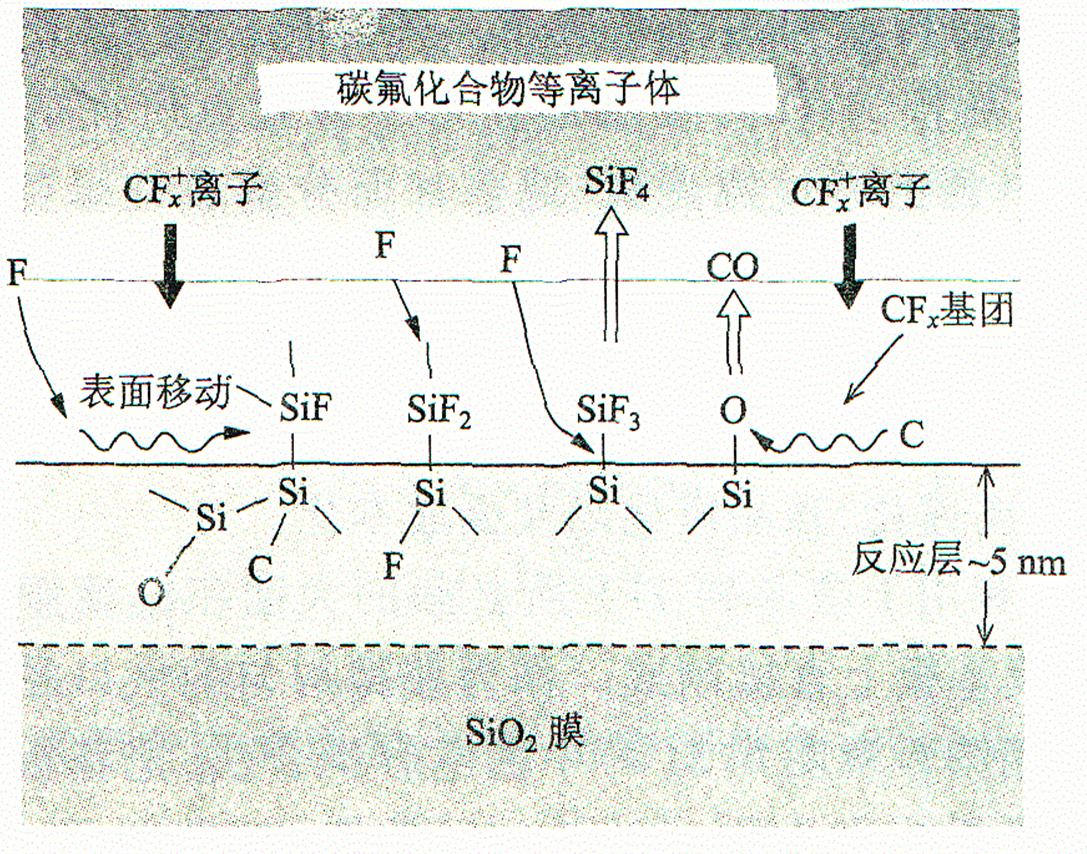 等離子刻蝕反應
等離子刻蝕反應