反應離子腐蝕技術是一種各向異性很強、選擇性高的乾法腐蝕技術。它是在真空系統中利用分子氣體等離子來進行刻蝕的,利用了離子誘導化學反應來實現各向異性刻蝕,即是利用離子能量來使被刻蝕層的表面形成容易刻蝕的損傷層和促進化學反應,同時離子還可清除表面生成物以露出清潔的刻蝕表面的作用。但是該刻蝕技術不能獲得較高的選擇比,對表面的損傷大,有污染,難以形成更精細的圖形。
基本介紹
- 中文名:反應離子腐蝕技術
- 外文名:Reactive ion etching
- 縮寫:RIE
- 技術種類:乾法腐蝕技術
工作原理

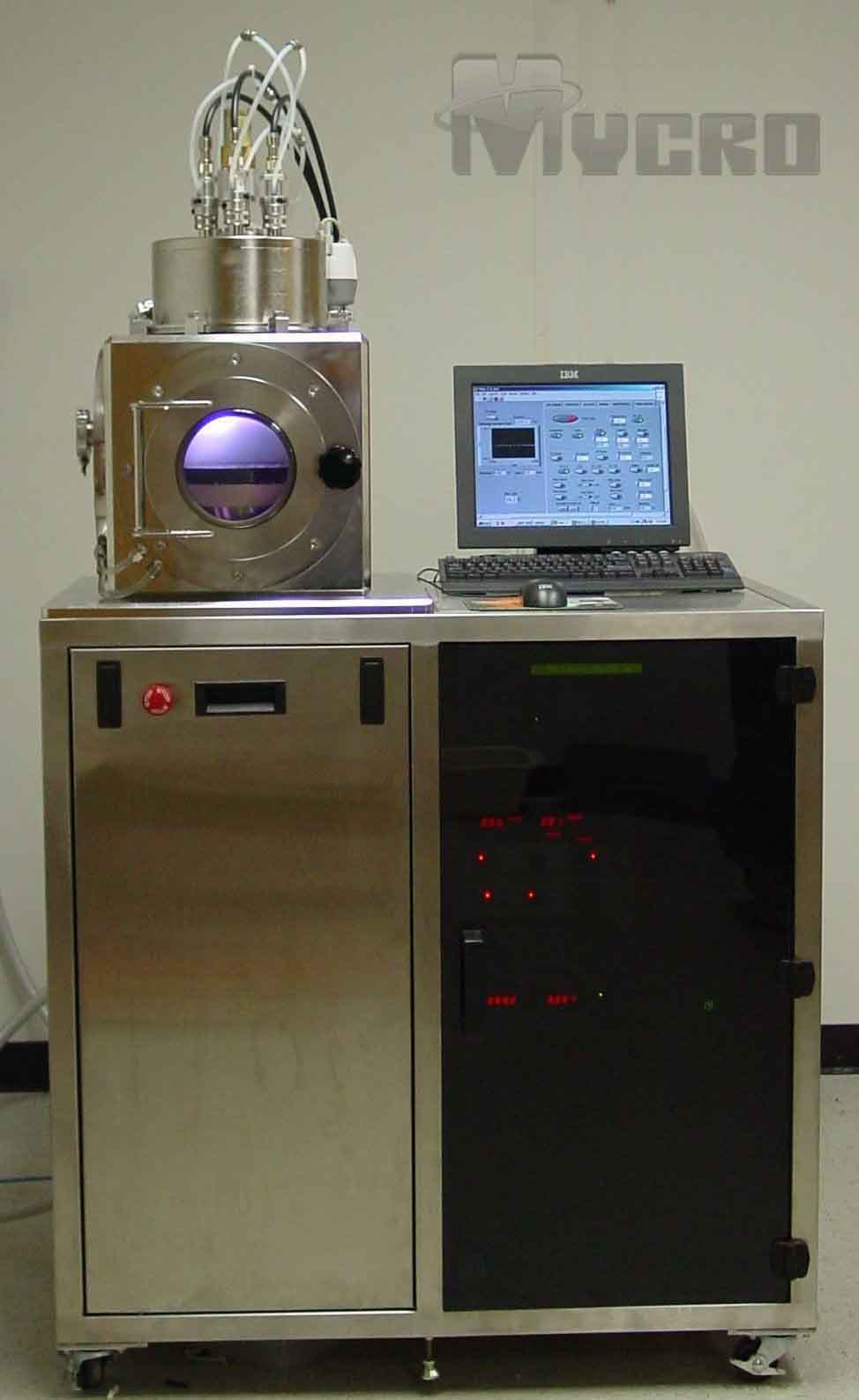
反應離子腐蝕技術是一種各向異性很強、選擇性高的乾法腐蝕技術。它是在真空系統中利用分子氣體等離子來進行刻蝕的,利用了離子誘導化學反應來實現各向異性刻蝕,即是利用離子能量來使被刻蝕層的表面形成容易刻蝕的損傷層和促進化學反應,同時離子還可清除表面生成物以露出清潔的刻蝕表面的作用。但是該刻蝕技術不能獲得較高的選擇比,對表面的損傷大,有污染,難以形成更精細的圖形。

反應離子腐蝕技術是一種各向異性很強、選擇性高的乾法腐蝕技術。它是在真空系統中利用分子氣體等離子來進行刻蝕的,利用了離子誘導化學反應來實現各向異性刻蝕,即是...
反應性離子刻蝕 (reaction ionetching;RIE)是製作...不過,IBARE是現在最重要的等離子技術。IBARE系統中,...對於多晶矽柵電極的刻蝕,腐蝕氣體可用Cl2或SF6,要求...
乾腐蝕是指在沒有水(包括但不限於液體水,水溶液或水蒸氣)接觸的情況下,引起的腐蝕或者氧化現象,即指等離子腐蝕,主要包括電漿腐蝕、離子銑蝕、濺射腐蝕、反應...
和控制腐蝕過程,由此所發展的方法、技術及相應的工程措施已成為防腐蝕工程技術。...鐵離子被氧化進入水中後,金屬中帶上了負電荷,電解液中帶上了正電荷,於是金屬...
金屬電化學腐蝕過程中,微型電池的陰極是接受電子產生還原反應的電極,陽極是失去...較新的一種表面技術是離子注入法,一般用離子注入機,使B、C、P、Si、N、Mo...
(2)溶液中的陽離子和氣體物質:腐蝕介質中,金屬陽離子與侵蝕性鹵化物陰離子共存時,氧化性金屬離子,如Fe3+、Cu2+和Hg2+對點蝕起促進作用。...
反應離子腐蝕技術是一種各向異性很強、選擇性高的乾法腐蝕技術。它是在真空系統中利用分子氣體等離子來進行刻蝕的,利用了離子誘導化學反應來實現各向異性刻蝕,即是...
金屬材料與電解質溶液接觸 , 通過電極反應產生的腐蝕...負極反應過程,反應產物是進入介質中的金屬離子或覆蓋...陰極保護技術套用已經比較成熟。在我國已經使用陰極...
電化學腐蝕,指金屬表面與離子導電的介質發生電化學反應而產生的破壞。在反應過程中有電流產生,腐蝕金屬表面上存在著陰極和陽極。陽極反應是金屬原子失去電子而成為離子...
真空鍍膜技術 運用 航空及航宇工業 包括 磁控濺射離子鍍、反應離子鍍等 目錄...由於離子鍍所獲得的鍍層緻密度高,針孔少,耐腐蝕性能好,並能沉積許多其他工藝...
DRIE,全稱是Deep Reactive Ion Etching,深反應離子刻蝕,一種微電子乾法腐蝕工藝。...... 基於氟基氣體的高深寬比矽刻蝕技術。與反應離子刻蝕原理相同,通過化學作用...
