定義概述
進行超快I-V測量需要產生高速脈衝波形[3]並在待測器件發生鬆弛之前測量產生的信號。
高速I-V測試的早期實現方式(通常稱之為脈衝式I-V測試系統)是針對諸如高k介質和絕緣體上矽(SOI)恆溫測試[4],或產生快閃記憶體器件特徵分析所必需的短脈衝之類的套用而開發的。脈衝式I-V測量技術是十分必要的,這是因為當採用傳統直流I-V測試方法時,它們的絕緣襯底使得SOI器件保留了測試信號自身產生的熱量,使測得的特徵參數發生偏移;而採用脈衝式測試信號能夠最大限度減少這種影響。
I-V測量技術的發展
過去,高速脈衝/測量測試系統通常由脈衝發生器、多通道示波器[5]、互連硬體和負責集成並控制儀器的軟體構成。不幸的是,這些系統受延遲的
影響,信號源和測量功能之間的協同非常複雜。根據儀器的質量及其集成的情況,這種方式在產生的脈衝寬度及其占空比方面還有局限性。即時不管這些局限性,這些早期脈衝式I-V測試系統的用戶已開始尋求將其用於各種其它特徵分析任務,包括非易失性存儲器測試、超快NBTI[6]可靠性測試和很多其它套用。但是,由於這些系統動態量程有限,它們仍然保留了一些特殊的技術。
展望下一代超快I-V測試系統
要想成為主流測試技術,下一代超快I-V測試[7]系統必須具有很寬的源與測量動態量程。這意味著它們必須能夠提供對快閃記憶體器件進行特徵分析所需的充足電壓,以及處理最新的
CMOS[8]工藝所需的足夠低的電壓。例如,對於CMOS工藝中的一種嵌入式快閃記憶體——該快閃記憶體可能需要高達20V的電壓進行編程,但是CMOS工藝工作電壓為3V,因此所採用的測試系統必須能夠提供滿足兩種需求的電壓。它還需要有足夠寬的電流量程處理最新的工藝,要有足夠快的上升時間和足夠長的脈寬滿足各種套用需求。它必須簡單易用,具有使系統能夠可靠提交精確測量結果的互連繫統。
當前,超快I-V和測量功能正逐漸集成到參數分析儀中用於對越來越多的器件特徵進行特徵分析,尤其是負偏溫度不穩定性(NBTI[9])和正偏溫度不穩定性(PBTI[10])降低。超快I-V測量工具通過使研究人員快速一致地實現器件可靠性測量,提高了可靠性設計(
DIR[11])壽命測量的精度,而這種測量支持器件和電路設計的建模。
近來,有些研究人員被迫配置他們自己的超快BTI測試系統。這些內部開發的系統通常包含脈衝發生器或任意波形發生器,以及配置了電流探頭或某種互阻抗放大器的示波器用於幫助測量低電流。儘管如果仔細選擇儀器和互連設備,我們可以構建出適合非常特殊電氣條件需求的BTI系統,但是仍然存在幾個主要的技術挑戰。
超快I-V測試系統面臨的挑戰
波形發生[12]。標準脈衝發生器和任意波形發生器的設計是在固定循環間隔上產生波形,而不是大多數可靠性測試(包括NBTI和PBTI測試)所需的Log(time)數。
測量定時與數據存儲。儘管
示波器[13]經過配置可以根據波形特徵(例如下降沿)進行觸發,但是它們無法有選擇地保存波形的指定部分樣本。這樣它們就必須存儲很大的數據集進行後處理。只有那些最昂貴的示波器或者那些擴展了昂貴存儲器選件的示波器才能存儲足夠的數據彌補這些不足。
精度、準確性和靈敏度。偏溫不穩定性是一種高動態的現象,需要靈敏而高速的測量才能進行準確的特徵分析。假設所有其它因素不變,測量的物理原理在很大程度上決定了測量速度和靈敏度之間的關係。當進行亞毫秒級測量時,所有的
噪聲源[14]都應該考慮在內;對於亞微秒級套用,即使量子效應也不能被忽略。示波器、
電流探頭[15]和互阻抗放大器都有單獨定義的性能指標,它們不一定為協同工作進行了最佳化。要想在高速情況下實現精密而準確的測量,我們通常很難以某種方式將這些部件組合起來實現具有很寬動態量程的最優性能。
互連。內部構建的系統通常採用分路器和T型偏置器[16],它們限制了測試系統配置的性能。例如,T型偏置器可能限制頻寬為100ns到10µs。儘管這適合於高速測量,但是它無法使得任何有效的預應力(prestress)和後應力(poststress)直流測量成為應力測量序列的組成部分。它也無法在10ms到直流的中間時序範圍內進行測量。
測試控制與數據管理。傳統的示波器不支持數據流,因此必須等待測試結束後才能傳輸測試結果。當測試一結束時,大量的數據必須傳輸到控制計算機上進行後期處理,它需要將複雜的波形解析為單個的測試結果,然後進一步減少進入實際測量的數據。
測試終端。由於從示波器傳輸數據之前無法分析測試結果,因此在測試開始之前必須確定測試持續的時間。這就使得我們不可能終止基於參數變換的測試,或者實時檢測出突發的故障。
自動化。晶圓級或晶匣級自動化測試需要控制測試儀器和晶圓探針台,內部構建的測試系統通常無法做到。此外,融合一些高級功能(如條件測試終端)也會給運行這類系統所需的定製軟體增加很大的複雜性。
更多的通道數。即使內部構建的系統在開始安裝時工作良好,系統集成設計者也需要增加通道或測試系統的數量以滿足不斷發展的套用需求,尤其定製系統的升級是極其複雜的。典型測試系統的維護問題,例如校準、操作和這些定製配置的關聯,也需要不相稱的大量技術資源,而這些資源常常供應有限。
最新一代的超快I-V測試系統參數分析儀
最新一代的參數分析儀可以通過配置最大限度減少或消除很多與內部構建的BTI特徵分析系統相關的缺陷。它們不是採用分離的脈衝或波形發生器與示波器,而是將這些功能組合在支持緊密時序協同的高速源與測量模組中。由於這些模組與參數分析儀[17]完全集成在一起,所以它們可以利用系統的數據存儲和自動測試功能。機架式系統只需添加更多的模組即可增加高速通道的數量,升級也很容易。
最新一代的參數分析儀能夠在同一個測試序列中集成超快I-V、直流I-V和C-V測量功能。這種功能對於越來越多的涉及到多種測量類型的套用是十分可貴的,例如
電荷泵[18](CP),它通常需要在提供一個柵電壓的同時測量直流襯底電流,或者分析光伏(太陽能)電池[19]的電氣特徵,其中通常要測量電流電容與載入的直流電壓之間的函式關係。
吉時利[20]的4200-SCS半導體[21]特徵分析系統(如圖1所示)長期以來始終支持精密直流I-V測量(利用集成的SMU)和C-V測量(利用可選的C-V模組)。利用最近推出的4225-PMU[22]超快I-V模組和4225-RPM[23]遠程放大器/開關,用戶可以增加超高速源和測量功能,所構建的系統也針對新興的實驗室套用進行了最佳化,例如超快通用I-V測量;脈衝式I-V和瞬態I-V測量;快閃記憶體、PCRAM和其它非易失性測試;中等尺寸功率器件的恆溫測試;縮放CMOS的材料測試,例如高k介質;NBTI/PBTI可靠性測試。(圖2給出了很多這類新興套用映射到4200的直流I-V和超快I-V源與測量範圍內的情形。)
圖1. 4200-SCS參數分析儀與超快I-V工具
圖2各種吉時利直流與脈衝I-V測量儀器的電流測量與時間關係的對比
SOI恆溫、詹森噪聲極限(環境)、4210-MMPC[24]線纜減少了傳輸線的影響、時間(秒)
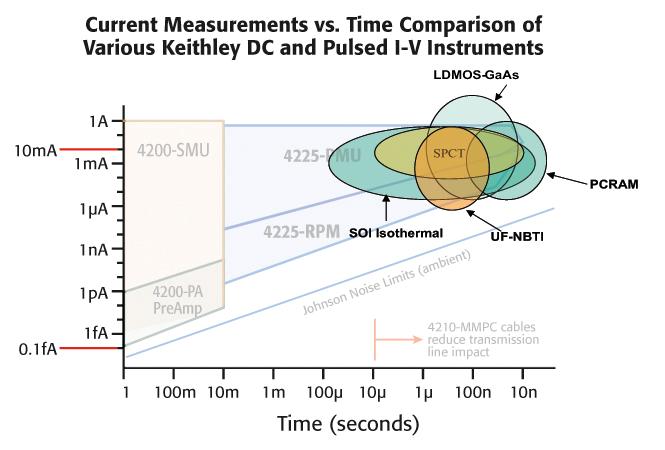 圖2
圖2超快I-V源和測量技術的套用
超快I-V源和測量技術隨著越來越多傳統直流I-V測量功能的消失而迅速發展。注意到,傳統SMU設計[25]能夠提供和測量最高約1A的電流,最低約1皮安的電流。儘管增加遠程前置放大器後最低可以解析0.1fA的電流信號,但是這些只支持直流I-V測量的系統配置最佳速度僅為10毫秒。相比之下,超快I-V測量方案能夠進行最快10ns的測量,這對於涉及器件恢復時間特徵分析的套用是非常關鍵的。專門針對超快I-V測試而設計的可選的遠程放大器將這些新型測量方案的電流解析度向下擴展到幾十皮安,僅僅稍高於待測器件產生的
詹森噪聲[26]決定的極限值。在單個機架內集成了超快I-V源和測量儀器與遠程放大器的系統支持的特徵分析套用比以往任何時候都更加寬泛,包括相變存儲器器件測試、單脈衝電荷俘獲/高k介質測試、LDMOS或砷化鎵中功率放大器器件特徵分析、SOI恆溫測試、超快負偏溫不穩定性(NBTI)測試、基於電荷的電容測量(CBCM[27])、MEMS電容測試和越來越多的其它一些測試。
圖3給出了支持越來越多的超快I-V套用的四種掃描類型:瞬態I-V掃描,其中對電壓和電流進行了連續數位化;快速脈衝式I-V測試,其中是在脈衝穩定之後對電壓和/電流進行了採樣;濾波式脈衝,其中產生一個變化的脈衝電壓同時用一台直流SMU測量產生的電流;脈衝應力/直流測量,其中產生脈衝式電壓,緊接著直流SMU測量。除了這些傳統的掃描類型,4225-PMU[28]還具有完整的任意波形發生功能以及Segment ARB®模式,能夠十分方便地構建、存儲和產生最多包含2048條用戶自定義線段的波形。每條線段可以有不同的持續時間,這一特性使其具有出色的波形發生靈活性。
瞬態I-V、快速脈衝I-V、脈衝發生器、脈衝發生器、濾波脈衝、脈衝應力/測量直流
圖3. 超快I-V測試配置
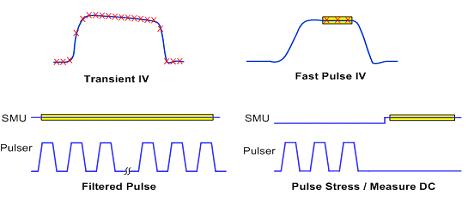 圖3
圖3隨著新型器件與測試套用的出現以及半導體實驗研究需求的不斷發展,超高速源/測量功能將變得越來越重要。能夠適應這些變化的需求,具有良好性價比和靈活性的測試系統不但可使研究人員延續以前的工作,而且可以跟上測量技術的發展。
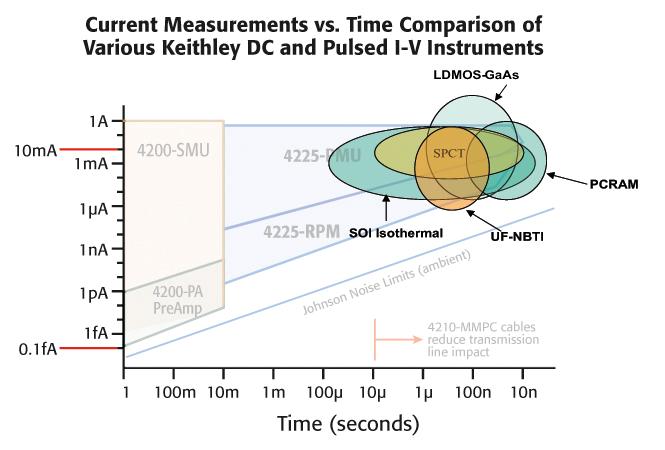 圖2
圖2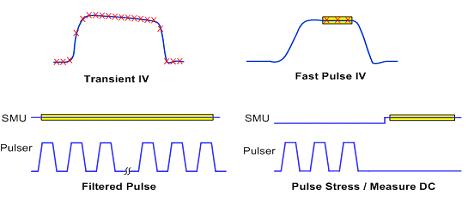 圖3
圖3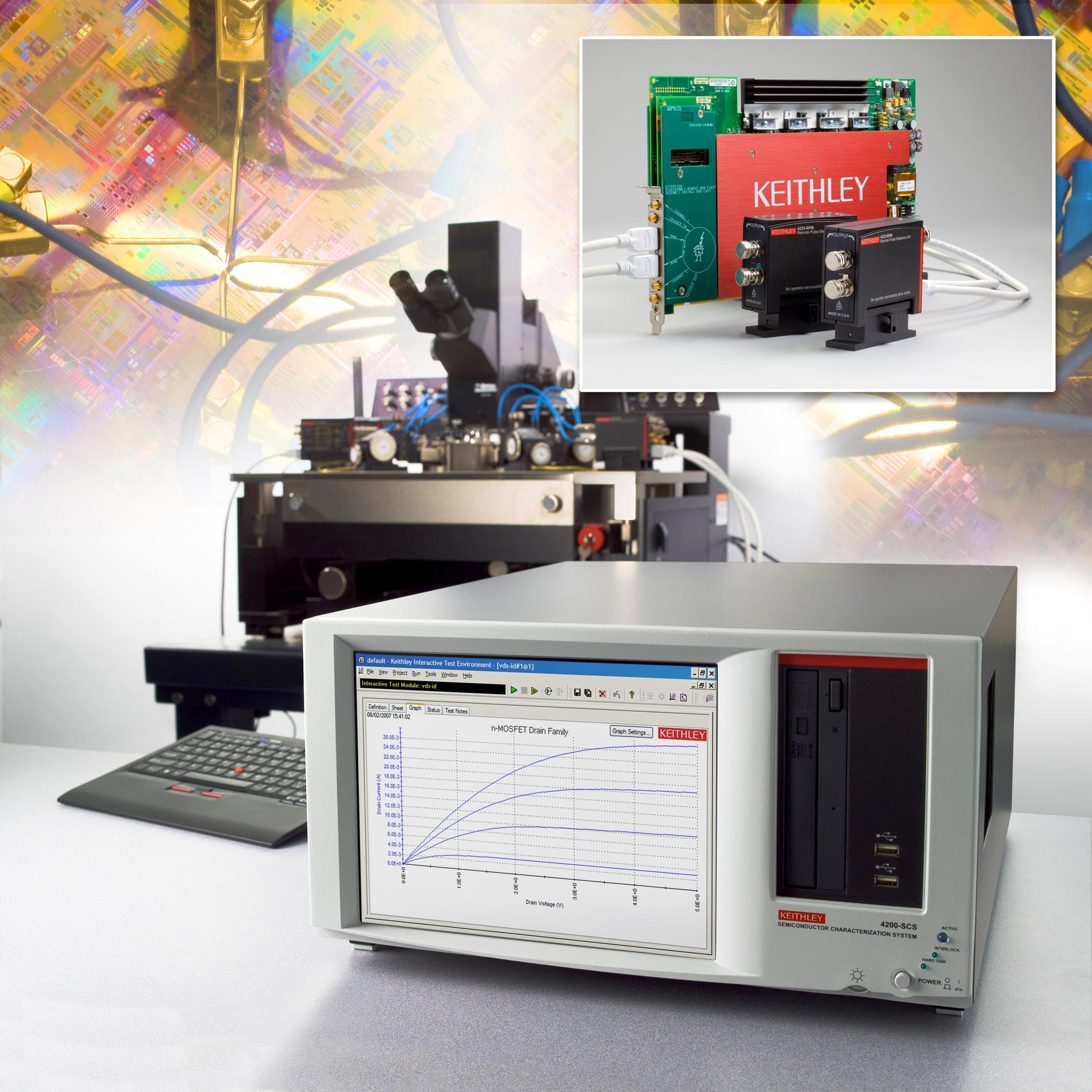
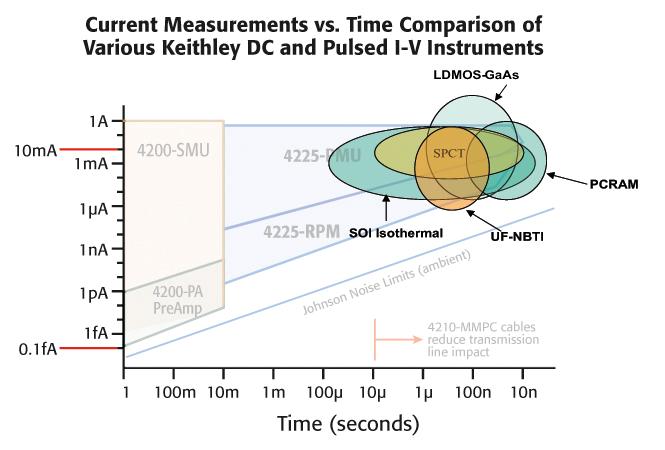 圖2
圖2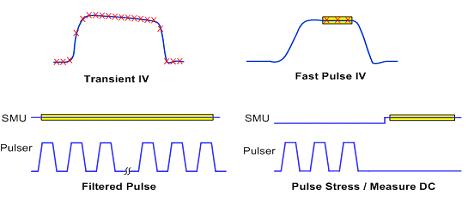 圖3
圖3