橢偏儀是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量儀器。由於測量精度高,適用於超薄膜,與樣品非接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一種極具吸引力的測量儀器。
基本介紹
歷史
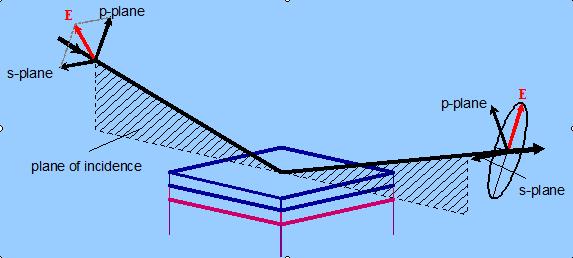
工作原理




儀器構造

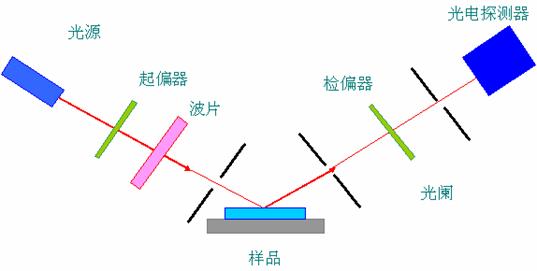 橢偏儀基本架構
橢偏儀基本架構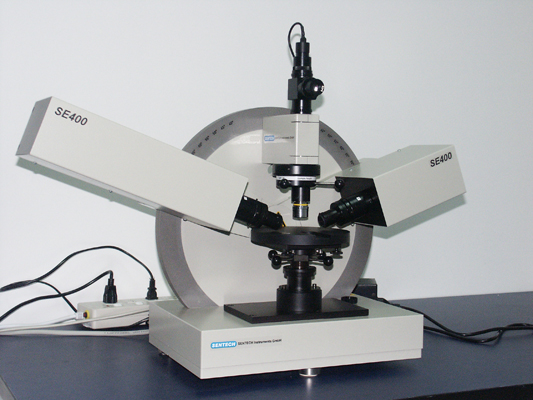
橢偏儀是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量儀器。由於測量精度高,適用於超薄膜,與樣品非接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一種極具吸引力的測量儀器。
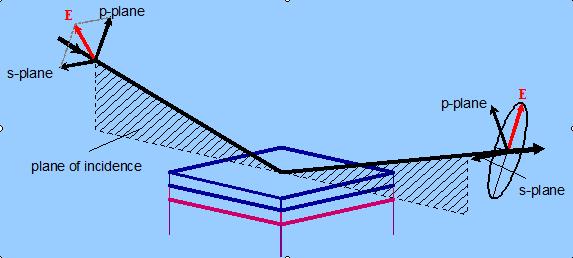





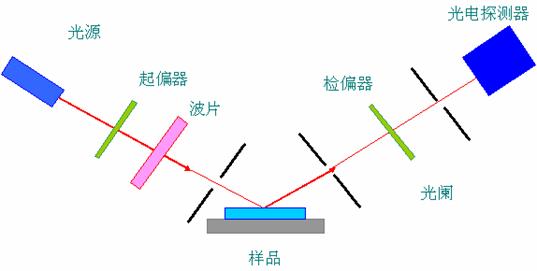 橢偏儀基本架構
橢偏儀基本架構橢偏儀是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量儀器。由於測量精度高,適用於超薄膜,與樣品非接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一...
橢偏儀是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量設備。由於厚度和折光率測量精度高,與樣品非接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一...
橢偏儀,是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量設備。由於並不與樣品接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一種極具吸引力的測量...
雷射橢偏儀,通常雷射光源的功率和波長可選。在測量過程中,需要以獲得橢偏數據,並對橢偏數據模擬分析從而得到測量結果,如薄膜厚度、光學常數以及材料微結構測量等。...
此技術可用單一波長或光譜式的橢偏儀,光譜式原位橢偏儀若採用多通道之偵檢器,如CCD,則可同時量測其研究光譜範圍內所有波長之橢圓偏振參數。...
北京量拓科技有限公司(ELLITOP SCIENTIFIC CO., LTD.)(以下簡稱“量拓科技”)是專業的高端橢偏儀器研發製造企業。...
例如,採用比色法、干涉條紋法以及橢偏術等測量各種透明薄膜;採用磨角染色法、...擴散層和離子注入層的深度;採用間接干涉法和台階儀等測量金屬膜和多晶矽的厚度等...
30 廣義橢偏儀 RC2 光學測量類 31 圓片鍵合機 SB6e 微納加工類 32 超聲原子力模量成像分析儀 AFAM 精密測量類 33 高頻高精度六分量測力裝置 9119AA2 精密測...
33 納米加工技術實驗室 光譜橢偏儀 SE 850 DUV 34 納米加工技術實驗室 矽刻蝕高密度電漿刻蝕機 Plasmalab System100 ICP180 35 納米檢測實驗室 雷射...
化學吸附-質譜聯用儀(Chemisorption-Mass Spectrometry) 雷射光散射納米粒度與電位分析儀(Laser Particle Size and Zeta Potential Analyzer) 橢偏儀(Spectroscopic Ellip...
余氯儀,啤酒飲料CO2測定儀,光電比色計,比色分析儀,三元素分析儀,螢光法溶解氧,化學膜溶解氧,爆炸物探測儀,橢偏儀,紫外輻照計,亮度計,地溝油快速檢測儀,氮磷鈣...
42 廣義橢偏儀 光學常數分析;薄膜表面截面特性;組分和結構進行表征測量分析。 43 薄膜原位生長測試隧道掃描顯微鏡 材料表面實空間的三維圖像;觀察單個原子層的局部表...
方向:薄膜光學、量子光學,現為山東大學光學工程專業的博士研究生,導師目前在做的工作大體是用橢偏儀測量薄膜材料的物理性質。中文名 李萍 出生日期 1975年 職業 ...
雷射共聚焦拉曼光譜儀、熱分析(DSC、TG、DMA)、雷射導熱儀、X- 射線衍射儀(XRD)、橢偏儀、台階儀、雷射粒度儀、比表面及孔隙率測試儀、化學吸附儀、壓汞儀、...
以及國家自然科學基金重大研究計畫項目“基於廣義橢偏儀的納米結構三維形貌參數測量理論與方法研究”、國家重大科學儀器開發專項“寬光譜廣義橢偏儀設備開發”等多項...
1.4.6橢偏儀在薄膜測量中的套用1.4.7偏振調製型光電感測器的設計1.5波長調製型光電感測器1.5.1概述1.5.2雷射都卜勒測速1.5.3雷射感生螢光測溫...
