橢偏儀,是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量設備。由於並不與樣品接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一種極具吸引力的測量設備。
基本介紹
- 中文名:橢圓偏振光譜儀
- 外文名:ellipsometry
- 套用:探測薄膜厚度、光學常數等
- 涉及領域:半導體、通訊、數據存儲等
- 可測的材料:半導體、電介質、聚合物等
基本原理
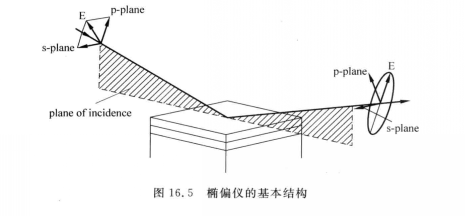 圖1
圖1橢偏儀
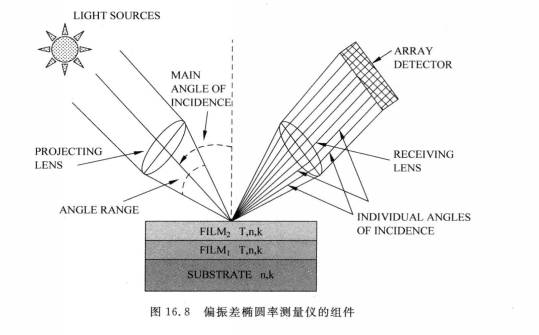 圖2
圖2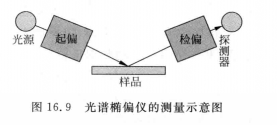 圖3
圖3可測材料
設計領域
橢圓偏振光

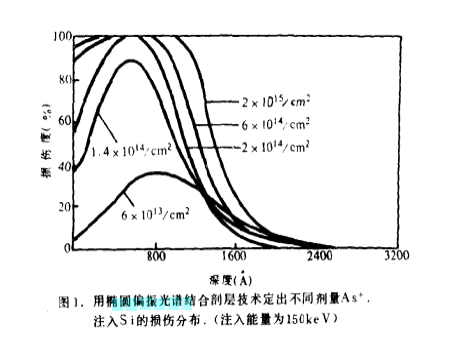 圖4
圖4

橢偏儀,是一種用於探測薄膜厚度、光學常數以及材料微結構的光學測量設備。由於並不與樣品接觸,對樣品沒有破壞且不需要真空,使得橢偏儀成為一種極具吸引力的測量設備。
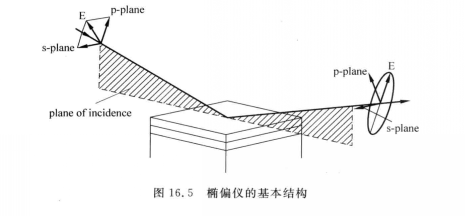 圖1
圖1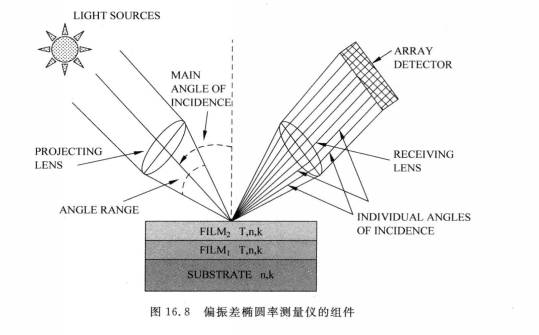 圖2
圖2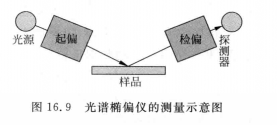 圖3
圖3
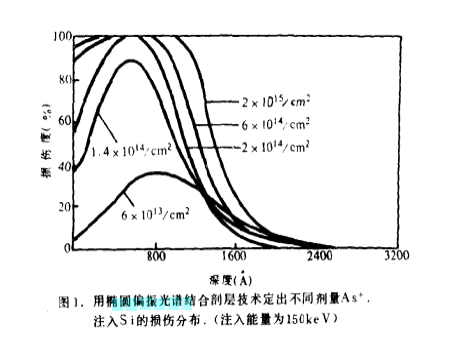 圖4
圖4
橢圓偏振光譜儀橢偏儀 編輯 偏振光橢圓率測量儀所需的組件包括:①把非偏振光轉化為線性偏振光的光學系統;②把線性偏振光轉化為橢圓偏振光的光學系統;③樣品反射;④...
光譜電化學裝置,依光譜儀的不同而不同.常用方法有透射光譜法、鏡面反射法和...橢圓偏振光譜電化學等。紫外和可見光譜電化學是一種透射光譜電化學技術,它需要在...
在這裡,用戶可以掌握:光柵、真空紫外光譜、光學光譜、拉曼光譜、橢圓偏振光譜、... 用戶培訓:可了解拉曼、螢光、ICP-OES、橢圓偏振、輝光光譜儀等培訓計畫。 ...
大型儀器設備29台(套),價值約5700萬元,納入了中科院上海材料與製造大型儀器區域...xps光電子能譜儀 變溫全自動橢圓偏振光譜儀 時域頻域光信號分析系統 Zeiss Auriga...
7 橢圓偏振光譜儀 M-2000X 柔性電子類 8 超純水 Milli_Q Integral 柔性電子類 9 原子沉積系統 SUNALETM R-200 柔性電子類 10 標籤封裝技術與成套設備RFID 柔...
分析儀、液相色譜質譜聯用儀、雷射拉曼光譜儀、X射線衍射儀、雷射粒度分析儀、...製備液相色譜儀 Agilent 1200 44 美國 2007 橢圓偏振光譜儀 ELLIP-A 35 中國...
16.4橢圓偏振光譜儀16.5統計過程控制16.5.1統計控制圖16.5.2過程能力指數16.5.3統計過程控制在積體電路生產中的套用參考文獻第17章良率改善17.1良率改善介紹...
擁有場發射掃描電鏡、雷射分子束外延系統、橢圓偏振光譜儀、飛秒雷射放大系統、多層精密鍍膜機等先進的科研設備,教學科研儀器設備總值3700餘萬元。理論物理是山東省“...
1.3.7橢圓偏振光譜儀15 1.3.8二次離子質譜探針16 1.3.9透射譜和吸收譜16 1.3.10拉曼光譜17 1.3.11紅外光譜測試儀18 1.3.12光致發光譜19 1.3.13...
44 橢圓偏振光譜儀 薄膜厚度測量。 45 立體顯微鏡 電子生產線、印刷線路板、焊接缺陷、顯示屏VFD檢定等 46 半導體特性分析平台 半導體C-V、I-V特性分析以及光電器...
實驗室儀器設備約3000萬元,已購置了十餘套大型科學儀器設備,包括紫外顯微螢光光譜測試儀、真空型傅立葉紅外光譜儀、自動橢圓偏振光譜儀、強光學超導磁體變溫測量系統...
阻抗分析儀、電子薄膜干涉相移應力分析儀、全自動橢圓偏振光譜儀等一系列大型精密儀器設備,儀器設備總價值達一千多萬元,奠定了從事信息材料與器件領域高水平研究開發...
