光刻膠是微電子技術中微細圖形加工的關鍵材料之一,特別是近年來大規模和超大規模積體電路的發展,更是大大促進了光刻膠的研究開發和套用。印刷工業是光刻膠套用的另一重要領域。1954 年由明斯克等人首先研究成功的聚乙烯醇肉桂酸脂就是用於印刷工業的,以後才用於電子工業。
基本介紹
分類
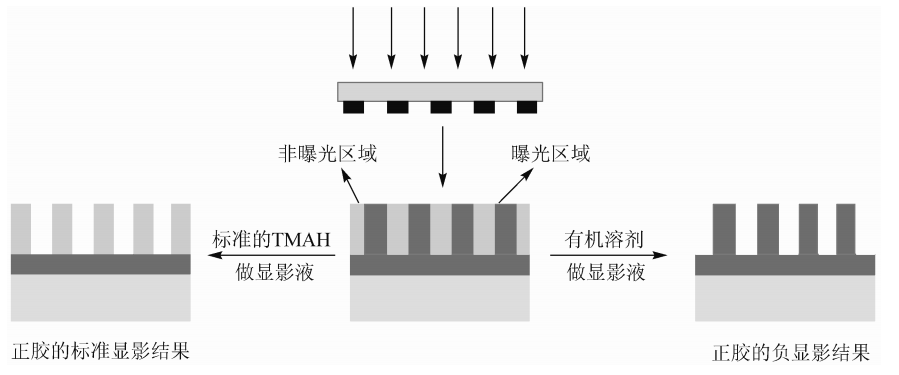 圖1 正性膠的顯影工藝與負性膠顯影工藝對比
圖1 正性膠的顯影工藝與負性膠顯影工藝對比光刻膠是微電子技術中微細圖形加工的關鍵材料之一,特別是近年來大規模和超大規模積體電路的發展,更是大大促進了光刻膠的研究開發和套用。印刷工業是光刻膠套用的另一重要領域。1954 年由明斯克等人首先研究成功的聚乙烯醇肉桂酸脂就是用於印刷工業的,以後才用於電子工業。
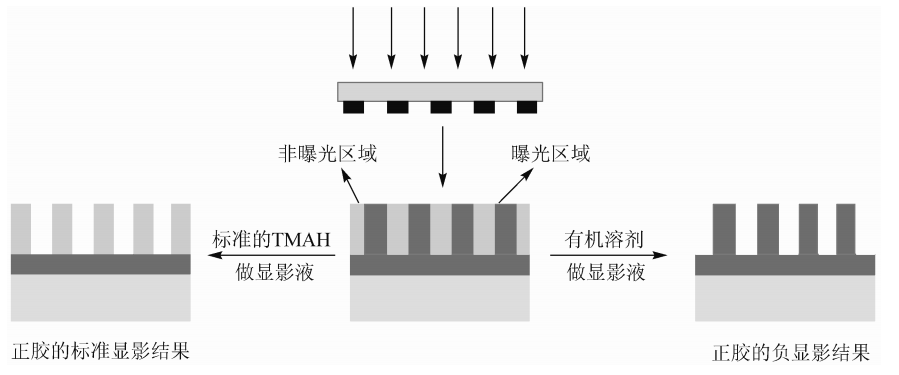 圖1 正性膠的顯影工藝與負性膠顯影工藝對比
圖1 正性膠的顯影工藝與負性膠顯影工藝對比光刻膠是微電子技術中微細圖形加工的關鍵材料之一,特別是近年來大規模和超大規模積體電路的發展,更是大大促進了光刻膠的研究開發和套用。印刷工業是光刻膠套用的...
正性光刻膠也稱為正膠。正性光刻膠樹脂是一種叫做線性酚醛樹脂的酚醛甲醛,提供光刻膠的粘附性、化學抗蝕性,當沒有溶解抑制劑存在時,線性酚醛樹脂會溶解在顯影...
光刻負膠,樹脂是聚異戊二烯,一種天然的橡膠;溶劑是二甲苯;感光劑是種經過曝光後釋放出氮氣的光敏劑,產生的自由基在橡膠分子間形成交聯。從而變得不溶於顯影液。...
根據光刻膠在溶劑中的溶解度,選擇光刻中合適的溶劑的方法稱為光刻膠配方。...... 選取合適的溶劑是光刻膠配方的重要工作,溶劑對光刻膠的性能有很大影響。溶劑選...
光刻是平面型電晶體和積體電路生產中的一個主要工藝。是對半導體晶片表面的掩蔽物(如二氧化矽)進行開孔,以便進行雜質的定域擴散的一種加工技術。...
負性光刻膠又稱光致抗蝕劑,是一種由感光樹脂、增感劑(見光譜增感染料)和溶劑三種主要成分組成的對光敏感的混合液體。...
光刻工藝過程可以用光學和化學模型,藉助數學公式來描述。光照射在掩模上發生衍射,衍射級被投影透鏡收集並會聚在光刻膠表面,這一成像過程是一個光學過程;投影在光...
環氧分子在酸的作用下聚合形成聚合物並與酚醛反應,形成交聯的一種光刻膠稱為環氧光刻膠。...
光刻(英語:photolithography)工藝是半導體器件製造工藝中的一個重要步驟,該步驟利用曝光和顯影在光刻膠層上刻畫幾何圖形結構,然後通過刻蝕工藝將光掩模上的圖形轉移...
紫外光刻膠UV resist用紫外光作曝光光源的光刻膠。一般是指分光感度波長為sao一450nin的近紫外抗蝕劑紫外光刻膠有負性、正性和止一負性兩用三類。負性的代表...
光刻膠是光刻工藝中使用的最關鍵的材料,多層光刻膠指在襯底上塗敷的光刻膠分成多層,然後使用該光刻膠進行曝光。...
光刻分子膠本質上是一種的聚合物化學放大膠,例如基於羥基苯乙烯聚合物的膠。...... 光刻分子膠本質上是一種的聚合物化學放大膠,例如基於羥基苯乙烯聚合物的膠。...
正性光刻膠,樹脂是一種叫做線性酚醛樹脂的酚醛甲醛,提供光刻膠的黏附性、化學抗蝕性,當沒有溶解抑制劑存在時,線性酚醛樹脂會溶解在顯影液中;感光劑是光敏化合物...
正型光刻膠 由光分解劑和鹼性可溶性樹脂及溶劑組成,為重氮茶醒磺酸醋及線性酚醛製成。...
正型光刻膠去膜劑 主要成分為苯酚、丙酮和有機胺。棕色油狀液體,易燃。...... 正型光刻膠去膜劑 主要成分為苯酚、丙酮和有機胺。棕色油狀液體,易燃。...
光刻材料是指光刻工藝中用到的增粘材料、抗反射塗層、光刻膠、化學溶劑和顯影液,還包括193nm浸沒式光刻中用到的抗水塗層。...
正型光刻膠顯影劑 主要成分為氫氧化鈉與有機胺。為無色透明的鹼性水溶液。用作正型光刻膠的顯影劑。 ...
光刻膠溶劑是指積體電路製造光刻工藝光刻膠配方中所使用的溶劑。...... 光刻膠溶劑是指積體電路製造光刻工藝光刻膠配方中所使用的溶劑 [1] 。中文名 光刻膠...
正型光刻膠稀釋劑 主要成分為醚及醋。無色透明的有機溶劑。易燃,易吸水,應在乾燥、遠離火源處存放。可用作調整正型光刻膠膠液濃度的稀釋劑。 ...
光刻膠用染料dyes for phVLaetChlT'g微電子工業光刻過程中所用的染料、通常是那些含兩個或三個雙偶氮蔡釀功能團的化合物和一些荀一3一梭酸類染料。二芳甲烷...
環化光刻膠cy-clixed resi、又稱環化橡膠型光致抗蝕劑一系由環化大然橡膠、增感hll(或稱交聯劑,如對疊氮型化合物)、光敏劑,以適當溶3}I,<}L制而成。...
特性 主要成分為苯酚加瘩劑。紅色透明液體。能與水、}} }* i} }riJ互溶.有毒且有腐蝕性。適用於去除負型光刻膠光刻後的膠膜以及同類型光刻膠膜的去除 ...
沉浸式光刻技術是在傳統的光刻技術中,其鏡頭與光刻膠之間的介質是空氣,而所謂浸入式技術是將空氣介質換成液體。實際上,浸入式技術利用光通過液體介質後光源波長...
特性 混合烷烴經1 . U}cm過濾膜過濾製得。為無色透明液體.易揮發.能與苯類、三氯甲烷、汕類等混合不溶於水易燃用於負}J光刻膠顯影。 ...
軟烘後,利用化學或光學的方法去除晶圓邊緣處的光刻膠,稱為光刻膠邊緣修復,也叫光刻膠去邊。...
“footing”是指在光刻工藝中由於顯影不充分等原因導致光刻膠圖形底部寬大的現象。...... “footing”是指在光刻工藝中由於顯影不充分等原因導致光刻膠圖形底部寬大...
