沉浸式光刻技術是在傳統的光刻技術中,其鏡頭與光刻膠之間的介質是空氣,而所謂浸入式技術是將空氣介質換成液體。實際上,浸入式技術利用光通過液體介質後光源波長縮短來提高解析度,其縮短的倍率即為液體介質的折射率。
基本介紹
- 中文名:沉浸式光刻技術
- 外文名:Immersion Lithography
- 別名:沉浸式光刻技術
- 類型:193nm浸入式光刻技術等
- 時間:2002年
概述



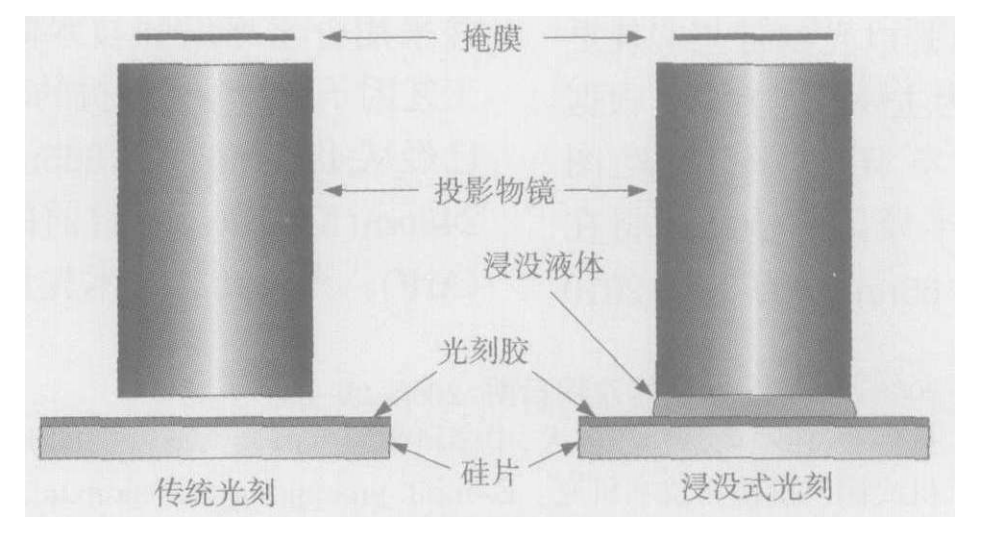
沉浸式光刻技術是在傳統的光刻技術中,其鏡頭與光刻膠之間的介質是空氣,而所謂浸入式技術是將空氣介質換成液體。實際上,浸入式技術利用光通過液體介質後光源波長縮短來提高解析度,其縮短的倍率即為液體介質的折射率。



沉浸式光刻技術是在傳統的光刻技術中,其鏡頭與光刻膠之間的介質是空氣,而所謂浸入式技術是將空氣介質換成液體。實際上,浸入式技術利用光通過液體介質後光源波長...
極紫外光刻(Extreme Ultraviolet Lithography),常稱作EUV光刻,它以波長為10-14納米的極紫外光作為光源的光刻技術。具體為採用波長為13.4nm 的紫外線。極紫外線就...
在現階段EUV(極紫外)技術雖然進展坎坷商業化困難重重,但是這項技術前景仍然看好。但是目前最為實際的情況是193nm光刻技術藉助於沉浸式技術,已經能夠延續到11nm工藝...
開發下一代光刻技術,比如EUV(極紫外線光刻),用於關鍵尺度在22納米甚至更低的...而最高端市場(例如沉浸式光刻機),ASML大約目前占據80%的市場份額。不過,競爭...
開發下一代光刻技術,比如EUV(極紫外線光刻),用於關鍵尺度在22納米甚至更低的...而最高端市場(例如沉浸式光刻機),ASML大約目前占據80%的市場份額。不過,競爭...
而在32納米製程中,由於在關鍵層上首次使用沉浸式光刻技術,所以此氧化層的厚度僅為0.9納米,而柵極長度則縮短為30納米。電晶體的柵極間距每兩年縮小0.7倍——32...
超低K電介質可以降低串聯電容、降低寫入延遲和能量消耗,從而明顯提升性能功耗比;而沉浸式光刻技術,實際上就是在雷射蝕刻頭的中間加入一種特殊的液體來修正光的折射...
這得益於處理器設計增強AMD 業界領先的45 nm沉浸式光刻技術和超強的處理器設計與驗證能力。2.L3快取容量提高200%,達到6MB,增強虛擬化、資料庫和Java等記憶體密集型...
而在32納米製程中,由於在關鍵層上首次使用沉浸式光刻技術,所以此氧化層的厚度僅為0.9納米,而柵極長度則縮短為30納米。電晶體的柵極間距每兩年縮小0.7倍——32...
其實在更早的45nm世代,ASML和尼康也曾雙雙成為Intel的光刻設備供應商,但在32nm節點上Intel首次套用了沉浸式光刻技術,只有尼康一家提供相關設備。...
其實在更早的45nm世代,ASML和尼康也曾雙雙成為Intel的光刻設備供應商,但在32nm節點上Intel首次套用了沉浸式光刻技術,只有尼康一家提供相關設備。...
這得益於處理器設計增強AMD 業界領先的45 nm沉浸式光刻技術和超強的處理器設計與驗證能力。2.L3快取容量提高200%,達到6MB,增強虛擬化、資料庫和Java等記憶體密集型...
45nm SOI沉浸式光刻製造技術AMD的45納米製程工藝是聯合IBM一同研發的。有趣的是,與英特爾的高-K金屬柵極不同,AMD和IBM的技術是超低K電介質互聯。而另兩項相關...
