基本介紹
- 中文名:薄層電阻測量技術
- 方法:Rymaszewski 法
- 儀器:四探針測試儀
- 作用:為提高晶錠的質量提供了重要參考
原理簡介,結構模型,
原理簡介
薄層電阻是指一塊正方形薄層沿其對邊平面方向的電阻,單位為Ω/□(圖1)。若正方形薄層的邊長為l,厚度為xj,截面積為A,平均電阻率為,薄層電阻Rs為由上式可知,薄層電阻只與薄層材料的平均電阻率及其厚度有關,與方塊的邊長無關。 經常通過外延生長、雜質擴散工藝或離子注入摻雜工藝在單晶襯底上形成一層異型薄層(如在N型襯底上形成P型層或在P型襯底上形成N型層),或通過真空蒸發工藝、濺射工藝在絕緣材料上覆蓋一層金屬薄膜。這些結構的薄層電阻值在半導體器件和積體電路生產中都是需要受到精確控制的重要工藝參數。半導體薄層電阻的大小取決於薄層中摻入雜質的情況。當雜質分布形式確定後,通過測量薄層電阻就能推算出表面雜質濃度。 在半導體工藝中,廣泛使用四探針法測量薄層電阻(圖2)。四個針尖排在一直線上,測量時電流由外側兩根探針流經薄層(因薄層與襯底的摻雜型號相異,電流基本上不通過襯底),並用兩根內側探針測量電壓。探針的間距相等,均為s。當薄層厚度xjs時,可算出式中U為電壓值(伏);I為電流值(安;)C為修正係數,當樣品的尺寸遠大於s時,C=4.532。
在矽平面工藝中,往往通過一些專門設計的測試圖形來檢測薄層電阻。這些圖形形成在晶片邊緣,或者專門的測試片上(與其他參數的測試圖形一起),它們和積體電路晶片同時經歷各項工藝步驟。通過這樣一些測試圖形測得的薄層電阻,更加準確地反映器件和電路中的實際情況。若在大圓矽片上作成布滿測試圖形的陣列,還可得到整個圓片上薄層電阻值分布的均勻性。 圖3為矩形條的薄層電阻測試圖形。有陰影線的方塊處為金屬化的歐姆接觸。電流I由外側的兩處接觸通過條狀薄層,中間的兩處接觸用於測量電壓U。矩形條的寬度W以及產生電壓降U的一段長度L均可測量。根據薄層電阻的定義,可得條狀測試結構與單塊積體電路中的電阻器的情況相似。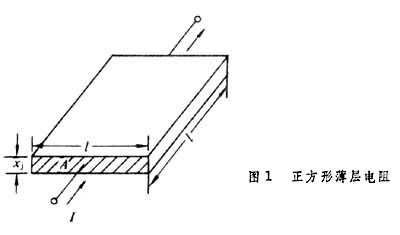
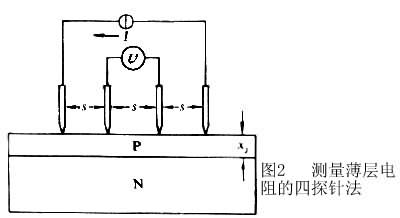
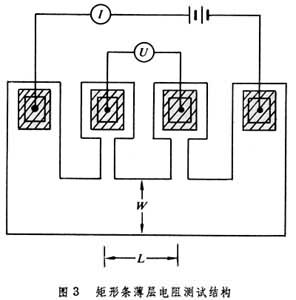
在矽平面工藝中,往往通過一些專門設計的測試圖形來檢測薄層電阻。這些圖形形成在晶片邊緣,或者專門的測試片上(與其他參數的測試圖形一起),它們和積體電路晶片同時經歷各項工藝步驟。通過這樣一些測試圖形測得的薄層電阻,更加準確地反映器件和電路中的實際情況。若在大圓矽片上作成布滿測試圖形的陣列,還可得到整個圓片上薄層電阻值分布的均勻性。 圖3為矩形條的薄層電阻測試圖形。有陰影線的方塊處為金屬化的歐姆接觸。電流I由外側的兩處接觸通過條狀薄層,中間的兩處接觸用於測量電壓U。矩形條的寬度W以及產生電壓降U的一段長度L均可測量。根據薄層電阻的定義,可得條狀測試結構與單塊積體電路中的電阻器的情況相似。
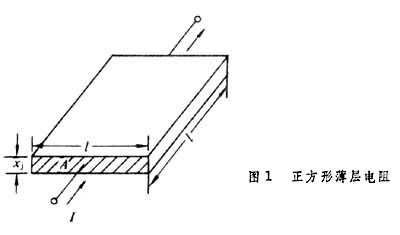
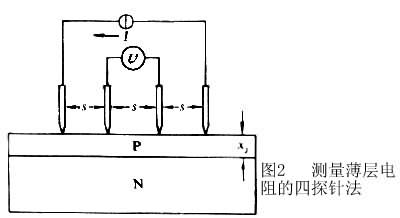
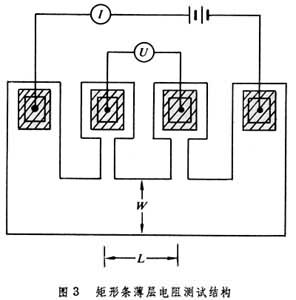
結構模型
正方形范德堡測試結構中(圖4),正中是需要測量的正方形薄層。測量時,從任一邊的兩個歐姆接觸點通入電流I,從對邊的兩個歐姆接觸點測量電壓U。由於圖形的高度對稱,若在此局部範圍內薄層電阻的平面分布均勻,則薄層電阻值Rs為通過對換電壓和電流測試點,並用測得的數據求出平均值就能消除因圖形不對稱所引起的誤差。

