有機金屬化學氣相沉積法 (MOCVD, Metal-organic Chemical Vapor Deposition) ,是在基板上成長 半導體 薄膜的一種方法。
基本介紹
- 中文名:有機金屬化學氣相沉積法
- 英文名:MOCVD, Metal-organic Chemical Vapor Deposition
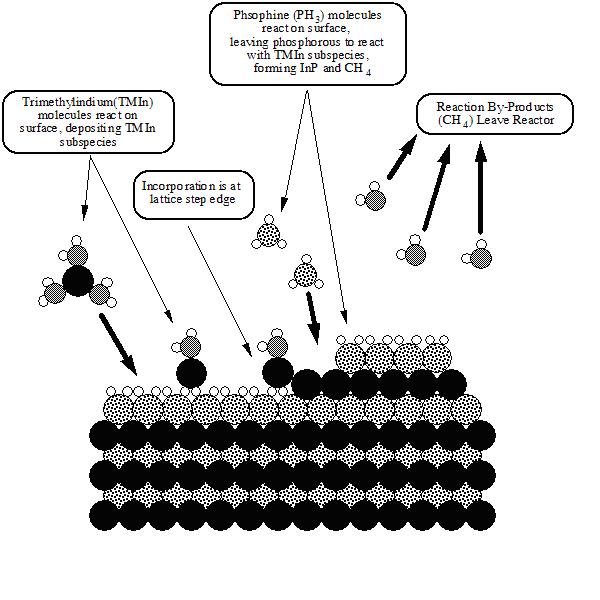
有機金屬化學氣相沉積法 (MOCVD, Metal-organic Chemical Vapor Deposition) ,是在基板上成長 半導體 薄膜的一種方法。
金屬有機化學氣相沉積法 (MOCVD, Metal-organic Chemical Vapor Deposition) ,是在基板上成長 半導體 薄膜的一種方法。...
金屬有機物化學氣相沉積(metal organic chemical vapour deposition)是一種利用有機金屬熱分解反應進行氣相外延生長薄膜的化學氣相沉積技術。...
金屬有機化合物化學氣相沉積metal or}amr c}}n:rpouruirhrmic}l }}po】一dcFx}sition ; MDCVh用金屬有機化合物熱分解進行氣相外延生長的方法。...
2化學氣相沉積法生產貴金屬銥高溫塗層從20世紀80年代開始,NASA 開始嘗試使用金屬有機化合物化學氣相沉積法製取出使用錸基銥作為塗層的複合噴管,並獲得了成功,這時化學...
化學氣相沉積包括常壓化學氣相沉積、電漿輔助化學沉積、雷射輔助化學沉積、金屬有機化合物沉積等。氣相沉積法分類 編輯 CVD技術常常通過反應類型或者壓力來分類,包括...
中文名稱 低壓金屬有機化學氣相沉積 英文名稱 low pressure metalorganic chemical vapor phase deposition 定義 在低於一個大氣壓條件下,將金屬有機化合物通過氣相...
熱化學氣相沉積(TCVD)是指利用高溫激活化學反應進行氣相生長的方法。廣泛套用的TCVD技術如金屬有機化學氣相沉積、氯化物化學氣相沉積、氫化物化學氣相沉積等均屬於熱...
1 3 1水熱與溶劑熱合成法31 3 2固相合成法41 3 3化學氣相沉積法(CVD)5...5 2 10有機金屬化合物的製備133實驗55二茂鐵的合成133實驗56乙醯基二茂鐵的合成...
中文名稱 常壓金屬有機化學氣相沉積 英文名稱 atmospheric pressure metalorganic chemical vapor phase deposition 定義 在常壓條件下,將金屬有機化合物通過氣相輸運...
氣相外延VPE(Vapor Phase Epitaxy)也稱為化學氣相沉澱CVD(Chemical Vapor Deposition)所謂在某些書籍上所出現的MOVPE其實就是鼎鼎大名的MOCVD,即MOCVD/MOVPE:金屬有機...
這種對熱不穩定性被用於半導體工業中,即有機金屬化學氣相沉積法(MOVPE)。 [3] 由於甲鍺烷毒性較大,某些有機鍺化合物(如異丁基鍺)可以替代甲鍺烷,套用於MOVPE...
5. 大連市留學回國人員科研基金,Pt-Pd功能催化材料的金屬有機化學氣相沉積可控制備及其深度加氫脫硫性能研究,2007.07-2009.06,項目負責人 4. 中科院大連化物所催化...
algaas適合於製造高亮度紅光及紅外線led,主要以lpe磊晶法量產,但因需製作algaas...2017年led外延片生長技術主要採用有機金屬化學氣相沉積方法。mocvd金屬有機物化學...
這種對熱不穩定性被用於半導體工業中,即有機金屬化學氣相沉積法(MOVPE)。由於甲鍺烷毒性較大,某些有機鍺化合物(如異丁基鍺)可以替代甲鍺烷,套用於MOVPE中。[4]...
高純金屬有機化合物即MO源是先進的金屬有機化學氣相沉積(簡稱MOCVD)、金屬有機分子束外延(簡稱MOMBE)等技術生長化合物半導體材料的支撐材料。化合物半導體材料是21世...
金屬有機化學氣相沉積MOCVD法利用有機金屬熱分解進行氣相外延生 長,可以合成組分按任意比例組成的人工合成材料, 形成厚度精確控制到原子級的薄膜,從而又可以製成 ...
2.3.1液相外延法(LPE)2.3.2金屬有機化學氣相沉積法(M0cvD)2.3.3分子束外延(MBE)思考題參考文獻第3章 半導體異質結的能帶圖3.1理想突變異質結的能帶圖...
(3)化學氣相沉積:通過熱分解所選定的金屬化合物或有機化合物,獲得沉積薄膜的過程。(4)離子鍍:實質上離子鍍系真空蒸鍍和陰極濺射鍍的有機結合,兼有兩者的工藝...
在973計畫項目等的支持下,中科院半導體所的劉祥林研究小組首次提出了氫致自催化方法,用金屬有機物化學氣相沉積技術生長出了六角對稱的氮化銦納米花結構(Appl. Phys....
