基本介紹
- 中文名:離子注入機
- 外文名:Ion implanter
- 屬性:加速器
- 套用領域:金屬表面改性、積體電路製造等
機器結構





原理
分類
離子注入機類型 | 能量範圍 | 注入劑量範圍 | 工藝中的主要套用 |
低能大束流離子注入機 | 0.2keV~100keV |  | 超淺結、源漏注入、多晶矽柵極注入等 |
高能離子注入機 | ~MEV |  | 深埋層等 |
中束流離子注入機 | 幾百keV |  | 柵閾值調整、輕摻雜漏區、SIMOX、Smart Cut穿透阻擋層等 |


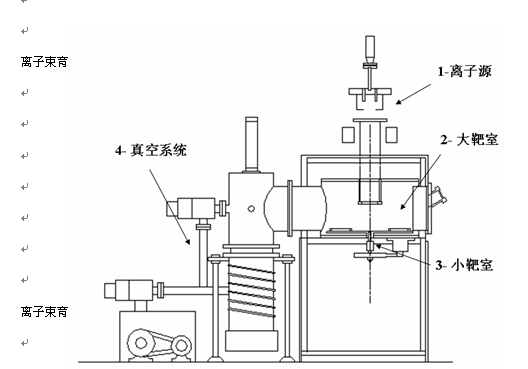





離子注入機類型 | 能量範圍 | 注入劑量範圍 | 工藝中的主要套用 |
低能大束流離子注入機 | 0.2keV~100keV |  | 超淺結、源漏注入、多晶矽柵極注入等 |
高能離子注入機 | ~MEV |  | 深埋層等 |
中束流離子注入機 | 幾百keV |  | 柵閾值調整、輕摻雜漏區、SIMOX、Smart Cut穿透阻擋層等 |


離子注入機是高壓小型加速器中的一種,套用數量最多。它是由離子源得到所需要的離子,經過加速得到幾百千電子伏能量的離子束流,用做半導體材料、大規模積體電路和...
離子注入是指當真空中有一束離子束射向一塊固體材料時,離子束把固體材料的原子或分子撞出固體材料表面,這個現象叫做濺射;而當離子束射到固體材料時,從固體材料...
離子注入技術:把摻雜劑的原子引入固體中的一種材料改性方法。簡單地說,離子注入的過程,就是在真空系統中,用經過加速的,要摻雜的原子的離子照射(注入)固體材料,...
將加速到一定高能量的離子束注入固體材料表面層內,以改變表面層物理和化學性質的工藝。在半導體中注入相應的雜質原子(如在矽中注入硼、磷或砷等),可改變其表面...
在常用金屬的離子注入改性中,可以提高金屬的硬度、抗腐蝕性能和抗疲勞強度,降低金屬的磨損率。某些絕緣材料如陶器、玻璃、有機材料經離子束照射以後,性質發生重要的...
離子源(英文名稱:Ion source)是使中性原子或分子電離,並從中引出離子束流的裝置。它是各種類型的離子加速器、質譜儀、電磁同位素分離器、離子注入機、離子束刻蝕...
雙等離子管是使中性原子或分子電離,並從中引出離子束流的裝置。它是各種類型的離子加速器、質譜儀、電磁同位素分離器、離子注入機、離子束刻蝕裝置、離子推進器以及...
離子源是使中性原子或分子電離,並從中引出離子束流的裝置。它是各種類型的離子加速器、質譜儀、電磁同位素分離器、離子注入機、離子束刻蝕裝置、離子推進器以及受控...
二十世紀80年代以來,中國陸續建設了四大高能物理研究裝置――北京正負電子對撞機...利用加速器將一定能量的離子注入到固體材料的表層,可以獲得良好的物理、化學及...
在《半導體學報》、《中國科學》、《中國出版》等刊物上相繼發表了《一個估算重離子在SiO2、Al2O3、和Ni3N4中Rp和ΔRp的經驗公式》、《400Kev離子注入機中磁...
其中中國自己累計生產出140多台離子注入機,能量為150KeV~600KeV(1KeV=1×103eV),流強為0.5mA到十幾mA。加速器農業 作為核技術套用裝備的加速器在農業上的...
2010年中回國後,擔任國家科技部02專項“極大規模積體電路製造裝備及成套工藝”的重要主課題“45-22nm低能大束流離子注入機研發和產業化”項目的首席技術專家,為...
1974 年與上海原子核研究所合作在該離子注入機上配置束流準直器及精密定角器,建立了背散射能譜測量及溝道效應分析系統,套用於離子注入半導體的表面層組分濃度分布...
電路批量生產的低能和中能離子注入機,為我國積體電路初期生產作出了貢獻。1977年12月,曾憲楠受到照顧,被調到溫州儀器儀表廠工作,夫妻不再分居。那時候,全國流行抽調...
931離子注入原理 932離子注入的重要參數 933離子注入摻雜工藝與擴散 摻雜工藝的比較 94離子注入機 941離子注入機的組成及工作 原理 942離子注入工藝及操作 規範 943...
1984年,主持離子注入機設計,召開全國方案論證會。王光華研究成果 編輯 1986年,上海先鋒電機廠機加速器研究所室主任王光華帶領團隊研究加速器的設計,完成1兆伏至3...
離子注入是將被注入元素的原子利用離子注入機電離成帶一個正電荷的離子,經高壓電場作用後,強行注入材料的表面,使其產生物理、化學性能的最佳化的工藝方法。可將任何...
[3].“離子注入機晶圓傳送系統及晶圓傳送方法”, 發明人:付成龍,陳懇,萬超 等. 專利號:ZL 201010245272.X,授權日:2013年1月 [4].“離子注入機多片晶圓定位...
1. 離子體浸沒離子注入機開發與套用,北京市科學技術獎三等獎,2014年2. 原子層沉積系統級工藝,全國發明展覽會一等獎,2011年3. 高亮度LED圖形化襯底刻蝕系統及工藝...
當元件的幾何尺寸縮小時,由於陰影效應(Shadowing Effect),採用標準的離子注入製程將很難在深寬比很大的Si 溝槽兩側與底部進行重度摻雜。一種新的離子注入方法稱作...
曾參與多台離子注入機的研製和調試;承擔過多項省重點和國家自然科學基金資助科研項目,從事有關離子注入單晶矽太陽電池、 C60 固體的合成及其薄膜光電特性的研究 ; ...
擁有MEVVA源強流離子注入機、400KeV離子注入機、ASR100/C型擴展電阻儀、UTT400型超高真空鍍膜機、BF-5電子直線加速器、400kV高壓倍加器、高能(MeV)離子注入系統...
低溫泵可以獲得抽氣速率最大、極限壓力最低的清潔真空,廣泛套用於半導體和積體電路的研究和生產,以及分子束研究、真空鍍膜設備、真空表面分析儀器、離子注入機和空間...
其中:1999年獲中科院近代物理研究所博士學位;1999 - 2001年在德國重離子研究中心...當時所里僅有一台200千伏離子注入機,需要做實驗的人太多,她排不上隊,就隻身...
冷凝泵是獲得清潔真空的極限壓力最低、抽氣速率最大的真空泵,廣泛套用於半導體和積體電路的研究和生產,以及分子束研究、真空鍍膜設備、真空表面分析儀器、離子注入機...
大角度離子注入機質量分析器設計[C]// 全國電子束、離子束、光子束學術年會. 2005. 4. 王成智. 近年質譜儀器發展動向[J]. 分析儀器, 1977(4):23-33. 5...
