高科技發展,人們需要性能高、體積小、功能多的電子產品,促使印製線路板製造也向輕、薄、短、小發展,有限空間,實現更多功能,布線密度變大,孔徑更小。自1995 年至2005 年間,機械鑽孔批量能力最小孔徑從原來0.4mm 下降到0.2mm,甚至更小。金屬化孔孔徑也越來越小。層與層間互連所依賴的金屬化孔,質量直接關係印製板可靠性。
基本介紹
- 中文名:雙面電路板
- 外文名:Double-sided circuit board
- 性能:輕、薄、短、孔徑更小
- 本質:電子產品
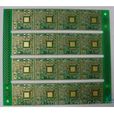
高科技發展,人們需要性能高、體積小、功能多的電子產品,促使印製線路板製造也向輕、薄、短、小發展,有限空間,實現更多功能,布線密度變大,孔徑更小。自1995 年至2005 年間,機械鑽孔批量能力最小孔徑從原來0.4mm 下降到0.2mm,甚至更小。金屬化孔孔徑也越來越小。層與層間互連所依賴的金屬化孔,質量直接關係印製板可靠性。
雙面電路板編輯 鎖定 高科技發展,人們需要性能高、體積小、功能多的電子產品,促使印製線路板製造也向輕、薄、短、小發展,有限空間,實現更多功能,布線密度變大,...
雙面PCB板是電路板中很重要的一種PCB板,市場上有雙面線路板金屬基地PCB板、Hi-Tg重銅箔線路板、平的蜿蜒的雙面線路板、高頻率的PCB、混合介電基地高頻雙面線路板...
雙面線路板是由崑山金鵬電子有限公司大型電路板生產基地提供說明生產雙面電路板, PCB板,線路板,SMT焊接等等。...
雙層線路板,是指雙面有銅,而且有金屬化孔的,也就是說雙面有銅,而且孔裡面也有銅,對於線路板雙面來說,孔里有銅特別重要,因為最早,最困難的就是孔里有銅(如何...
單面PCB電路板,是印刷電路板的一種。只有PCB板的一面有線路(可以有孔,也可以無孔),另一面為基材或直接絕緣油墨覆蓋,無任何線路並且置於強光下整板透光(除去個別...
單面電路板指的是在最基本的PCB上,零件集中在其中一面,導線則集中在另一面上,導線只出現在其中一面的意思。因為單面電路板在設計線路上有許多嚴格的限制(因為...
電路板的名稱有:陶瓷電路板,氧化鋁陶瓷電路板,氮化鋁陶瓷電路板,線路板,PCB板,鋁基板,高頻板,厚銅板,阻抗板,PCB,超薄線路板,超薄電路板,印刷(銅刻蝕技術)電路...
中文名稱:高難度PCB板英文名稱:High PCB board定 義:是用環氧樹脂等材料製成的雙面或多層電路板。套用學科:物理學(一級學科);材料物理學、電學(二級學科)...
柔性電路板又稱“軟板”,是用柔性的絕緣基材製成的印刷電路。柔性電路提供優良的電性能,能滿足更小型和更高密度安裝的設計需要,也有助於減少組裝工序和增強可靠性...
雙面板是中間一層介質,兩面都是走線層。多層板就是多層走線層,每兩層之間是介質層,介質層可以做的很薄。多層電路板至少有三層導電層,其中兩層在外表面,而剩...
印製電路板{PCB線路板},又稱印刷電路板,是電子元器件電氣連線的提供者。它的發展已有100多年的歷史了;它的設計主要是版圖設計;採用電路板的主要優點是大大減少...
PCB( Printed Circuit Board),中文名稱為印製電路板,又稱印刷線路板,是重要的電子部件,是電子元器件的支撐體,是電子元器件電氣連線的載體。由於它是採用電子印刷...
多功能電路板,是一種新型的電路板,由電路實驗板和電路元件所組成。與現有技術相比,由於印刷電路板上同時集成有三種不同的輸出電路,並且通過路由控制電路來方便地...
電路板製作使電路迷你化、直觀化,對於固定電路的批量生產和最佳化用電器布局起重要作用。...
線路板PCB是英文(Printed Circuie Board)印製PCB,線路板的簡稱。通常把在絕緣材上,按預定設計,製成印製線路、印製元件或兩者組合而成的導電圖形稱為印製電路。...
這種PCB,線路板覆銅簿板材,我們就稱它為剛性板。再製成印製PCB,線路板,我們就稱它為剛性印製PCB,線路板。單面有印製線路圖形我們稱單面印製線路板,雙面有印製...
PCB( Printed Circuit Board),中文名稱為印製電路板,又稱印刷線路板,是重要的電子部件,是電子元器件的支撐體,是電子元器件電氣連線的載體。由於它是採用電子印刷...
多層板的製作方法一般由內層圖形先做,然後以印刷蝕刻法作成單面或雙面基板,並納入指定的層間中,再經加熱、加壓並予以粘合,至於之後的鑽孔則和雙面板的鍍通孔法...
感光電路板又叫光印線路板,是通過光線直接照射均勻塗在電路板的感光藥膜,有光照的地方的藥膜會被顯影劑溶解,沒有溶解的感光膜保留在電路板的銅皮上,不讓三氯化鐵...
中國電路板的名稱有線路板,PCB板,鋁基板等,一般不太容易看出實際數目。...... 中國電路板的名稱有線路板,PCB板,鋁基板...,多層板用上了更多單或雙面的布線板。...
PCB(Printed Circuit Board)印製板,也叫印製電路板、印刷電路板。多層印製板,就是指兩層以上的印製板,它是由幾層絕緣基板上的連線導線和裝配焊接電子元件用的...
