金屬與合金的各種相的形貌(形狀、大小和分布等)、晶體結構、化學組成等微觀的研究,統稱微觀分析。金屬與合金的性能與其顯微組織密切相關。隨著微束分析儀器的不斷發展,對金屬與合金的分析也逐漸深入,由過去的毫米、微米尺度正在進入到納米(1nm=10m=10┱)尺度。在某些特殊情況下,甚至可以直接觀察單個原子,並確定其原子序數。根據微束源不同,微觀分析儀器可分光子、電子和離子束三大類(圖1)。此外中子衍射也有所套用。
基本介紹
- 中文名:金屬和合金的微觀分析
- 領域:晶體結構
- 學科:化學
- 類別:科學分析
研究歷史
過去,合金中的第二相顆粒的化學成分,主要是用化學或電化學方法,先將它們從基體中分離出來,再用常規化學分析方法測定,如過渡族金屬在鋁合金中與鋁形成的化合物和在合金鋼中與碳形成的合金碳化物等(見合金相)。套用雷射技術,在光學顯微鏡中安裝雷射源,使雷射通過透鏡中心孔射到金相試樣上選好的第二相顆粒上,測定所含各元素的發射光譜,可以測定微區成分,但是雷射束的直徑在10m以上,因此這種雷射探針只適用於分析如鋼中夾雜物、礦物及爐渣中較粗大的顆粒。
電子顯微鏡的問世把放大倍率由光學顯微鏡的一千多倍提高到掃描電子顯微鏡(SEM)的幾萬倍或透射電子顯微鏡(TEM)的幾十萬倍(見電子顯微學)。不僅如此,電子顯微鏡還發展成為一個全面的微束分析儀器,既能觀察幾個埃(┱)的微觀細節,還能進行幾十埃範圍的晶體結構分析(選區或微束電子衍射)和成分分析(X射線譜或電子能量損失譜)。
X射線波譜和電子探針 聚焦的電子束照射到試樣上,使其中的原子失掉核外電子而處於激發的電離態(圖2a),這是不穩定的,外層電子會迅速填補內層電子空位而使能量降低(圖2b)。4釋放出來的能量(在圖中是-)可以產生該元素的具有特徵波長或能量的標識X射線譜。根據這些X射線的波長不同,經分析晶體展譜(X射線波譜,wave dispersive spectroscopy,簡寫為 WDS)或根據X射線光子能量不同由半導體探測器等展譜(X射線能譜,energy dispersive spectroscopy,簡寫為EDS)。X射線波譜儀的構造原理與X射線螢光譜儀基本相同,只不過是用電子而不是用X射線作為激發源。X射線波譜儀的特點是解析度高,因此分析的精度高而檢測極限低,此外,根據布喇格定理2sin=,採用晶面間距大的分光晶體,可以分析標識X射線波長為的硼、碳、氮、氧等輕元素。它的缺點是分光晶體接受X射線的立體角小,X射線的利用率低;此外,試樣要求象金相試樣那樣表面平正光潔,不能分析凸凹不平的試樣。電子探針(electron microprobe,簡寫為EMP)就是由幾個電磁透鏡組成的照明系統與 X射線波譜儀結合在一起的微束分析儀器,電子束焦斑直徑一般是0.1~1m。將金相試樣置於電子探針儀中,用靜止的電子束可以得到定點的分析結果,也可以用掃描電子束得到一些元素在一條直線上的一維分布或一個面上的二維分布。電子探針在分析合金中第二相的成分、偏析、晶界與表層成分方面用途很廣(見界面)。
研究儀器
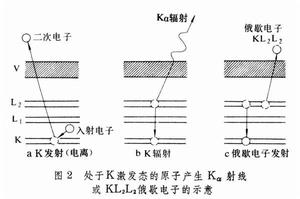 金屬和合金的微觀分析
金屬和合金的微觀分析優劣分析
電子能量損失譜(electron energy loss spectro-scopy,簡寫為EELS) 能量為的入射電子與試樣中原子的非彈性碰撞使後者電離而處於較高能量的激發態(圖2a中是K激發態、能量為),入射電子損失的能量為+,為二次電子的逸出功。由此可見,對於不同元素,電子能量損失有不同的特徵值。使透射電子顯微鏡中的成像電子經過一個靜電或電磁能量分析器,按電子能量不同分散開來。除了有一個很強的無能量損失的彈性電子能量峰外,還會出現一些與試樣中各元素相對應的較弱的具有特徵能量損失的峰。儘管這些峰不很明銳(較好的水平是2~3eV),定量分析還存在一定困難,但是由於它有下列兩個顯著優點而在透射電子顯微術中逐漸得到廣泛套用:一是可以分析B、C、N、O等輕元素;二是將電子束聚焦到幾十埃就可以測出微小區域的組成。顯然,入射電子由於產生標識X射線而損失一定能量(圖2a、b),可見電子能量損失譜和X射線能譜有著密切關係。
俄歇電子譜 圖2中所描述的K電子復位所釋放出來的能量-,除了產生K輻射這種可能性外,還有一種可能性是繼續產生電離,使另一核外電子脫離原子變成二次電子。如->,這就有可能使L、L、M、N層以及導帶V上的電子逸出,產生相應的電子空位(圖2c),圖2c中的二次電子稱為KLL電子,它的能量等於---(為電子逸出功),因此也有固定值,隨元素不同而異。這種具有特殊能量的電子是俄歇(Auger)首先發現的,稱為俄歇電子。既然俄歇電子有特徵能量值,因此也可以利用來進行元素分析,稱為俄歇電子譜(Auger electron spectroscopy,簡寫為AES)。俄歇電子的能量很低,一般是幾百電子伏,因此其平均自由程非常短,一般小於10┱。大於這個距離,俄歇電子就要損失能量,不再有特徵能量值;即具有特徵能量的俄歇電子的來源僅限於表面二、三層原子。因此,俄歇電子譜繪出的是表面二、三個原子層的成分,用離子槍逐層剝離表面上的原子層,還可以分析幾十到幾千埃深度內的成分變化。輕元素的螢光(X射線)產額低而俄歇電子產額高,因此俄歇電子譜宜於用來檢測表面或界面上的輕元素。但俄歇電子的信號是很微弱的,需要用靈敏度高的鏡筒(能量)分析器及鎖定放大器將它挑選並檢測出來,這是俄歇譜儀的關鍵部件;此外,試樣還需要在超高真空中製備,以免表面上吸附氣體分子造成不真實的分析結果。圖5是一種鉻鉬釩鋼在具有回火脆性狀態下晶界斷口的俄歇電子譜,磷峰很明顯,相當於晶界上單原子中有8%是磷原子。用離子槍從斷口表面剝離幾個原子層後,磷峰即迅速減弱,說明在具有回火脆性的鋼中磷在晶界的偏析也僅是幾個原子層, 但濃度很高, 這是產生沿晶界脆斷的原因。除了界面偏析外,俄歇電子譜儀還可以用來研究金屬與合金的氧化、腐蝕、催化作用等表面化學反應。將電子束聚焦到微米量級並在試樣上掃描,配上俄歇電子譜儀進行成分分析,就構成一台掃描俄歇電子譜儀,它可以檢測出表面和界面上化學成分的變化,並可顯示出組成元素的二維分布,因而也稱為掃描俄歇顯微鏡(scanning Auger microscope,簡寫為SAM)。
金屬和合金的微觀分析電子能譜化學分析(electron spectroscopy for chemical analysis,簡寫為ESCA) 是用光子或X射線光子(如Al的K或Mg的K)照射試樣,使其中的原子電離產生光電子。這種電子有特徵能量,一般在20~1500eV之間, 可以用來分析4~20┱厚的表面成分。X射線光子不能聚焦,因此試樣上的照射面積比較大,不能象俄歇電子譜那樣分析微區的表面成分;但是,由於電子的結合能與元素的價態有關,因此這種電子譜可以給出表面原子的化學結合狀態(鍵),因此稱為電子能譜化學分析。這對於研究金屬與合金的氧化、腐蝕、催化作用等也是很有利的。將電子能譜化學分析儀,俄歇電子譜儀,二次離子質譜儀等表面分析儀器組合在一起,便成為多功能表面分析儀。
低能電子衍射只反映表面幾層原子的分布,也就是表面的二維晶體結構。低能電子衍射與俄歇電子譜結合在一起是研究晶體表面結構和成分的有力工具。
場離子顯微鏡(fieldion micro-scope,簡寫為FIM) 是結構簡單而放大率可達幾百萬倍的顯微鏡,其原理是利用施加到試樣上的高壓,在試樣尖端處(曲率半徑為幾百埃)產生強電場使附近的惰性氣體原子電離,射向螢光屏產生試樣的場離子象,其放大倍數由投影距離和試樣尖端半徑之比確定。圖6是鎢的場離子象,反映試樣尖端的原子排列,圖像中的亮點是表面上處於凸出位置的原子。原子在一些平行的原子平面上排列,形成許多台階,這裡場強最大,容易產生氣體離子並成像,因此比較容易觀察到原子平面邊緣處的一圈一圈的原子。但是在一些原子排列稀疏的平面上,可以觀察到整個原子平面上諸原子的規則排列。由此可見,場離子顯微鏡是研究空位等晶體缺陷及固體表面結構的重要手段。場離子顯微鏡的缺點是試樣難於製備,並且要觀察大量試樣才能得到要觀察的視場。
金屬和合金的微觀分析原子探針 將場離子顯微鏡配上飛行時間質譜儀,以測定表面上原子的種類與數量,就構成一台原子探針(atom probe, 簡寫為AP)。除原來施加在試樣上的高壓外,再利用短時間(幾微秒)的脈衝電壓使試樣尖端表面上的原子電離和蒸發並離開表面飛向檢測器,由它將飛來的離子逐個地接收記錄下來,不同離子的質量與電荷比不同,達到檢測器的飛行時間也不同,據此可以鑑定原子類型及數量。此外,還可將試樣尖端各種原子的分布圖象直觀地顯示在螢光屏上,圖7是金屬鉬中M o離子及O離子的圖像。從鉬離子圖像可以看出在這個視場內有三個晶粒形成的一個三重結點晶界;而氧離子圖象說明晶界處有氧的富集,這可能就是鉬變脆的原因。此外,還可以在原子探針內將試樣表面的原子逐層剝除,研究金屬表層內的成分在垂直表面方向的變化。
金屬和合金的微觀分析離子探針 用能量為1~30keV 的一次離子束轟擊試樣表面,也可以使表面原子電離變成離子濺出,用雙聚焦質譜儀檢測並分析這種二次離子就可以得出試樣表面4~20┱的成分及其隨深度的變化,這就是二次離子質譜(secondary ion mass spectroscopy,簡寫為SIMS)。如果將一次離子束聚焦到1m 甚至更小,並令其在試樣上掃描,就可以得到表面上定點的微區成分分析或二維的成分圖像。這種微束二次離子質譜儀稱為離子探針(ion micro-prooe)。二次離子質譜的特點是:①可以分析包括氫在內的各種同位素,如用離子探針檢測出鋼中夾雜物內吸附有氫,以及氫在鈦的晶界上的偏聚;②靈敏度極高(10%),可以分析半導體中的雜質及注入元素的深度分析;③可以進行同位素的豐度分析。缺點是圖譜比較複雜,不易辨識, 最好與其他分析手段結合在一起使用。為了表面及深度分析,又常使用大焦斑 (≥100m)的一次離子束。如果使一次離子束在試樣表面掃描,可直接得到離子束照射範圍內的二次離子象,得出有關原子分布的信息。這種離子探針也稱為離子顯微鏡(ion microscope)。(見彩圖)
金屬和合金的微觀分析
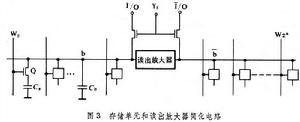 金屬和合金的微觀分析
金屬和合金的微觀分析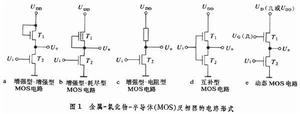 金屬和合金的微觀分析
金屬和合金的微觀分析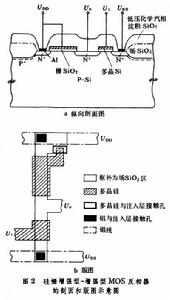 金屬和合金的微觀分析
金屬和合金的微觀分析 金屬和合金的微觀分析
金屬和合金的微觀分析 金屬和合金的微觀分析
金屬和合金的微觀分析 金屬和合金的微觀分析
金屬和合金的微觀分析