膜厚探測系統又稱薄膜檢測系統,用於測量薄膜的厚度。現有的薄膜厚度測量技術中,光學厚度測量技術測量精度高,然而難以實現大厚度薄膜測量;非光學厚度測量技術可實現大厚度薄膜測量,但是測量誤差大。
基本介紹
- 中文名:膜厚探測系統
- 外文名:The film thickness detection system
- 學科:工程技術
- 又稱:薄膜檢測系統
- 作用:測量薄膜的厚度
- 方法:光學和非光學厚度測量技術
研究意義,非光學方法,電容測厚法,力學顯微鏡測厚法,其它非光學方法,光學方法,紅外光譜分析測厚法,射線測厚法,雷射測厚法,光干涉測厚法,基於FPGA的金屬膜厚檢測系統,
研究意義
隨著薄膜在顯示與觸摸、醫療衛生、農業生產等行業套用越來越廣泛,市場對薄膜產品的需求量不斷擴大。在我國第十二個五年計畫期間,薄膜市場規模年均增長率超過兩成以上。隨著薄膜的種類越來越多,厚度範圍越來越廣。有厚度為幾十微米以下的小厚度薄膜,也有厚度為幾百到幾千微米的大厚度薄膜。比如套用於感光材料、電器絕緣和光學鏡片表面保護等領域的PET膜厚度規格有36微米、125微米等;套用於液晶顯示器、太陽能電池和微電子等領域的導電膜厚度一般在100微米到1000微米之間;套用於尾礦儲存場、渠道防滲和捷運工程等具有防水阻隔功能的土工膜厚度一般在200微米到3000微米之間。
在薄膜的所有性能指標中,薄膜的厚度是衡量其質量的主要指標。薄膜厚度是否達到標準對薄膜表面特性、光學特性、阻隔性以及拉伸強度等都有很大影響,將薄膜厚度偏差控制在生產要求範圍以內是保證薄膜其它特性的重要前提條件。隨著薄膜的廣泛套用及科學技術的快速發展,各行業對薄膜產品的質量要求越來越高。為了提高薄膜產品質量,必須嚴格控制薄膜的厚度,然而大範圍的薄膜厚度規格和高精度的產品質量需求對薄膜測量技術提出了更高的要求。現有的薄膜厚度測量技術中,光學厚度測量技術測量精度高,但難以實現大厚度薄膜測量;非光學厚度測量技術可實現大厚度薄膜測量,但是測量誤差大。且上述兩種厚度測量技術還存在實現難度大、研製成本高等問題。我國在厚度測量技術領域發展較晚,與國外相比,研究水平還遠遠落後於美國及歐洲國家,國內高性能的薄膜厚度測量設備都是從國外進口,價格十分昂貴。
非光學方法
電容測厚法
電容測厚法的原理是根據電容感測器電容與極板之間的介質介電常數和介質厚度關係實現厚度測量。2001年,鄧湘等人設計了基於電容感測器的薄膜厚度測量系統。該系統如圖1-2所示,測量範圍為10微米到100微米,誤差在 以內。
以內。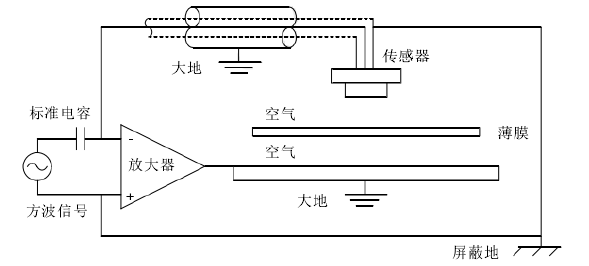 鄧湘設計的測厚系統
鄧湘設計的測厚系統

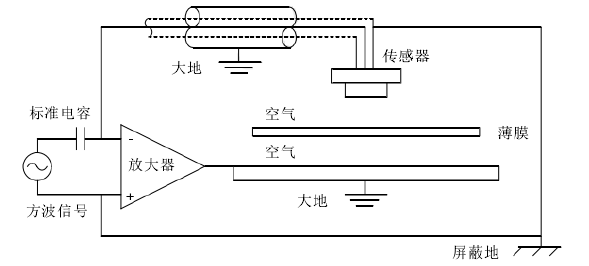 鄧湘設計的測厚系統
鄧湘設計的測厚系統力學顯微鏡測厚法
該方法包括基於原子力顯微鏡(AFM)的測厚方法和基於磁力顯微鏡(MFM)的測厚方法。基於AFM的測厚方法依據AFM的力敏感元件和物體表面之間的原子間相互作用力實現厚度測量。基於MFM的測厚方法依據磁力顯微鏡磁性探針與物體表面雜散磁場之間的相互作用力實現厚度測量。
其它非光學方法
除了上述兩種非光學測厚法以外,還有機械測厚法和超音波測厚法可用於測量薄膜厚度。機械測厚法對被測薄膜無特殊要求,測量結果穩定、可靠。但容易造成薄膜損壞,存在對環境振動敏感、測量效率低等問題。超音波測厚法利用超音波反射原理實現厚度測量。該方法安全、可靠,可適應於高溫環境。但測量精度難以達到微米量級,且對被測薄膜種類具有選擇性。
光學方法
紅外光譜分析測厚法
紅外光譜分析測厚法根據某一化學物質如分子、離子或自由基等,由於吸收了紅外電磁波的能量,使得該化學物質在電子基態時轉動、振動或轉動一振動能量產生變化,進而實現厚度測量。
紅外光譜分析測厚法精度高。但該方法對顏色敏感,不適用於多顏色薄膜厚度的測量。
射線測厚法
射線測厚法優點是穩定性好,不受被測物抖動、表面形貌等影響。但由於射線的物理特性使得射線厚度測量方法存在如下缺點:受大氣壓、溫度、材料影響較大;實現難度大,研製成本高,一般在十幾萬美元以上;由於射線會危害到人體的健康,基於射線技術的薄膜厚度測量設備廣泛推廣套用受到限制。
雷射測厚法
雷射測厚法通過兩個雷射器同時發出兩束雷射照射到被測薄膜的上下表面,分別測得兩個雷射器到薄膜上下表面的距離,求差後得到薄膜厚度。
雷射測厚法的優點是可以消除測量過程中薄膜振動的影響。但存在的最大不足之處是掃描測量過程中必須保證兩個雷射器發射光束同軸。因此,該方法的實現難度較大。
光干涉測厚法
光干涉測厚法根據相干光干涉形成等厚干涉條紋,通過對干涉圖樣分析處理得出薄膜厚度。光干涉測厚法的優點是精度高,易於實現,可快速掃描測量。但不足之處是只適用於微米級以下的薄膜厚度測量。
基於FPGA的金屬膜厚檢測系統
在金屬厚度測量套用中,電渦流檢測技術得到了廣泛的研究與套用。在套用渦流技術對金屬厚度進行測量時,為了消除提離距離變化的影響,可採用多頻激勵模式下具有的峰值特徵信息確定被測金屬的厚度。基於這一原理,陳立晶等利用基於FPGA晶片設計的多頻激勵模式控制系統實現對金屬膜厚度的實時線上測量。選用基於FPGA的系統設計,可發揮FPGA晶片中集成的各種功能核的作用,簡化系統設計、降低系統成本;同時FPGA程式能實現並行運行,提高了系統的實時性。套用三次樣條插值和保形擬插值分別對測試多層鋁箔的頻率回響曲線和標定曲線進行插值逼近,結果表明,套用該系統進行金屬厚度的測量可以給出令人滿意的結果。



