基本介紹
- 中文名:耗盡層
- 外文名:depletion region
- 影響因素:溫度偏置電壓的大小
- 類型:一個高電阻區域
- 學科:物理
定義,p-n結,正向偏壓,反向偏壓,MOS電容器,
定義
耗盡層(depletion region),又稱耗盡區、阻擋層、勢壘區(barrier region),是指PN結中在漂移運動和擴散作用的雙重影響下載流子數量非常少的一個高電阻區域。耗盡層的寬度與材料本身性質、溫度以及偏置電壓的大小有關。
耗盡區是這樣命名的,因為它是由導電區域通過除去所有自由電荷載體而形成的,而不留下任何電流。了解耗盡區是解釋現代半導體電子器件的關鍵:二極體,雙極結型電晶體,場效應電晶體和可變電容二極體都依賴於耗盡區現象。
以下討論限於p-n結和MOS電容器,但是在上述所有裝置中都會出現耗盡區。
p-n結
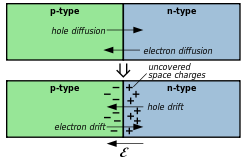 圖1 頂部:擴散前的p-n結; 底部:達到平衡後
圖1 頂部:擴散前的p-n結; 底部:達到平衡後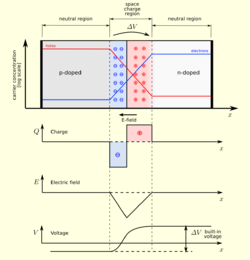 圖2 從上到下
圖2 從上到下圖2 中從上到下;頂部:通過結的空穴和電子濃度;第二:電荷密度;第三:電場;底部:電勢
電子和空穴擴散到電子和空穴濃度較低的區域,很像墨水擴散到水中,直到它均勻分布。根據定義,與P型區域相比,N型半導體具有過量的自由電子,並且與N型區域相比,P型具有過量的空穴。因此,當N摻雜和P摻雜的半導體片放置在一起形成結時,電子遷移到P側並且空穴遷移到N側。電子從N側向P側的離開在N側後面留下正向施主離子,並且同樣在P側上離開負受主離子。
在轉移之後,擴散的電子與P側上的空穴接觸並通過複合消除。對於N側的擴散孔也是如此。最終的結果是擴散的電子和空穴消失了,在沒有移動載體的區域留下與界面相鄰的帶電離子(這就是為什麼稱為耗盡區,載流子被耗盡的原因)。未補償的離子在N側為正,在P側為負。這創造了一個電場這提供了反對電荷載體持續交換的力量。當電場足以阻止空穴和電子的進一步轉移時,耗盡區達到其平衡尺寸。在耗盡區上積分電場決定了所謂的內建電壓(也稱為結電壓或勢壘電壓或接觸電勢)。
- 在數學上講,半導體器件中的電荷轉移是由於電場(漂移)和擴散導致的傳導。對於P型區域,空穴以電導率σ傳導並且以擴散常數D擴散,淨電流密度由下式給出
正向偏壓
正向偏壓(P相對於N為正值)縮小了耗盡區域並降低了載流子注入的阻擋(如右圖所示)。更詳細地說,大多數運營商從偏見領域獲得一些能量,使他們能夠進入該地區並抵消相反的費用。發生越多的中和(或區域中的離子篩選)越偏向。載流子可以重新結合到離子上,但是當費米能量接近時,熱能立即使得重新結合的載流子返回。當偏置足夠強使得耗盡區變得非常薄時,電流的擴散分量大大增加,漂移分量減少。在這種情況下,淨電流在p-n結的圖中是向右的。載流子密度很大(隨施加的偏壓電壓呈指數變化),電流的數學描述由肖克利二極體方程提供。反向偏置下的低電流和正向偏置下的大電流是整流的一個例子。
反向偏壓
在反向偏壓下(P相對於N為負),耗盡區上的電壓降(即,電壓)增加。更詳細地說,大多數載流子被從連線處推開,留下更多的帶電離子。因此耗盡區域變寬,電場變強,增大了電流的漂移分量,減小了擴散分量。在這種情況下,淨電流在p-n結的圖中是向左的。載流子密度(主要是少數載流子)很小,只有非常小的反向飽和電流流過。
MOS電容器
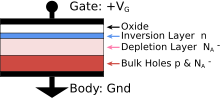 圖4 P型矽上的金屬氧化物半導體結構
圖4 P型矽上的金屬氧化物半導體結構耗盡區的另一個例子發生在MOS電容器中。在右圖中顯示了對於P型襯底。假設半導體最初是電荷中性的,由於空穴由於受主摻雜雜質而被負電荷精確地平衡,如果現在將正電壓施加到柵極,這是通過將正電荷Q引入柵極來完成的,則最靠近柵極的半導體中的一些帶正電的空穴被柵極上的正電荷排斥,並通過底部接觸。他們留下了枯竭因為沒有可移動的孔而保溫的區域;只有不動的,帶負電的受主雜質。放置在柵極上的正電荷越大,施加的柵極電壓越正,並且離開半導體表面的空穴越多,擴大耗盡區域。(在這個器件中,耗盡寬度可能變寬的程度有一個限制,它是由薄層或溝道表面附近的載流子反轉層開始設定的,上述討論適用於足夠低的正電壓反演層不形成)。
如果柵極材料是與體半導體相反類型的多晶矽,則如果柵極與襯底電短路,則形成自發耗盡區,其方式與針對上述p-n結描述的方式大致相同。
電荷中性原理說,正電荷的總和必須等於負電荷的總和:
其中n和p是自由電子和空穴的數量, 和
和 分別是離子化的供體和受體的數量。如果我們假設完全電離和那個
分別是離子化的供體和受體的數量。如果我們假設完全電離和那個 , 然後:
, 然後:











MOS電容中的耗盡寬度
與p-n路口一樣,這裡的管理原則是電荷中立。讓我們假設一個P型襯底。如果正電荷Q被放置在門,然後孔被耗盡到深度瓦特暴露足夠的負受體恰好平衡柵極電荷。假設摻雜劑密度是 每單位體積的受體,則電荷中性要求耗盡寬度w滿足以下關係:
每單位體積的受體,則電荷中性要求耗盡寬度w滿足以下關係:





