線寬粗糙度(Line Width Roughness, LWR)描述的是由於邊緣粗糙導致的光刻膠線寬相對於目標值的偏離。
基本介紹
- 中文名:線寬粗糙度
- 外文名:Line Width Roughness
- 英文縮寫:LWR
線寬粗糙度(Line Width Roughness, LWR)描述的是由於邊緣粗糙導致的光刻膠線寬相對於目標值的偏離。
測量方法
目前對半導體的研究經常採用掃描電子顯微鏡和AFM進行比對測量。
線寬粗糙度是通過高解析度電子顯微鏡測量的。圖1是一條光刻膠線條的示意圖。電鏡觀察視窗中光刻膠線條的長度是L,電鏡對線條等間距的掃描N次。相鄰掃描之間的間距是 ,
, 。
。 和
和
 是線條的左邊和右邊的邊界。每一次掃描所測得的線條寬度為
是線條的左邊和右邊的邊界。每一次掃描所測得的線條寬度為






平均線寬為

每一次線寬的測量值和平均值的偏差是 。線寬測量的標準偏差為
。線寬測量的標準偏差為


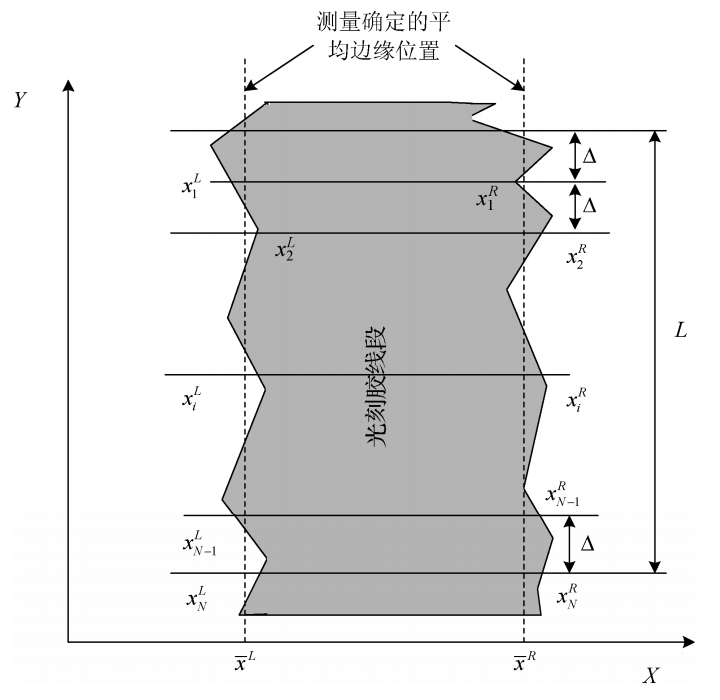
圖1 一段光刻膠線條的示意圖
但採用 SEM 測量存在以下缺陷: ① 環境要求苛刻,必須在真空中測量樣本。② 要求樣本為導體或半導體,這可能在實際測量中由於SEM使用電子束掃描而損壞某些樣本。③ 只有橫向解析度,不能獲得刻線三維形貌。上述缺點限制了 SEM的套用。AFM由於對樣本的廣泛適用性及能夠獲取樣本的三維圖像,套用領域不斷擴大,已成為SEM的有益補充。