溝道熱電子注入(Channel hot electron injection,CHE)效應是小尺寸MOSFET中熱電子所呈現出的一種現象,也稱為溝道雪崩注入效應,即是溝道中部分高能量的熱電子往柵氧化層注入的一種現象。
基本介紹
- 中文名:溝道熱電子注入效應
- 外文名:Channel hot electron injection,CHE
- 別稱:溝道雪崩注入效應
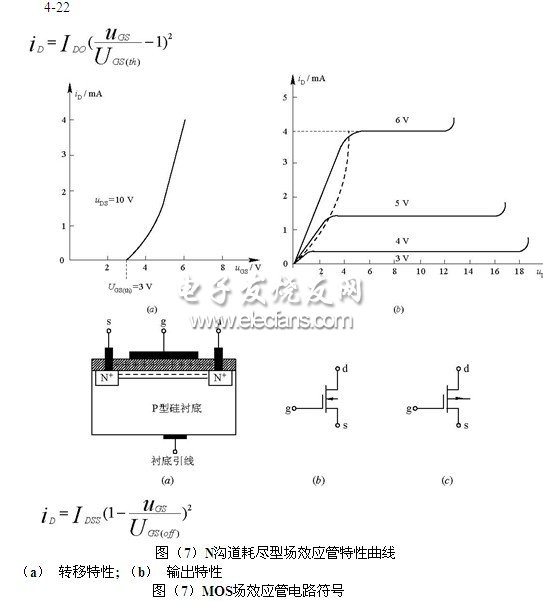
溝道熱電子注入(Channel hot electron injection,CHE)效應是小尺寸MOSFET中熱電子所呈現出的一種現象,也稱為溝道雪崩注入效應,即是溝道中部分高能量的熱電子往柵氧化層注入的一種現象。
溝道熱電子注入(Channel hot electron injection,CHE)效應是小尺寸MOSFET中熱電子所呈現出的一種現象,也稱為溝道雪崩注入效應,即是溝道中部分高能量的熱電子往柵...
11.2.1 熱電子注入 11.2.2 柵極電子注入 11.2.3 逆壓電效應 11.3 GaN HEMT的電應力退化(一) 11.3.1 溝道熱電子注入應力 11.3.2 柵極電子注入應力...
如果注入離子的半徑較小,它沿著敞開的晶體方向注入時,溝道效應更加顯著。矽的<...晶格原子的熱振動以及原子核和核外電子引起的多次散射等原因,在散射角積累到大於...
、可靠性機制(溝道熱電子注入、Fowler-Mordheim隧穿、帶間熱空穴產生和注入、p...第6章 金屬—氧化物—半導體及其他場效應電晶體 600 引言 610 反型溝道MOSFET...
長度降低而降低、漏致勢壘降低、載流子表面散射、速度飽和、離子化和熱電子效應。...熱載流子在兩個方面影響器件性能:1)越過Si-SiO2勢壘,注入到氧化層中,不斷積累...
溝道雪崩注入效應是小尺寸MOSFET中熱電子所呈現出的一種現象,也稱為溝道熱電子注入效應,即是溝道中部分高能量的熱電子往柵氧化層注入的一種現象。...
主要有兩種技術來改變存儲在閃速存儲器單元的數據:溝道熱電子注入(CHE)和Fowler-Nordheim隧道效應(FN隧道效應)。所有的閃速存儲器都採用FN隧道效應來進行擦除。至於...
這是著眼於減短溝道長度的一種橫嚮導電MOSFET,通過兩次擴散而製作的器件稱為...擊穿電壓提高,而電離倍增和熱電子注入效應降低;電極均在同一表面上, 容易集成。...
