基本介紹
- 中文名:曝光後烘烤
- 外文名:Post Exposure Bake
- 英文縮寫:PEB
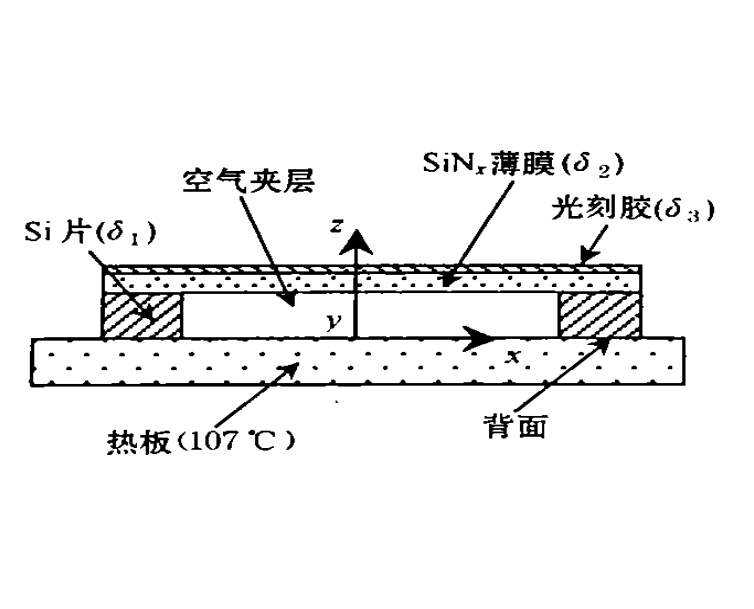
曝光後烘烤是以一定溫度烘烤曝光後的矽片,目的是降低駐波效應的影響以及使化學反應更充分...
曝光是利用光照將掩模版上的圖形經過光學系統後投影到光刻膠上,實現圖形轉移,是積體電路製造中光刻工藝的重要工序之一。...
兩次曝光之後,晶片做烘烤和顯影。工藝流程簡寫為:光刻膠旋塗-曝光1-曝光2-顯影-刻蝕(litho-litho-etch, LLE)。所以,雙重曝光是在同一層光刻膠上曝光兩次,兩次...
在塗膠和烘烤完成後,晶圓被傳送到邊緣曝光單元。邊緣曝光單元也是勻膠顯影機的一部分。晶圓的邊緣部分被曝光,激發光化學反應。這樣在最後顯影時,邊緣的光刻膠就與...
去保護反應指的是曝光後晶圓需要立即被傳送到勻膠顯影機內的熱盤上,進行烘烤。這一步又叫曝光後烘烤,或後烘烤(PEB)。...
光致酸產生劑是一種光敏感的化合物,在光照下分解產生酸(H+)。在曝光後烘烤(PEB)過程中,這些酸會作為催化劑使得聚合物上懸掛的酸不穩定基團脫落,並產生新的酸...
曝光後烘烤(Post Exposure Bake,PEB)步驟可以理解為簡單的Fickian擴散。這些假設適用於i-line、h-line、g-line DNQ 型光刻膠的建模。圖1是 DNQ 型光刻膠光敏...
控制後段烘烤之塗膜厚度在15-35微米為較適當的範圍,塗膜厚度太薄會造成不耐噴錫、鍍化金等製程,塗膜厚度太厚,可能會造成殘膜或是預烤不足,導致曝光沾粘底片。...
(TMAH 顯影液); 曝光激發光化學反應,產生了酸,經烘烤後(de-protection reaction)聚合物的極性發生了變化,成為親水的聚合物(hydrophilic polymer),不再溶於 NTD ...
光線透過一個掩模把掩模上的圖形投影在晶圓表面的光刻膠上,實現曝光,激發光化學反應。對曝光後的晶圓進行第二次烘烤,即所謂的曝光後烘烤,後烘烤是的光化學反應...
防焊在pcb大排版面印刷油漆,簡單烘烤後按相應外掛程式位置曝光並洗去不需要部分,印刷文字方便外掛程式與後續維修。...
為提高底片的探測量子效率和靈敏度,在曝光前後或曝光時對底片所作的特殊處理。 從二十世紀四十年代開始,已經有人採用烘烤等敏化技術。十多年來,發展了氣體敏化...
烘烤溫度過低將延長烘乾時間,烘烤時間過短,印刷時會出現爛版現象。6.後處理。即除粘與後曝光。使感光樹脂徹底硬化(聚合)達到應有的硬度指標,並消除印版粘性,以...
