基本介紹
- 中文名:半導體多重圖形製造法
- 外文名:Semiconductor multi-pattern manufacturing method
- 學科:電氣工程
中心距分離,側壁圖像轉移,
中心距分離
多重圖形的最簡單形式是將圖形分離成二個或者三個部分。每個部分按照通常的製程方法進行製作。整個圖形最終會合併形成最終的圖層。這種方法有時稱為中心距分離,也會被稱為光照-刻蝕-光照-刻蝕(LELE)。
這種技術用於20納米製程、14納米製程等。額外暴光的成本在相關製程中可以承受。一個重要的關注點是多次暴光中的圖形交疊問題。自對準多重暴光技術成功的引入解決這一問題。
側壁圖像轉移
多重圖形介紹:側壁是一個通過將預圖形兩邊澱積而產生的物質。由於側壁使用的是hardmask材料,它們的後刻蝕圖形質量非常重要。
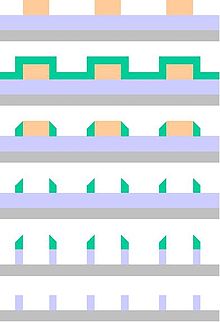
在間隔物圖案化中,間隔物是在預先形成圖案的特徵的側壁上形成的膜層。通過在先前的圖案上沉積或反應膜來形成間隔物,隨後通過蝕刻去除水平表面上的所有膜材料,僅留下側壁上的材料。通過去除原始的圖案特徵,僅留下間隔物。但是,由於每條線都有兩個墊片,因此線密度現在翻了一番。例如,隔離技術適用於以原始光刻間距的一半來定義窄柵極。
由於不同曝光部件之間的特徵位置可能存在差異,因此間距分割變得更加困難,側壁圖像轉印(SIT)已成為更為公認的必要方法。SIT方法通常需要在蝕刻特徵的側壁上形成間隔層。如果該隔離片對應於導電特徵,那么最終必須在不少於兩個位置處切割該隔離片以按照通常所預期的將特徵分成兩條或更多條導線。另一方面,如果間隔件對應於介電特徵,則切割將不是必需的。預測先進邏輯模式需要多少削減是一項巨大的技術挑戰。許多間隔物圖案化的方法已經發布(下面列出的一些),所有這些都旨在改進管理(和減少)削減。
由於間隔物材料通常是硬掩模材料,所以它們的蝕刻後圖案質量比蝕刻後的光致抗蝕劑圖案更好,這通常受到線邊緣粗糙度的困擾。
間隔物方法的主要問題是間隔物是否能夠在它們所連線的材料被移除之後保持在原位,間隔物外形是否可接受以及下層材料是否受到蝕刻的攻擊,從而除去間隔物附著的材料。圖案轉移因去除鄰近間隔物的材料也去除少量下層材料的情況而變得複雜。這導致間隔件的一側比另一側的形狀更高。預先圖案化的特徵關鍵尺寸(CD)中的掩模或偏移的任何未對準將導致特徵之間的間距交替,這種現象稱為縱搖行走。
間隔件的定位還取決於間隔件所連線的圖案。如果圖案太寬或太窄,則隔離墊的位置會受到影響。然而,這對於自對準的關鍵存儲器特徵製造工藝來說不是問題。

