基本分類
一,非光學機型

二,光學機型
相關釋義
分光學對位與非光學對位
光學對位——通過光學模組採用裂稜鏡成像,LED照明方式,調整光場分布,使小晶片成像顯示與顯示器上。以達到光學對位返修。
非光學對位——則是通過肉眼將BGA根據PCB板絲印線及點對位,以達到對位返修。
針對不同大小的BGA原件進行視覺對位,焊接、拆卸的智慧型操作設備,有效提高返修率生產率,大大降低成本。BGA:BGA封裝記憶體
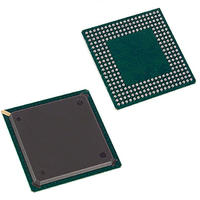 BGA植球加工
BGA植球加工BGA封裝(Ball Grid Array Package)的I/O端子以圓形或柱狀焊點按陣列形式分布在封裝下面,BGA技術的優點是I/O引腳數雖然增加了,但引腳間距並沒有減小反而增加了,從而提高了組裝成品率;雖然它
的功耗增加,但BGA能用可控塌陷晶片法焊接,從而可以改善它的電熱性能;厚度和重量都較以前的封裝技術有所減少;寄生參數減小,信號傳輸延遲小,使用頻率大大提高;組裝可用共面焊接,可靠性高。
1.PBGA(Plasric BGA)基板:一般為2-4層有機材料構成的多層板。Intel系列CPU中,Pentium II、III、IV處理器均採用這種封裝形式。
2.CBGA(CeramicBGA)基板:即陶瓷基板,晶片與基板間的電氣連線通常採用倒裝晶片(FlipChip,簡稱FC)的安裝方式。Intel系列CPU中,Pentium I、II、Pentium Pro處理器均採用過這種封裝形式。
3.FCBGA(FilpChipBGA)基板:硬質多層基板。
4.TBGA(TapeBGA)基板:基板為帶狀軟質的1-2層
PCB電路板。
5.CDPBGA(Carity Down PBGA)基板:指封裝中央有方型低陷的晶片區(又稱空腔區)。
說到BGA封裝就不能不提Kingmax公司的專利TinyBGA技術,TinyBGA英文全稱為Tiny Ball Grid Array(小型球柵陣列封裝),屬於是BGA封裝技術的一個分支。是Kingmax公司於1998年8月開發成功的,其晶片面積與封裝面積之比不小於1:1.14,可以使記憶體在體積不變的情況下記憶體容量提高2~3倍,與
TSOP封裝產品相比,其具有更小的體積、更好的散熱性能和電性能。
BGA主要有四種基本類型:PBGA、CBGA、CCGA和TBGA,一般都是在封裝體的底部連線著作為I/O引出端的焊球陣列。這些封裝的焊球陣列典型的間距為1.0mm、1.27mm、1.5mm,焊球的鉛錫組份常見的主要有63Sn/37Pb和90Pb/10Sn兩種,焊球的直徑由於沒有這方面相應的標準而各個公司不盡相同。從BGA的組裝技術方面來看,BGA有著比QFP器件更優越的特點,其主要體現在BGA器件對於貼裝精度的要求不太嚴格,理論上講,在焊接回流過程中,即使焊球相對於焊盤的偏移量達50%之多,也會由於焊料的
表面張力作用而使器件位置得以自動校正,這種情況經實驗證明是相當明顯的。其次,BGA不再存在類似QFP之類器件的引腳變形問題,而且BGA還具有相對QFP等器件較良好的共面性,其引出端間距與QFP相比要大得多,可以明顯減少因焊膏印刷缺陷導致焊點“
橋接”的問題;另外,BGA還有良好的電性能和熱特性,以及較高的互聯密度。BGA的主要缺點在於焊點的檢測和返修都比較困難,對焊點的可靠性要求比較嚴格,使得BGA器件在很多領域的套用中受到限制。
基本類型
以下就四種基本類型的BGA,從其結構特點等多方面加以闡述。
1.1 PBGA(Plastic Ball Grid Array塑封球柵陣列)
PBGA即通常所說的OMPAC(Overmolded Plastic Array Carrier),是最普通的BGA封裝類型(見圖2)。PBGA的載體是普通的印製板基材,例如FR-4、BT樹脂等。矽片通過金屬絲壓焊方式連線到載體的上表面,然後用塑膠模壓成形,在載體的下表面連線有共晶組份(37Pb/63Sn)的焊球陣列。焊球陣列在器件底面上可以呈完全分布或部分分布(見圖3),通常的焊球尺寸0.75~0.89mm左右,焊球節距有1.0mm、1.27mm、1.5mm幾種。
圖2 PBGA內部結構
圖3部分分布與完全分布示意圖
PBGA可以用現有的表面安裝設備和工藝進行組裝。首先通過漏印方式把共晶組份焊膏印刷到相應的PCB焊盤上,然後把PBGA的焊球對應壓入焊膏並進行回流,因漏印採用的焊膏和封裝體的焊球均為共晶焊料,所以在回流過程中焊球和焊膏共熔,由於器件重量和表面張力的作用,焊球坍塌使得器件底部和PCB之間的間隙減小,焊點固化後呈橢球形。PBGA169~313已有批量生產,各大公司正不斷開發更高的I/O數的PBGA產品,預計在近兩年內I/O數可達600~1000。
①可以利用現有的組裝技術和原材料製造PBGA,整個封裝的費用相對較低。
②和QFP器件相比,不易受到機械損傷。
③可適用於大批量的電子組裝。
PBGA技術的主要挑戰是保證封裝的共面性、減少潮氣的吸收和防止“popcorn”現象的產生以及解決因日趨增大的矽片尺寸引起的可靠性問題,對於更高I/O數的封裝,PBGA技術的難度將更大。由於載體所用材料是印製板基材,所以在組裝件中PCB和PBGA載體的熱膨脹係數(TCE)近乎相同,因此在回流焊接過程中,對焊點幾乎不產生應力,對焊點的可靠性影響也較小。PBGA套用遇到的問題是如何繼續減少PBGA封裝的費用,使PBGA能在I/O數較低的情況下仍比QFP節省費用。
1.2 CBGA(Ceramic Ball Grid Array陶瓷球柵陣列)
圖4 CBGA和CCGA的結構比較
CBGA通常也稱作SBC(Solder Ball Carrier),是BGA封裝的第二種類型(見圖4)。CBGA的矽片連線在多層陶瓷載體的上表面,矽片與多層陶瓷載體的連線可以有兩種形式,第一種是矽片線路層朝上,採用金屬絲壓焊的方式實現連線,另一種則是矽片的線路層朝下,採用倒裝片結構方式實現矽片與載體的連線。矽片連線完成之後,對矽片採用環氧樹脂等填充物進行包封以提高可靠性和提供必要的機械防護。在陶瓷載體的下表面,連線有90Pb/10Sn焊球陣列,焊球陣列的分布可以有完全分布或部分分布兩種形式,焊球尺寸通常約0.89mm左右,間距因各家公司而異,常見的為1.0mm和1.27mm。
PBGA器件也可以用現有的組裝設備和工藝進行組裝,但由於與PBGA的焊球組份不同,使得整個組裝過程和PBGA有所不同。PBGA組裝採用的共晶焊膏的回流溫度為183℃,而CBGA焊球的熔化溫度約為300℃,現有的表面安裝回流過程大都是在220℃回流,在這個回流溫度下僅熔化了焊膏,但焊球沒有熔化。因此,要形成良好的焊點,漏印到焊盤上的焊膏量和PBGA相比要多,其目的首先是要用焊膏補償CBGA焊球的共平面誤差,其次是保證能形成可靠的焊點連線。
在回流之後,共晶焊料包容焊球形成焊點,焊球起到了剛性支撐的作用,因此器件底部與PCB的間隙通常要比PBGA大。CBGA的焊點是由兩種不同的Pb/Sn組份焊料形成的,但共晶焊料和焊球之間的界面實際上並不明顯,通常焊點的金相分析,可以看到在界面區域形成一個從90Pb/10Sn到37Pb/63Sn的過渡區。
一些產品已採用了I/O數196~625的CBGA封裝器件,但CBGA的套用還不太廣泛,更高I/O數的CBGA封裝的發展也停滯不前,主要歸咎於CBGA組裝中存在的PCB和多層陶瓷載體之間的熱膨脹係數(TCE)不匹配問題,這個問題的出現,使得在熱循環時引起封裝體尺寸較大的CBGA焊點產生失效。通過大量的可靠性測試,已經證實了封裝體尺寸小於32mm×32mm的CBGA均可以滿足工業標準熱循環試驗規範。CBGA的I/O數目限制在625以下,對於陶瓷封裝體尺寸在32mm×32mm以上的,則必須要考慮採取其它類型的BGA。
CBGA封裝的主要優點在於:
1)具有優良的電性能和熱特性。
2)具有良好的密封性能。
3)和QFP器件相比,CBGA不易受到機械損傷。
4)適用於I/O數大於250的電子組裝套用。
此外,由於CBGA的矽片與多層陶瓷的連線可以採用倒裝片連線方式,所以可以達到比金屬絲壓焊連線方式更高的互聯密度。在很多情況下,尤其是在高I/O數的套用下,ASICs的矽片尺寸受到金屬絲壓焊焊盤尺寸的限制,CBGA通過採用了更高密度的矽片互聯線路,使得矽片的尺寸可以進一步減小而又不犧牲功能,從而降低了費用。
發展
CBGA技術的發展沒有太大的困難,其主要的挑戰在於如何使CBGA在電子組裝行業的各個領域中得到廣泛套用。首先必須要能保證CBGA封裝在大批量生產工業環境中的可靠性,其次CBGA封裝的費用必須要能和其它BGA封裝相比擬。由於CBGA封裝的複雜性以及相對高的費用,使得CBGA被局限套用於高性能、高I/O數要求的電子產品。此外,由於CBGA封裝的重量要比其它類型BGA封裝大,所以在攜帶型電子產品中的套用也受到限制。
1.3 CCGA(Ceramic Cloumn Grid Array陶瓷柱柵陣列)
CCGA也稱SCC(Solder Column Carrier),是CBGA在陶瓷體尺寸大於32mm×32mm時的另一種形式(見圖5),和CBGA不同的是在陶瓷載體的下表面連線的不是焊球而是90Pb/10Sn的焊料柱,焊料柱陣列可以是完全分布或部分分布的,常見的焊料柱直徑約0.5mm,高度約為2.21mm,柱陣列間距典型的為1.27mm。CCGA有兩種形式,一種是焊料柱與陶瓷底部採用共晶焊料連線,另一種則採用澆鑄式固定結構。CCGA的焊料柱可以承受因PCB和陶瓷載體的熱膨脹係數TCE不匹配產生的應力,大量的可靠性試驗證實封裝體尺寸小於44mm×44mm的CCGA均可以滿足工業標準熱循環試驗規範。CCGA的優缺點和CBGA非常相似,唯一的明顯差異是CCGA的焊料柱比CBGA的焊球在組裝過程中更容易受到機械損傷。有些電子產品已經開始套用CCGA封裝,但是I/O數在626~1225之間的CCGA封裝暫時尚未形成批量生產,I/O數大於2000的CCGA封裝仍在開發中。
圖5CCGA(Ceramic Cloumn Grid Array陶瓷柱柵陣列)
1.4 TBGA(Tape Ball Grid Array載帶球柵陣列)
圖6 TBGA內部結構
TBGA又稱為ATAB(Araay Tape Automated Bonding),是BGA的一種相對較新的封裝類型(見圖6)。TBGA的載體是銅/聚醯亞胺/銅雙金屬層帶,載體的上表面分布有信號傳輸用的銅導線,而另一面則作為地層使用。矽片與載體之間的連線可以採用倒裝片技術來實現,當矽片與載體的連線完成後,對矽片進行包封以防止受到機械損傷。載體上的過孔起到了連通兩個表面、實現信號傳輸的作用,焊球通過採用類似金屬絲壓焊的微焊接工藝連線到過孔焊盤上形成焊球陣列。在載體的頂面用膠連線著一個加固層,用於給封裝體提供剛性和保證封裝體的共面性。在倒裝矽片的背面一般用導熱膠連線著散熱片,給封裝體提供良好的熱特性。TBGA的焊球組份為90Pb/10Sn,焊球直徑約為0.65mm,典型的焊球陣列間距有1.0mm、1.27mm、1.5mm幾種,TBGA與PCB之間的組裝所採用的為63Sn/37Pb共晶焊料。TBGA也可以利用現有的表面安裝設備和工藝,採用與CBGA相似的組裝方法進行組裝。
常用的TBGA封裝的I/O數小於448,TBGA736等產品已上市,國外一些大公司正在開發I/O數大於1000的TBGA。
TBGA封裝的優點在於:
①比其它大多數BGA封裝類型更輕更小(尤其是I/O數較高的封裝)。
②具有比QFP和PBGA封裝更優越的電性能。
③可適於批量電子組裝。
此外,這種封裝採用高密度的倒裝片形式實現矽片與載體的連線,使TBGA具有信號噪聲小等很多優點,由於印製板和TBGA封裝中加固層的熱膨脹係數TCE基本上是相互匹配的,所以對組裝後TBGA焊點可靠性的影響並不大,TBGA封裝遇到的最主要問題是潮氣的吸收對封裝的影響。
TBGA套用遇到的問題是如何才能在電子組裝領域中占有一席之地,首先TBGA的可靠性必須能在批量生產環境中予以證實,其次TBGA封裝的費用必須要能和PBGA封裝相比擬。由於TBGA的複雜性和相對高的封裝費用,TBGA主要用於高性能、高I/O數的電子產品。
2 Flip Chip :
和其它表面安裝器件不同,倒裝片無封裝,互聯陣列分布於矽片的表面,取代了金屬絲壓焊連線形式,矽片直接以倒扣方式安裝到PCB上。倒裝片不再需要從矽片向四周引出I/O端,互聯的長度大大縮短,減小了RC延遲,有效地提高了電性能。倒裝片連線有三種主要類型:C4、DC4和FCAA。
2.1 C4(Controlled Collapse Chip Connection可控坍塌晶片連線)
圖7 C4結構形式
C4是類似超細間距BGA的一種形式(見圖7)。與矽片連線的焊球陣列一般的間距為0.203~0.254mm,焊球直徑為0.102~0.127mm,焊球組份為97Pb/3Sn,這些焊球在矽片上可以呈完全分布或部分分布。由於陶瓷可以承受較高的回流溫度,因此陶瓷被用來作為C4連線的基材,通常是在陶瓷的表面上預先分布有鍍Au或Sn的連線盤,然後進行C4形式的倒裝片連線。
C4連線不能使用現有的組裝設備和工藝進行組裝,因為97Pb/3Sn焊球的熔化溫度是320℃,且在這種採用C4連線的互聯結構中不存在其它組份的焊料。在C4連線中,取代了焊膏漏印,而是採用印刷高溫助焊劑的方式,首先將高溫助焊劑印刷到基材的焊盤或矽片的焊球上,然後矽片上的焊球和基材上相應焊盤精確對位,通過助焊劑提供足夠的粘附力來保持相對位置並直到回流焊接完成。C4連線採用的回流溫度為360℃,在該溫度下焊球熔化,矽片處於“懸浮”狀態,由於焊料表面張力的作用,矽片會自動校正焊球和焊盤的相對位置,最終焊料坍塌至一定的高度形成連線點。C4連線方式主要套用於CBGA和CCGA封裝中,此外,有些廠家在陶瓷多晶片模組(MCM—C)套用中也使用這種技術。採用C4連線的I/O數在1500以下,一些公司預期開發的I/O數將超過3000。
C4連線的優點在於:
1)具有優良的電性能和熱特性。
2)在中等焊球間距的情況下,I/O數可以很高。
3)不受焊盤尺寸的限制。
4)可以適於批量生產。
5)可大大減小尺寸和重量。
此外,C4連線在矽片和基材之間只有一個互聯界面,可提供最短的、干擾最小的信號傳遞通道,減少的界面數量使得結構更簡單,並且可靠性更高。C4連線在技術上還存在很多挑戰,真正套用於電子產品還有一定的難度。C4連線方式只能適用於陶瓷基材,它們將在高性能、高I/O數的產品中得到廣泛的套用,例如CBGA、CCGA和MCM—C等。
2.2 DCA(Direct Chip Attach直接晶片連線)
DCA和C4類似,是一種超細間距連線(見圖8)。DCA的矽片和C4連線中的矽片結構相同,兩者之間的唯一區別在於基材的選擇,DCA採用的基材是典型的印製材料。DCA的焊球組份是97Pb/3Sn,連線焊接盤上的焊料是共晶焊料(37Pb/63Sn)。對於DCA,由於間距僅為0.203~0.254mm,共晶焊料漏印到連線焊盤上相當困難,所以取代焊膏漏印這種方式,在組裝前給連線焊盤頂鍍上鉛錫焊料,焊盤上的焊料體積要求十分嚴格,通常要比其它超細間距元件所用的焊料多。在連線焊盤上0.051~0.102mm厚的焊料由於是預鍍的,一般略呈圓頂狀,必須要在貼片前整平,否則會影響焊球和焊盤的可靠對位。
圖8 DCA結構形式
這種連線方式可以用表面安裝設備和工藝實現。首先,助焊劑通過印刷方式被分配到矽片上,然後進行矽片的貼裝,最後回流焊接。DCA組裝採用的回流溫度約220℃,低於焊球的熔點但高於連線焊盤上的共晶焊料熔點,矽片上焊球的作用相當於剛性支撐,回流之後共晶焊料熔化,在焊球與焊盤之間形成焊點連線。對於這種採用兩種不同的Pb/Sn組份形成的焊點,在焊點中兩種焊料的界面實際並不明顯,而是形成從97Pb/3Sn到37Pb/63Sn的光滑過渡區域。由於焊球的剛性支撐作用,DCA組裝中焊球不“坍塌”,但還具有自校正特性。DCA已經開始得到套用,I/O數主要在350以下,一些公司計畫開發的I/O數超過500。這種技術發展的動力不是更高的I/O數,而主要是著眼於尺寸、重量和費用的減小。DCA的特點和C4非常相似,由於DCA可以利用現有的表面安裝工藝實現與PCB的連線,所以能採用這種技術的套用很多,尤其是在攜帶型電子產品中的套用。
然而並不能誇大DCA技術的優點,在DCA技術的發展過程中仍有許多技術挑戰。在實際生產中使用這種技術的組裝廠家為數並不多,他們都在努力提高工藝水平,以擴大DCA的套用。由於DCA連線把那些和高密度相關的複雜性轉移到PCB上,所以給PCB的製造增加了難度,此外,專門生產帶有焊球的矽片的廠家為數不多,在組裝設備、工藝等各方面仍存在著很多值得關注的問題,只有這些問題得到了解決,才能推動DCA技術的發展。
2.3 FCAA(Flip Chip Adhesive Attachment倒裝片膠連線)
FCAA連線存在多種形式,當前仍處於初期開發階段。矽片與基材之間的連線不採用焊料,而是用膠來代替。這種連線中的矽片底部可以有焊球,也可以採用焊料凸點等結構。FCAA所用的膠包括各向同性和各向異性等多種類型,主要取決於實際套用中的連線狀況。另外,基材的選用通常有陶瓷、印製板材料和柔性電路板等。這種技術目前尚未成熟,在這裡就不作更多的闡述。
詳細介紹
BGA的全稱是Ball Grid Array(球柵陣列結構的PCB),它是積體電路採用有機載板的一種封裝法。它具有:①封裝面積減少②功能加大,引腳數目增多③PCB板溶焊時能自我居中,易上錫④可靠性高⑤電性能好,整體成本低等特點。有BGA的PCB板一般小孔較多,大多數客戶BGA下過孔設計為成品孔直徑8~12mil,BGA處表面貼到孔的距離以規格為31.5mil為例,一般不小於10.5mil。BGA下過孔需塞孔,BGA焊盤不允許上油墨,BGA焊盤上不鑽孔。- S% X. i: E% h5 O% X* o" ?# _我們公司目前對BGA下過孔塞孔主要採用工藝有:①剷平前塞孔:適用於BGA塞孔處阻焊單面露出或部分露出,若兩種塞孔孔徑相差1.5mm時,則無論是否阻焊兩面覆蓋均採用此工藝;②阻焊塞孔:套用於BGA塞孔處阻焊兩面覆蓋的板;③整平前後的塞孔:用於厚銅箔板或其他特殊需要的板。所塞鑽孔尺寸有:0.25、0.30、0.35、0.40、0.45、0.50、0.55mm共7種。# T4 Z* |" c4 R在CAM製作中BGA應做怎樣處理呢?' e+ d; L5 [4 h( Z, O# _3 j# F一、外層線路BGA處的製作:- Z4 Q8 p, g6 P6 ~: F1 p" X% a( c在客戶資料未作處理前,先對其進行全面了解,BGA的規格、客戶設計焊盤的大小、陣列情況、BGA下過孔的大小、孔到BGA焊盤的距離,銅厚要求為1~1.5盎司的PCB板,除了特定客戶的製作按其驗收要求做相應補償外,其餘客戶若生產中採用掩孔蝕刻工藝時一般補償2mil,採用圖電工藝則補償2.5mil,規格為31.5mil BGA的不採用圖電工藝加工;當客戶所設計BGA到過孔距離小於8.5mil,而BGA下過孔又不居中時,可選用以下方法:( i* H! i. o/ Q7 M可參照BGA規格、設計焊盤大小對應客戶所設計BGA位置做一個標準BGA陣列,再以其為基準將需校正的BGA及BGA下過孔進行拍正,拍過之後要與原未拍前備份的層次對比檢查一下拍正前後的效果,如果BGA焊盤前後偏差較大,則不可採用,只拍BGA下過孔的位置。! W, {+ f/ x2 G二、BGA阻焊製作: 8 A) ^/ ?% b. D7 T: c1、BGA表面貼阻焊開窗:與阻焊最佳化值一樣其單邊開窗範圍為1.25~3mil,阻焊距線條(或過孔焊盤)間距大於等於1.5mil; ( p/ s: ^5 @, Z' z2、BGA塞孔模板層及墊板層的處理:! A" N( l% Q& V2 F$ y. Q4 L①製做2MM層:以線路層BGA焊盤拷貝出為另一層2MM層並將其處理為2MM範圍的方形體,2MM中間不可有空白、缺口(如有客戶要求以BGA處字元框為塞孔範圍,則以BGA處字元框為2MM範圍做同樣處理),做好2MM實體後要與字元層BGA處字元框對比一下,二者取較大者為2MM層。) T$ f4 e- X; U% l0 Q②塞孔層(JOB.bga):以孔層碰2MM層(用面板中Actionsàreference selection功能參考2MM層進行選擇),參數Mode選Touch,將BGA 2MM範圍內需塞的孔拷貝到塞孔層,並命名為:JOB.bga(注意,如客戶要求BGA處測試孔不作塞孔處理,則需將測試孔選出,BGA測試孔特徵為:阻焊兩面開滿窗或單面開窗)。7 c7 z" j" b. e3 Y7 g* e5 ]③拷貝塞孔層為另一墊板層(JOB.sdb)。* A8 _; t2 B- G% R. y④按BGA塞孔檔案調整塞孔層孔徑和墊板層孔徑。4 \* e, {1 D! e6 r/ v* [三、BGA對應堵孔層、字元層處理:5 j* C% S, w3 }' w g①需要塞孔的地方,堵孔層兩面均不加擋點;) p2 m1 t2 x/ U) \* G4 s②字元層相對塞孔處過孔允許白油進孔。5 K1 {0 M# G5 |7 y* M' y以上步驟完成後,BGA CAM的單板製作就完成了,這只是BGA CAM的單板製作情況,其實由於
電子信息產品的日新月異,PCB行業的激烈競爭,關於BGA塞孔的製作規程是經常在更換,並不斷有新的突破。這每次的突破,使產品又上一個台階,更適應市場變化的要求。我們期待更優越的關於BGA塞孔或其它的工藝出爐。
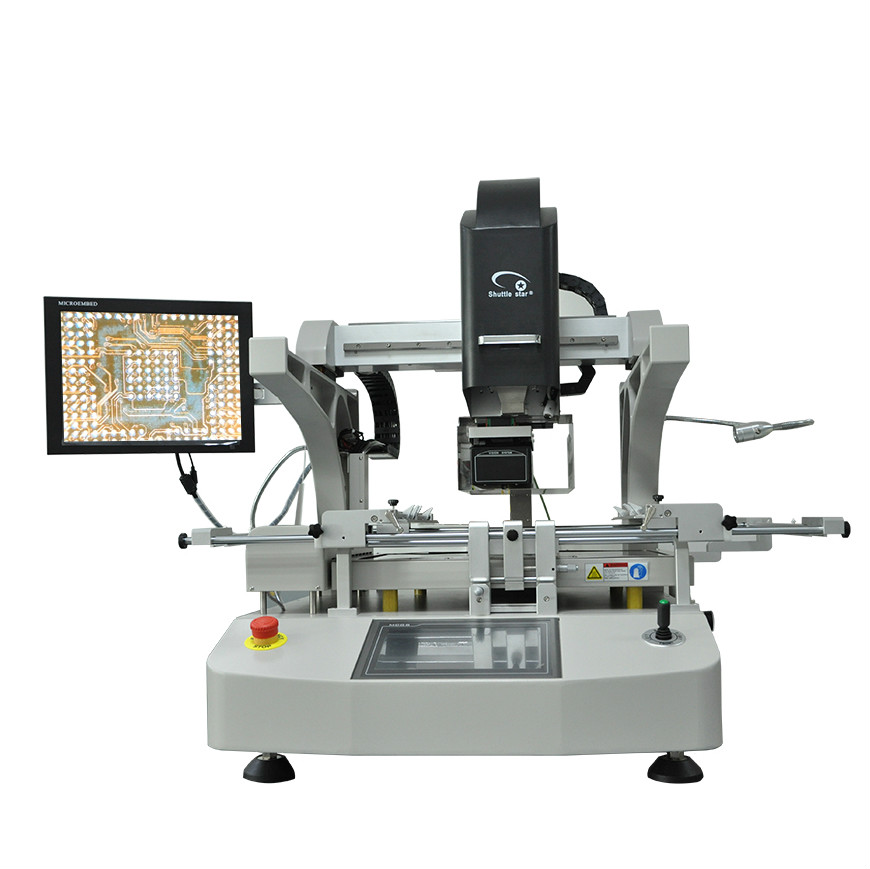 RW-6250U
RW-6250U

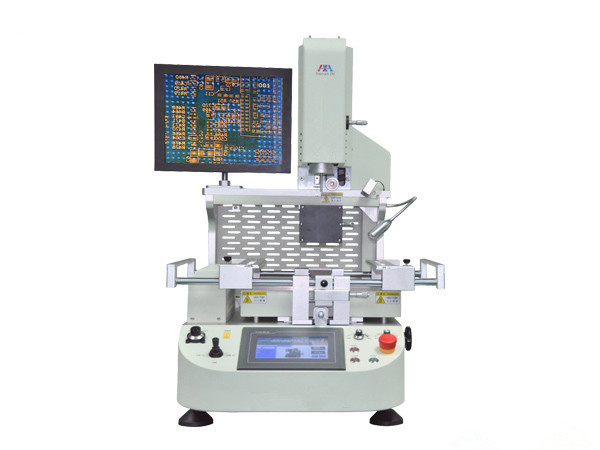
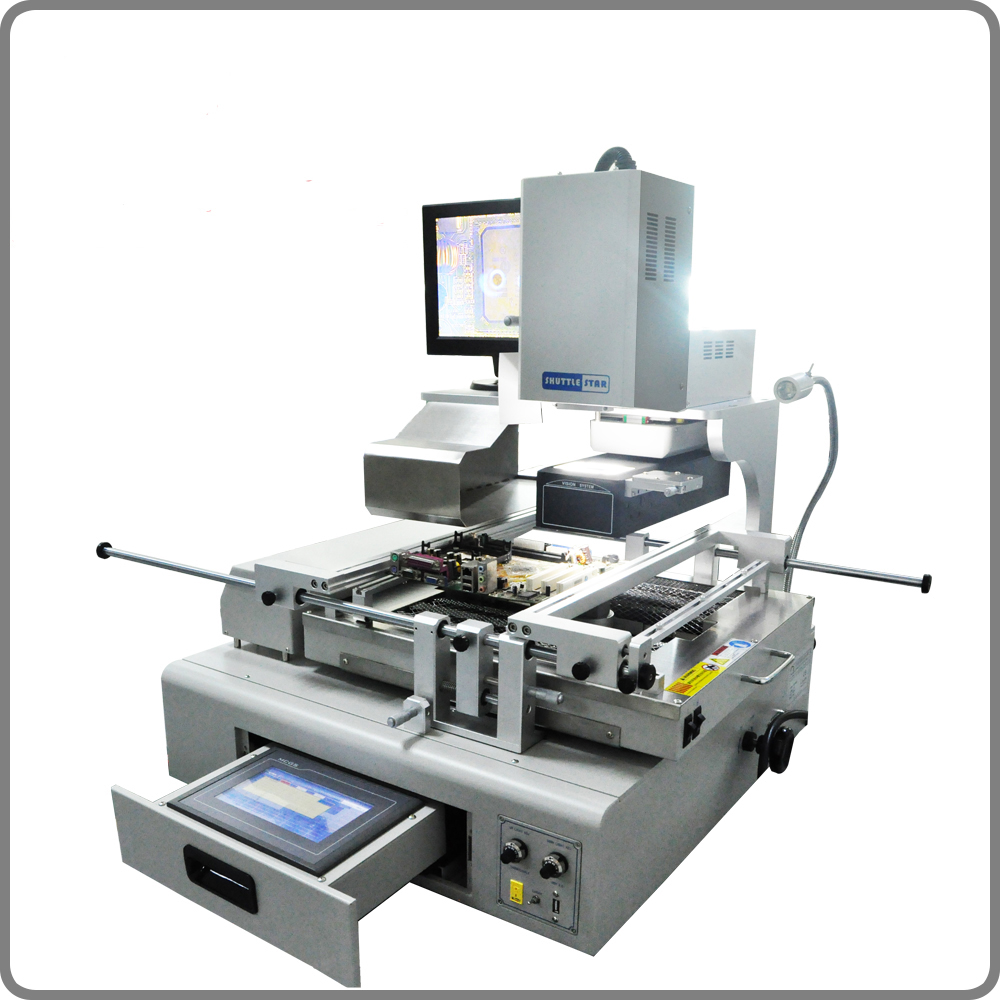
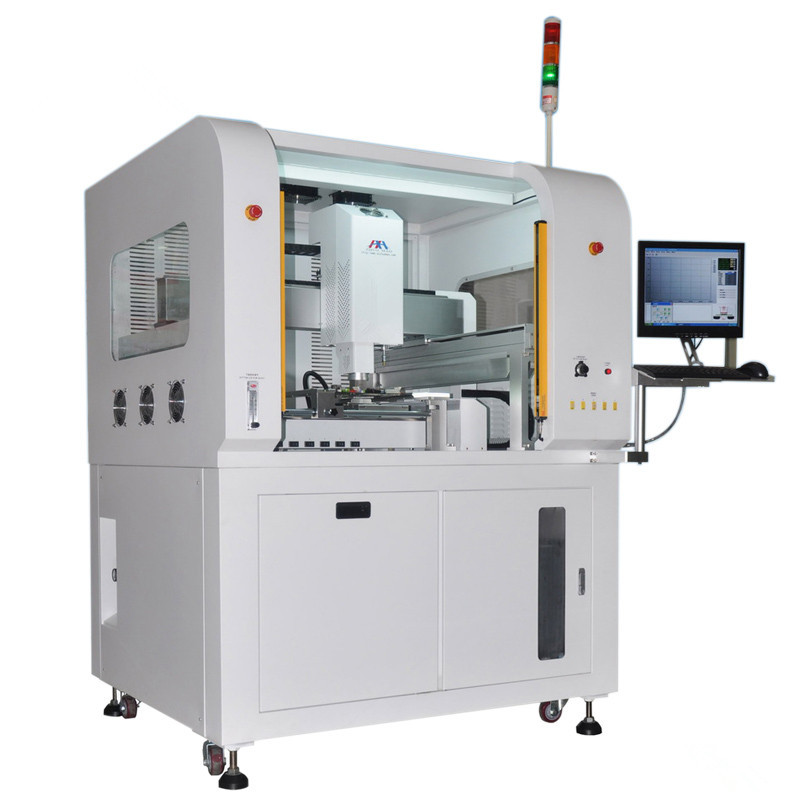
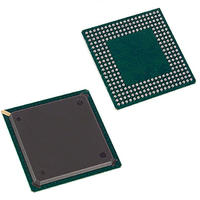 BGA植球加工
BGA植球加工
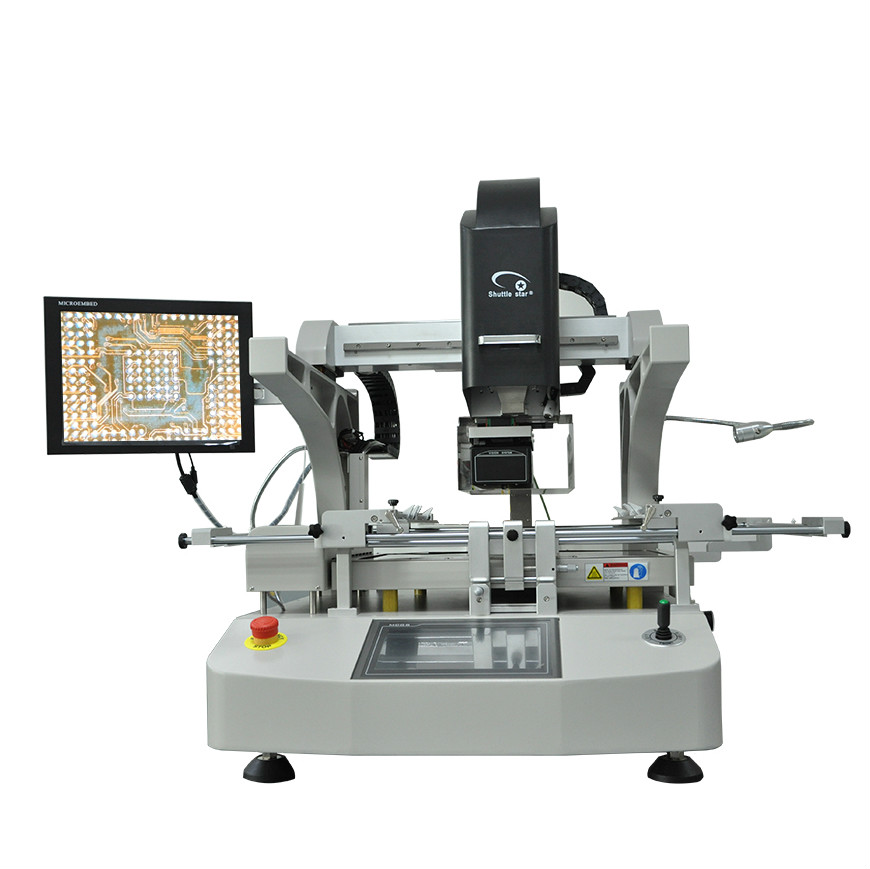 RW-6250U
RW-6250U
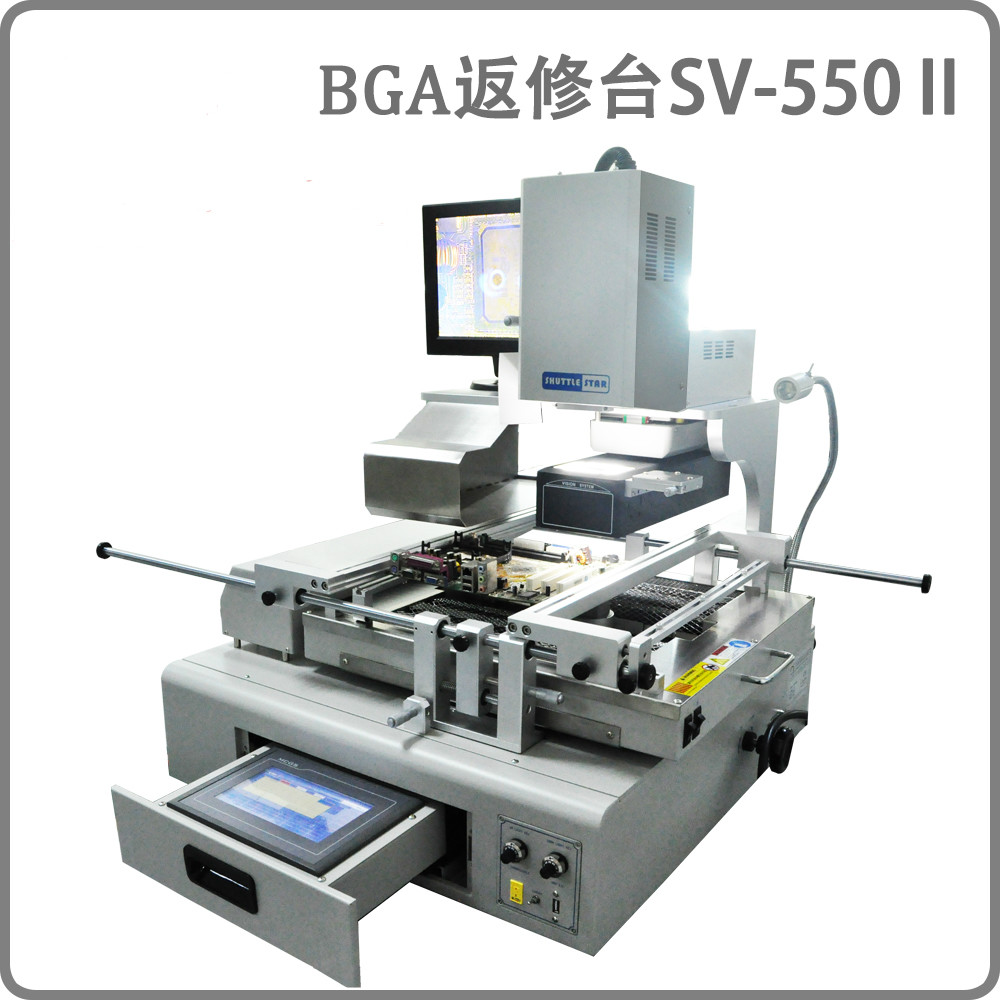
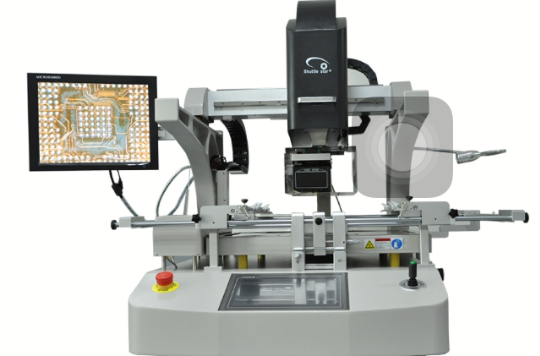

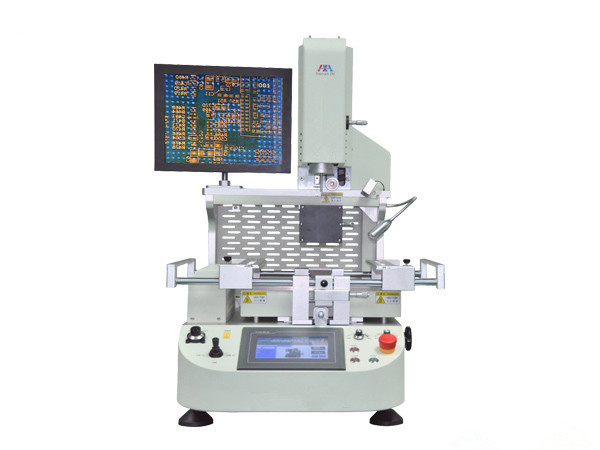
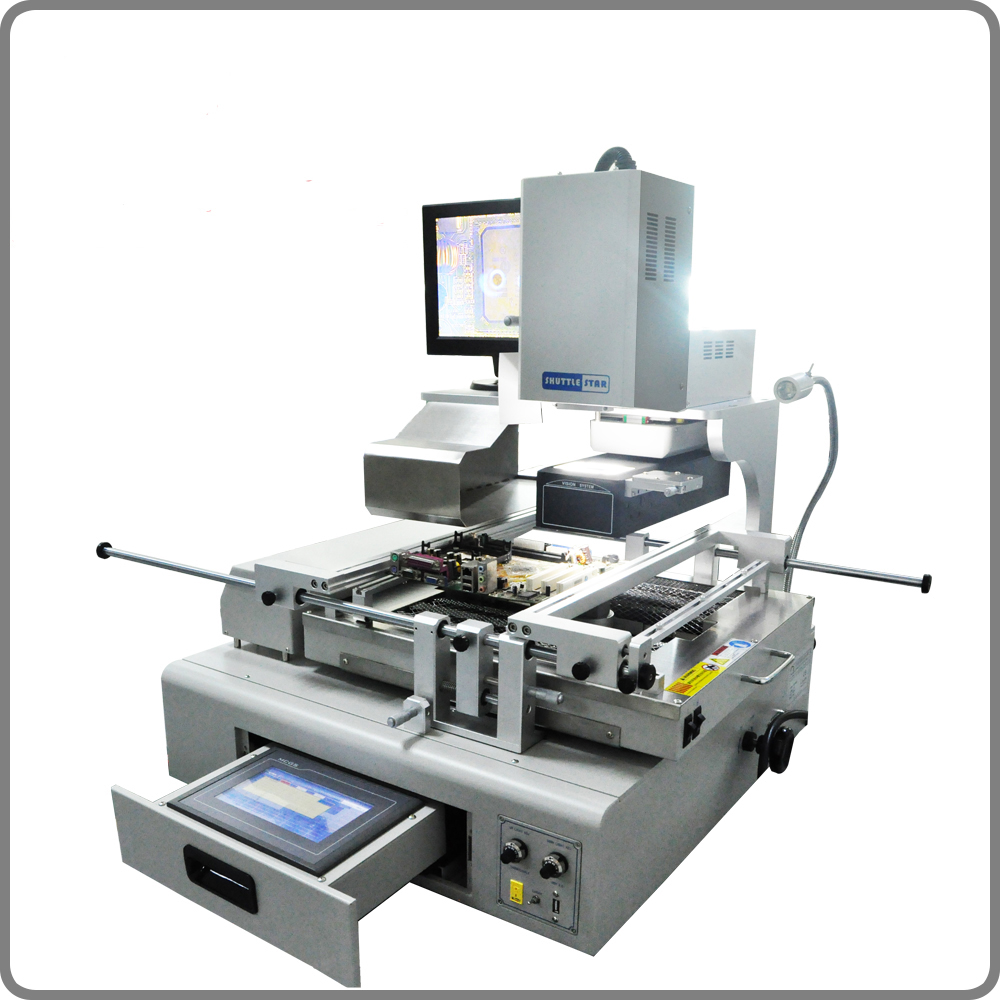
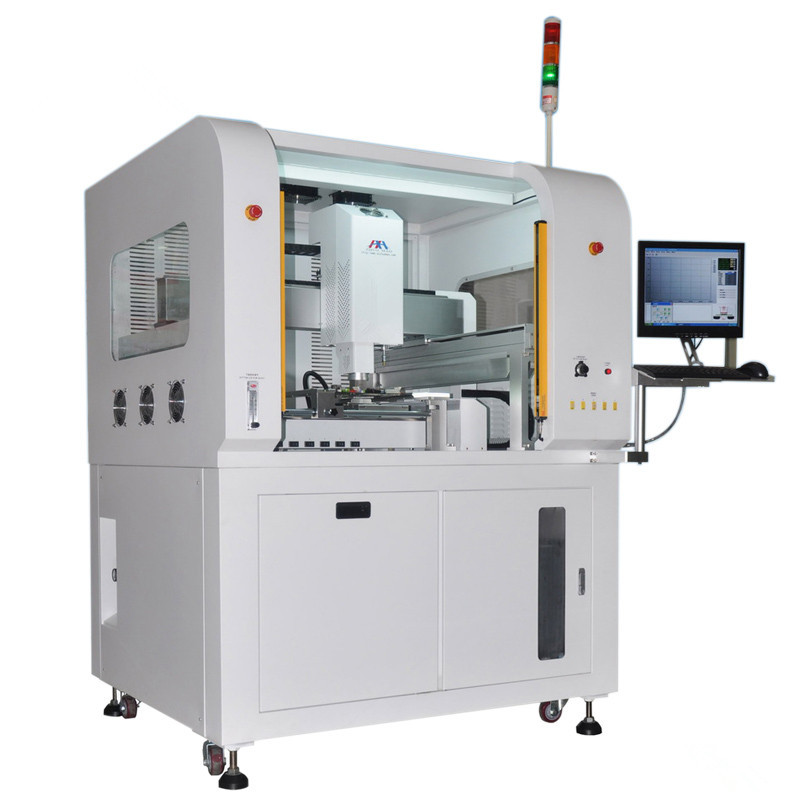
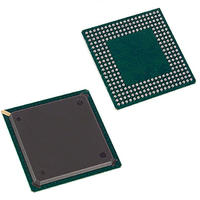 BGA植球加工
BGA植球加工
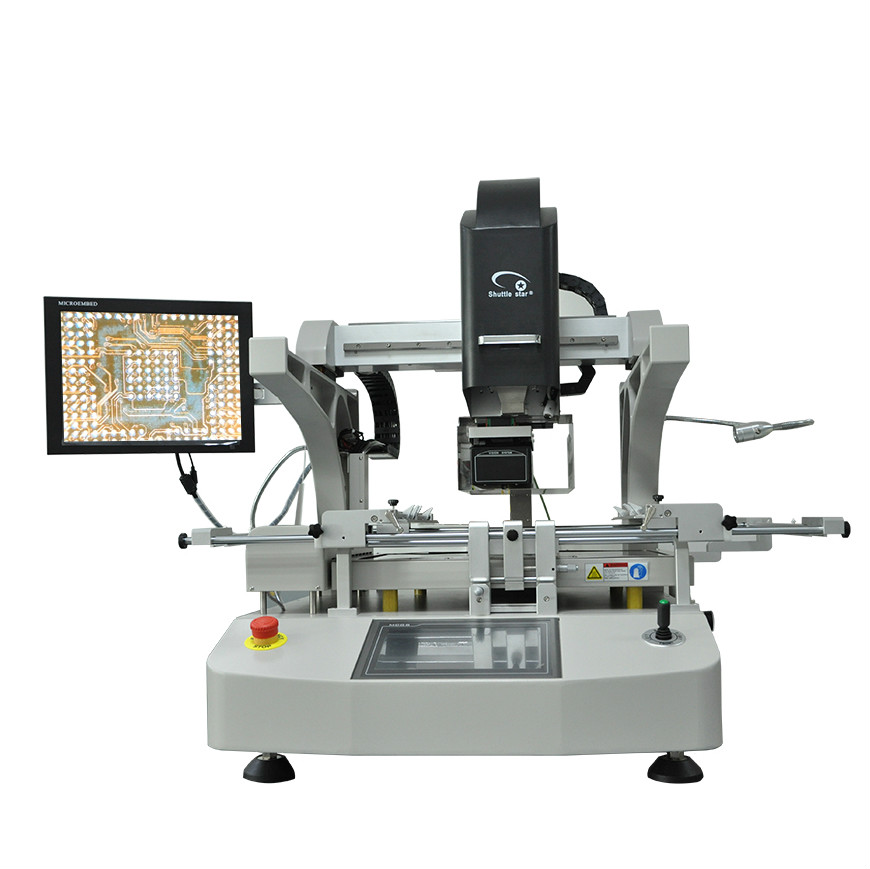 RW-6250U
RW-6250U