基本介紹
基本結構
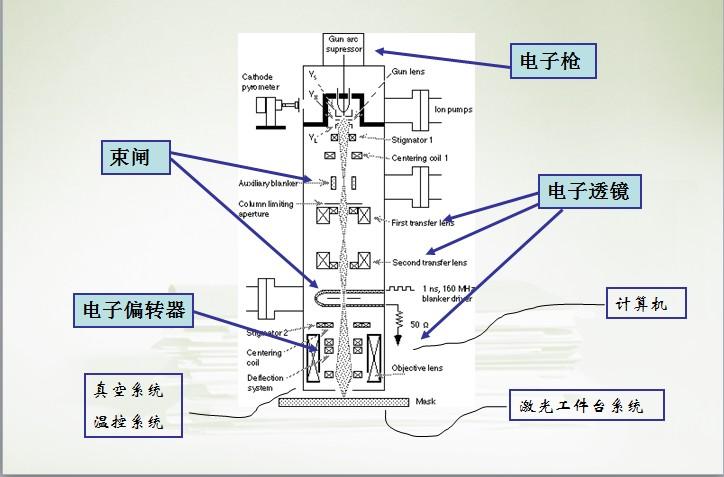
電子束曝光系統
(1)基於改進掃描電鏡的電子束曝光系統
(2)高斯電子束掃描系統

(3)成型電子束掃描系統
(4)投影電子束掃描系統
曝光系統 | 改裝SEM曝光系統 | 高斯束曝光系統 | 成型電子束曝光系統 | 投影電子束掃描系統 |
解析度 | 低 | 高 | 低 | 高 |
生產率 | 低 | 較高 | 高 | 很高 |
自動化程度 | 低 | 較高 | 高 | 高 |
相關工藝
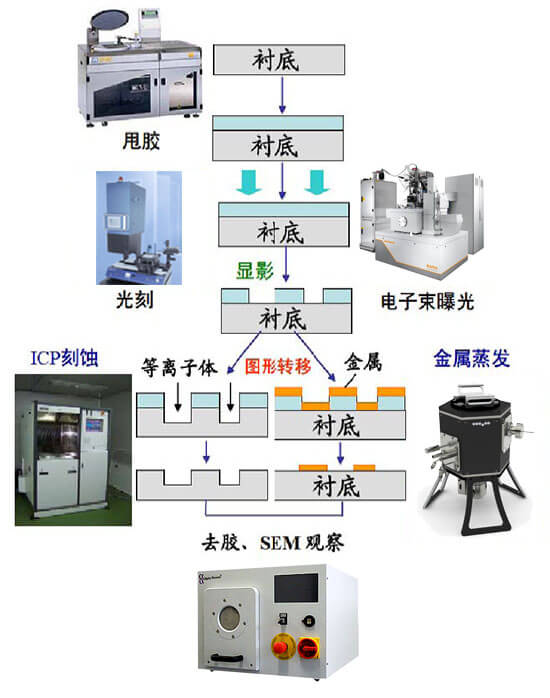
特點
操作
寫場校準
曝光起點與寫場中心相一致。

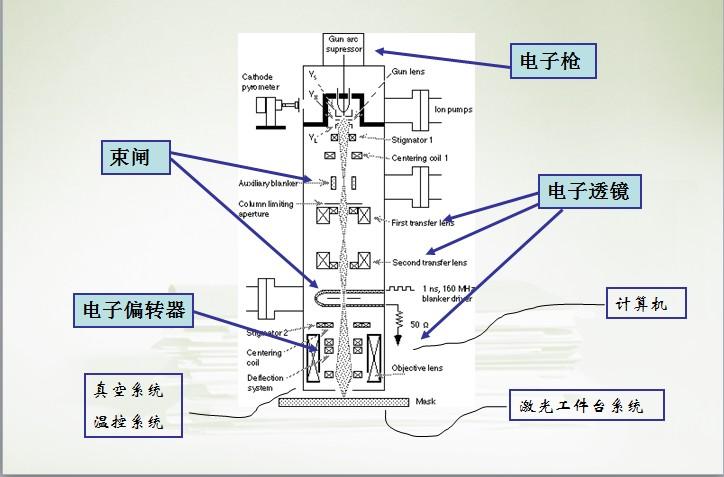

曝光系統 | 改裝SEM曝光系統 | 高斯束曝光系統 | 成型電子束曝光系統 | 投影電子束掃描系統 |
解析度 | 低 | 高 | 低 | 高 |
生產率 | 低 | 較高 | 高 | 很高 |
自動化程度 | 低 | 較高 | 高 | 高 |
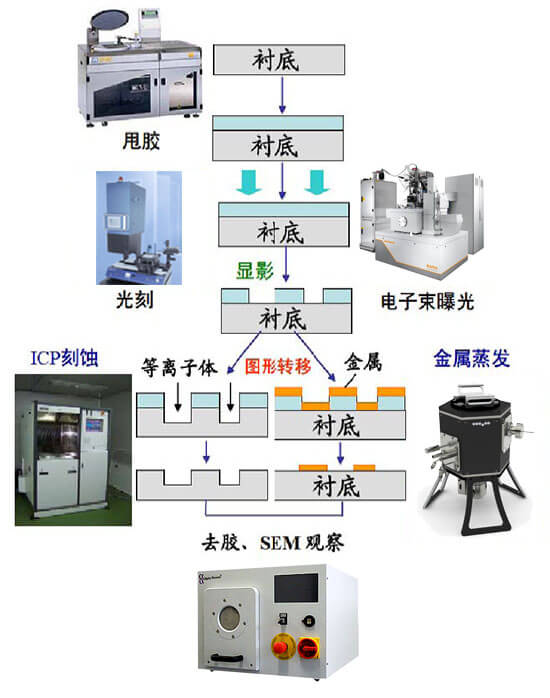
電子束曝光(electron beam lithography)指使用電子束在表面上製造圖樣的工藝,是光刻技術的延伸套用。光刻技術的精度受到光子在波長尺度上的散射影響。使用的光波長越...
電子束曝光(electron beam lithography)指使用電子束在表面上製造圖樣的工藝,是光刻技術的延伸套用。電子束曝光系統(electron beam lithography system)即用於實現電子...
電子束曝光技術是光刻技術的延伸,是指利用某些有機聚合物對電子敏感的特性,將其加工成精細掩模圖形的曝光技術。它是近些年才發展起來的集電子光學,精密機械,超高...
掃描電子束曝光系統是研製成功時間為1965年的劍橋儀器公司生產的系統。...... 掃描電子束曝光系統是研製成功時間為1965年的劍橋儀器公司生產的系統。中文名 掃描電子束...
《電子束曝光微納加工技術》是2004年北京工業大學出版社出版的圖書,作者是顧文琪。...... 《電子束曝光微納加工技術》是2004年北京工業大學出版社出版的圖書,作者...
電子束膠對電子束可感光,聚甲基丙烯酸甲酯是目前使用得最多的電子束膠,但是聚甲基丙烯酸甲酯在套用時存在缺點,例如抗刻蝕能力差,粘合性差,耐酸鹼性和耐溫性差。...
電子束與離子束微細加工是指通過具有一定能量的電子束、離子束與固體表面相互作用來改變固體表面物理、化學性質和幾何結構的精密加工技術。用具有一定能量的電子束照射...
電子抗蝕劑(Electron resist)是用於電子束曝光的一種抗蝕劑,屬於高分子聚合物,其性能類似於光學曝光中的光致抗蝕劑,即輻照可使其產生化學或物理變化而形成圖形。...
電子束加工是利用高能量的會聚電子束的熱效應或電離效應對材料進行的加工。利用電子束的熱效應可以對材料進行表面熱處理、焊接、刻蝕、鑽孔、熔煉,或直接使材料升華...
套用於電子束光刻的抗蝕劑。...... 電子束光刻套用範圍非常廣泛,用於電子束掩模曝光系統的抗蝕劑要求靈敏度高,曝光速度快,解析度大體在100nm左右,用於納米直寫...
聚焦離子束也可以像電子束那樣作為一種曝光手段。離子束曝光有非常高的靈敏度,這主要是因為在固體材料中的能量轉移的效率遠遠高於電子。常用的電子束曝光抗蝕劑對...
電子束誘導沉積(Electron beam-induced deposition,EBID)是一種使用電子束分解氣相分子,從而在襯底上的特定位置實現沉積生長的技術。電子束誘導沉積實驗中的電子束常常...
光學投影曝光微納加工技術(電子束離子束光子束微納加工技術系列專著)編輯推薦 編輯 本書系統地介紹了光學光刻技術的發展歷史、主流光刻技術——光學投影光刻的工作...
離子束投影光刻技術(Ion Projection Lithography, IPL)早期是用離子束進行光刻膠曝光,或者通過掩模,或者用精確聚焦的離子束連續在光刻膠上直寫。如果使用掩膜,則...
電子束光刻技術是利用電子槍所產生的電子束,通過電子光柱的各極電磁透鏡聚焦、對中、各種象差的校正、電子束斑調整、電子束流調整、電子束曝光對準標記檢測、電子...
電子束曝光系統(electron beam lithography, EBL,又稱電子束暴光系統)是一種利用電子束在工件面上掃描直接產生圖形的裝置。由於SEM、STEM及FIB的工作方式與電子束曝光...
男,1966年8月出生,博士,教授,博士生導師,山東科技大學機械電子工程學院副院長、...4) 電子束曝光機雷射定位工作檯系統研製,山東省科技進步二等獎。...
靜電透鏡,是電子透鏡中的一種。由具有帶電導體所產生的靜電場來使電子束聚焦和成象的裝置。它廣泛套用於電子器件(如陰極射線示波管)和電子顯微鏡中。由多個靜電...
1 發展歷程 2 矽片直徑 3 光學曝光技術 4 分子雷射曝光 5 縮小投影曝光 6 電子束直寫 半導體光刻技術發展歷程 編輯 從第一個電晶體問世算起,半導體技術的...
開發了化學放大抗蝕劑在電子束曝光納米加工中的套用;主持了歐洲微系統技術支持中心;參與了歐洲微系統技術標準化路線圖的制定;參與了歐洲建立納米科技聯合中心的可行性...
夏善紅,1995年至今在中國科學院電子學研究所工作,目前任研究員、博士生導師、所...91 掃描電子束曝光機複合物鏡的研究與設計 電子科學學刊 1991-05-01...
d)相位掩膜法 將用電子束曝光刻好的圖形掩膜置於探光纖上,相位掩膜具有壓制零級,增強一級衍射的功能。紫外光經過掩膜相位調製後衍射到光纖上形成干涉條紋,寫入周期...
1985-90年負責(組長)六五攻關“光柵掃描式電子束曝光機”的子課題“(二維)閉環控制(雙頻)雷射測量系統”。1987-91年與姚建銓院士共同主持七五攻關“73-01-03....
