基本介紹
- 中文名:發射帶
- 外文名:emission band
- 來源:發光材料
- 套用:GaN半導體材料
- 學科:核技術
內容簡介
離子注入型GaN黃光發射帶研究
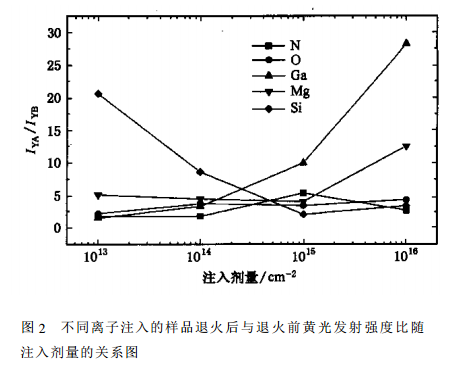 樣品退火後與退火前黃光發射強度比隨注入劑量的關係圖
樣品退火後與退火前黃光發射強度比隨注入劑量的關係圖性仍需要進一步的驗證。

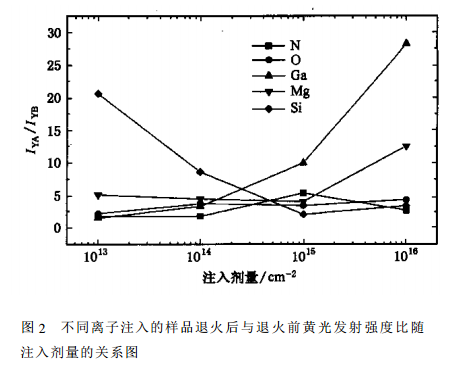 樣品退火後與退火前黃光發射強度比隨注入劑量的關係圖
樣品退火後與退火前黃光發射強度比隨注入劑量的關係圖GaN晶體薄膜的光致發光譜均存在一個非常寬且比較複雜的黃光發射帶,從給出的譜線形狀可判斷,其包含有多個發光峰,這說明黃光發光帶是由多個躍遷過程產生的。...
窄帶發射是在無線電研究中,窄帶描述了一個信道,該中信息的頻寬不明顯超過信道的相干頻寬。...
德國尼科煙火器材公司生產的信號發射器,是一種可在地面和海上發射信號彈的裝置,已被軍、警、民各部門廣泛用於發射聯絡或遇險求救信號。...
out-of-band emission 由於調製過程而產生的,剛超過必要頻寬的一個或多個頻率的發射,但雜散發射除外。 ...
發射藥,通常指裝在槍炮彈膛內用以發射彈丸的火藥。由火焰或火花等引燃後,在正常條件下不爆炸,僅能爆燃而迅速發生高熱氣體,其壓力足使彈頭以一定速度發射出去,但...
發射率也叫比輻射率或發射係數,是指地物發射的輻射通量與同溫度下黑體輻射通量之比。地物的發射率與地物的性質、表面狀況(如粗糙度、顏色等)有關,且是溫度和...
當金屬表面接受光輻射時,可使金屬表面自由電子能量增加,衝破金屬表面的制約飛到金屬外面來,這種現象稱為光發射。...
發射機(a transmitter circuit)主要任務是完成有用的低頻信號對高頻載波的調製,將其變為在某一中心頻率上具有一定頻寬、適合通過天線發射的電磁波。廣泛套用於電視,...
在航天測試發射操作過程中,參與的設備複雜、人員數量多、人員操作崗位多。航天發射任務是一項組織嚴密、容不得半點差錯的活動,特別是在危害後果大的測試操作。每一個...
寬頻發射是指頻寬大於某一特定的測量設備或接收機頻寬的發射。...... 寬頻發射是指頻寬大於某一特定的測量設備或接收機頻寬的發射。注1:若信號脈衝重複頻率(Hz)小...
MLRS由自行發射/裝填車、後勤保障車、帶不同彈頭的火箭和火控系統組成。 [2] MLRS還可用來發射二元化學彈頭的火箭和美國陸軍戰術飛彈系統。目前還在研製輕型MLRS和...
FM發射器就是一個個人微型廣播電台,能將Discman、MD、MP3(包括蘋果iPod)等各種攜帶型音、視頻播放器中的音頻信號轉換成高保真的無線FM調頻立體聲信號發射出去,汽車...
發射環是一個構想中的非火箭航天發射裝置。通過利用一個架在距地面80公里,長為2000公里的高架環路上的磁懸浮帶,把負載發射到某個軌道上。整個帶子在將負載拋射出...
雜散發射(spurious emission)指必要頻寬之外的一個或多個頻率的發射,其發射電平可以降低而不致影響相應信息的傳遞;雜散發射包含諧波發射、寄生發射、互調產物及變頻...
“發射頻率”是天文學專有名詞。來自中國天文學名詞審定委員會審定發布的天文學專有名詞中文譯名,詞條譯名和中英文解釋數據著作權由天文學名詞委所有。中文譯名:發射...
電子發射,是電子從物體逸入周圍媒質(真空或氣體)的現象。物體中的電子在常態下所具有的能量都不足以克服表面勢壘而逸出物體。要使它們從物體裡釋放出來,必須另外...
航天發射場是發射太空飛行器的特定區域,其主要功能是完成運載火箭和太空飛行器的裝配、測試和發射;對飛行中的運載火箭及太空飛行器進行跟蹤測量,獲取數據,進行處理和分析;對運載...
發射換能器是指“發射器”,用於水中發射聲波的換能器。它需能承受足夠的功率,具有較高的電聲轉換效率和機械強度,它通常工作在諧振頻率附近的一個適當寬的頻率...
神威烈火夜叉銃,簡稱“夜叉銃”。古代發射帶火毒鏃的單管火銃。將帶有三棱倒須鉤之塗毒箭鏃,釘於火銃法馬(法馬亦稱木馬,以堅木車成之圓形薄片,微小於銃管直徑,...
