溝道效應含義及證明實驗
如下圖中的A所示。如果注入離子的半徑較小,它沿著敞開的晶體方向注入時,溝道效應更加顯著。矽的<100> 和<111> 晶向,溝道敞開約
,容易接受半徑較小的離子(N、B、Al、Ga, P、As、Sb),矽的<110> 晶向,溝道敞開約
,接受面積較大,它幾乎可以接受所有的離子,離子沿<110> 晶向注入,受到電子的作用較弱。
 離子注入晶體的例子
離子注入晶體的例子如果注入的離子沿溝道方向運動,必須具有三個基本的條件:
第一,離子可以透過原子排之間敞開的溝道;
第二,必須有一個力作用在離子上,控制它朝溝道的中央運動;
第三,溝道離子必須是穩定的。
有兩類實驗可以證實存在溝道效應,第一類是,然後進入探測器進行計數,或者測量透射單晶片的電流。這類實驗的裝置示意圖如下圖所示。50keV的質子通過金的單晶薄片,進入測量電流的電極。圍繞著垂直單晶薄片表面的軸旋轉晶體,可以改變晶格的方向而不影響質子穿透單晶薄片的厚度,因而,測得的電流變化便反映出晶體結構的影響。
 離子穿透單晶薄片進入探測電極的裝置示意圖
離子穿透單晶薄片進入探測電極的裝置示意圖圖1.3示出了透射的離子電流隨晶體圍繞
軸旋轉角度θ的變化。
如果入射離子(質子)的能量較高,則可用矽面壘探測器直接測量透射質子的數目。在透射中,每個質子失去的能量,可以直接從計數的脈衝高度來測量,測量結果如圖1.4表示,A是入射質子束的譜,C是入射質子束未對準單晶矽晶軸的譜,B是入射質子束對準矽
面的譜,B譜分成兩個區域,即能量損失較小的尖峰(反常峰)和非對準情形中的正常峰,反常峰和溝道現象有關。正常峰是進入溝道的粒子,在單晶矽內運動到適當的位置變成退道引起的。另一類實驗是測量離子注入晶體後的射程分布,沿晶向注入,離子穿透較深,如圖1.5所示。
溝道效套用於確定雜質原子在晶格中的位置
雜質原子在晶格中的位置,對晶體的電學和光學等特性都有明顯的影響,因而可用電學和光學等方法對雜質原子定位。但是,這種測量通常是間接的,不能提供在晶體格位上雜質原子所占的比例。而利用溝道效應則可提供一種直接的測量方法,可確定上述比例。若再結合電學和光學性質的研究,則有可能最終解決各種類型的缺陷對離子注入層導電率的貢獻。這種方法已廣泛用於矽和鍺的研究。下面我們介紹背散射的溝道效應。核反應與感生X射線的溝道效應原理與之相同,此處不再贅述。
由於溝道粒子不能與晶體格位上的原子作用而產生近距事件,故定向譜的背散射產額比隨機譜顯著減小(可減小20~100倍)。讓我們來考慮金剛石型晶格的情況,大多數半導體晶體都是這種結構,下圖描繪了它的原子構型在
面上的投影。圖中陰影部分為“禁區”,在此區域內溝道粒子不能貫穿,非陰影部分為可通行區,即所謂“溝道”,此區域內溝道粒子可以通過。雜質原子可能有三種位置:
●為替代位置,位於<111> 、<110> 及<100>的原子列上;
▲為四面體間隙位置,位於<100>及<111>的原子列上,而不在<110>的原子列上;
X為任意間隙位置,不位於任何原子列。
 金剛石{110}面上結構
金剛石{110}面上結構當我們分別測量沿<111>、<110>及<100>晶向的定向譜時,由於X位置都在三個軸溝道內,對上述三種晶向的背散射產額都有貢獻,因而三個定向譜的產額都與隨機譜相同、都沒有方向效應;▲位置在<111>和<100>的原子列上而不在<110>的原子列上,故<111>和<100>定向譜與隨機譜相比其產額大大衰減而呈現方向效應,但<110>定向譜無衰減,即無方向效應;●位置的三個定向譜產額均顯著衰減,即都有方向效應。因此,如比較兩個以上不同晶向測量的定向譜和隨機譜,結合晶體結構的知識,即可判斷雜質原子在晶格中的位置。
溝道效套用於測量晶體的輻照損傷
如前所述,溝道粒子不能與晶格列上的原子作用而產生近距事件,但能與輻照損傷產生的偏離格位的位移原子作用,因此測量未注入和注入晶體的定向譜並與隨機譜比較,即可確定在離子注入的晶體中輻照損傷產生的無序量及其深度分布。
 溝道束和隨機束
溝道束和隨機束在考慮定向譜時,為方便起見,通常將束流分為“溝道束”和“隨機束”兩部分。前者由溝道粒子組成,後者由非溝道粒子組成,它們在晶體中運動的軌跡分別如上圖中(a)、(b)所示。事實上,即使一個完全對準的入射束(ψ=0),其中也只有95~99%的粒子為溝道束,另外還有可能與晶格原子作用的1~5%的粒子為隨機束。當溝道束進一步穿透晶體時,由於晶體的不完整性、晶格原子的熱振動以及原子核和核外電子引起的多次散射等原因,在散射角積累到大於臨界角後,即部分地轉變為隨機束,致使隨機束成分增加而溝道束成分減少。這個過程叫做“退溝道”或“消溝道”。為了確定輻照損傷的數量及其深度分布,必須測量三種背散射譜,即ψ=0時未注入的完美晶體和注入後的損傷晶體的定向譜,以及當
時的隨機譜。典型的背散射譜如下圖所示。
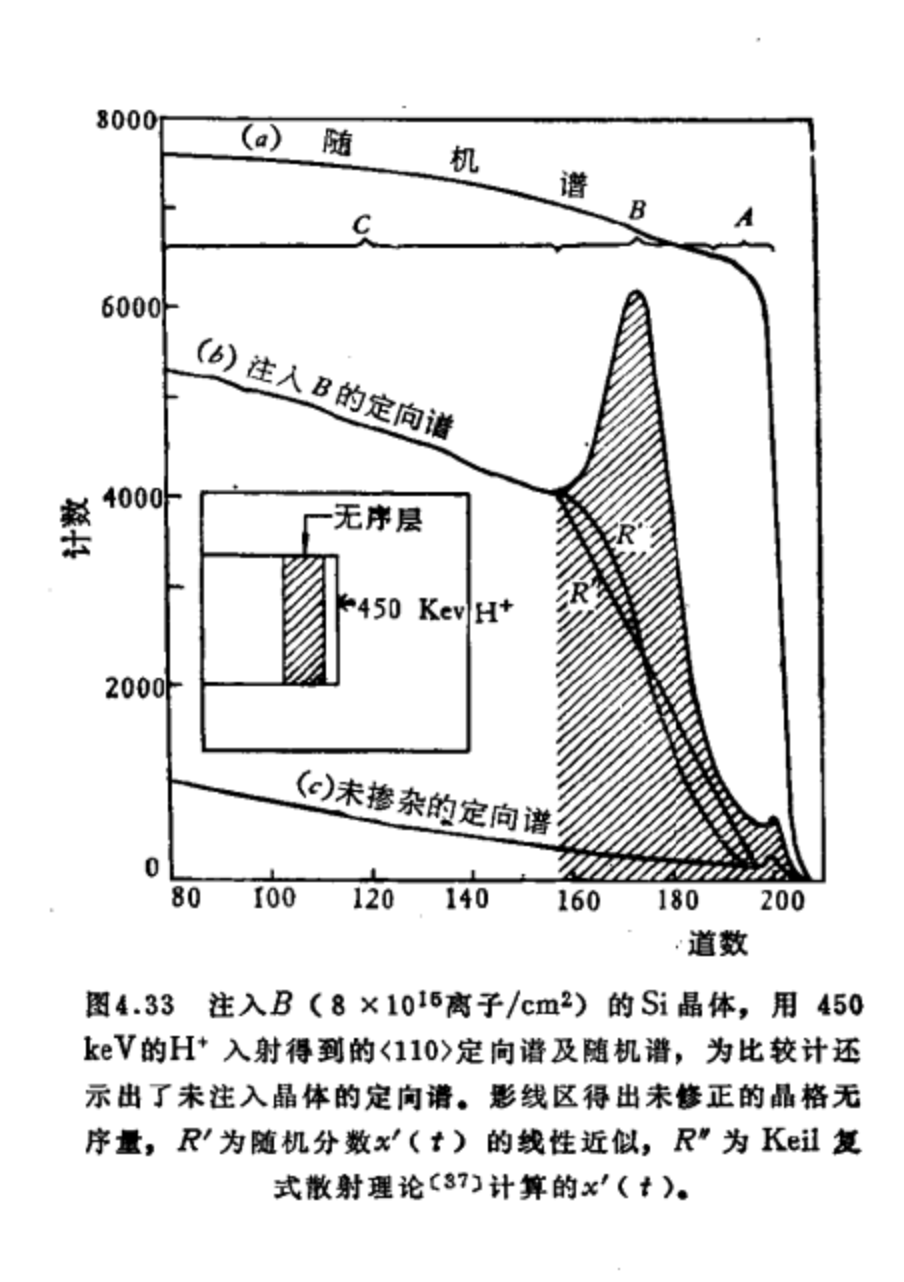 定向譜和隨機譜
定向譜和隨機譜溝道效應測量僅能給出輻照損傷產生的晶格缺陷的平均濃度,而不能肯定缺陷的類型,因此需要結合其他技術,如電子顯微鏡、電子共振等來研究。溝道效應測量計及所有位於晶軸禁止距(Thomas-Fermi禁止半徑)以外的所有原子,它不僅包括注入過程中產生的位移原子,而且還包括晶格中的任何局部畸變(注入時產生的晶格缺陷如雙空位的周圍可能產生這種畸變)產生的位移原子,因此測得的晶格無序量要比實際的位移原子數大些。套用背散射溝道效應測量晶格損傷不夠靈敏,它要求被測晶體中至少有1%的位移原子。若採用雙定向法,可將靈敏度提高一個數量級,即0.1%,相應於總的位移原子數從約2×1015原子/cm3(單定向)提高到約2×1014原子/cm3(雙定向)。此外,分析束採用質子和氦離子均可測量損傷。氦離子束的深度解析度較好,但退溝道量比質子大,故對薄的重損傷層傾向於使用氦離子束,而厚層樣品傾向於使用質子束。通常分析束採用較高的能量有利,這樣可減少退溝道量從而提高測量的靈敏度。
溝道效應測量晶格損傷已廣泛套用於離子注入半導體。近來離子注入工藝在國內外得到了很大的發展。在注入雜質的同時必然要產生大量的晶格損傷,人們用溝道效應來研究這些問題,例如晶格損傷的數量與離子注入劑量的關係、殘餘晶格損傷的數量與退火條件(退火時間、退火溫度及退火方式)的關係等。此外,溝道效應也可用來研究金屬、離子晶體等的晶格損傷,以及晶體無定形層的外延再生長等問題。


 離子注入晶體的例子
離子注入晶體的例子 離子穿透單晶薄片進入探測電極的裝置示意圖
離子穿透單晶薄片進入探測電極的裝置示意圖


 金剛石{110}面上結構
金剛石{110}面上結構 溝道束和隨機束
溝道束和隨機束
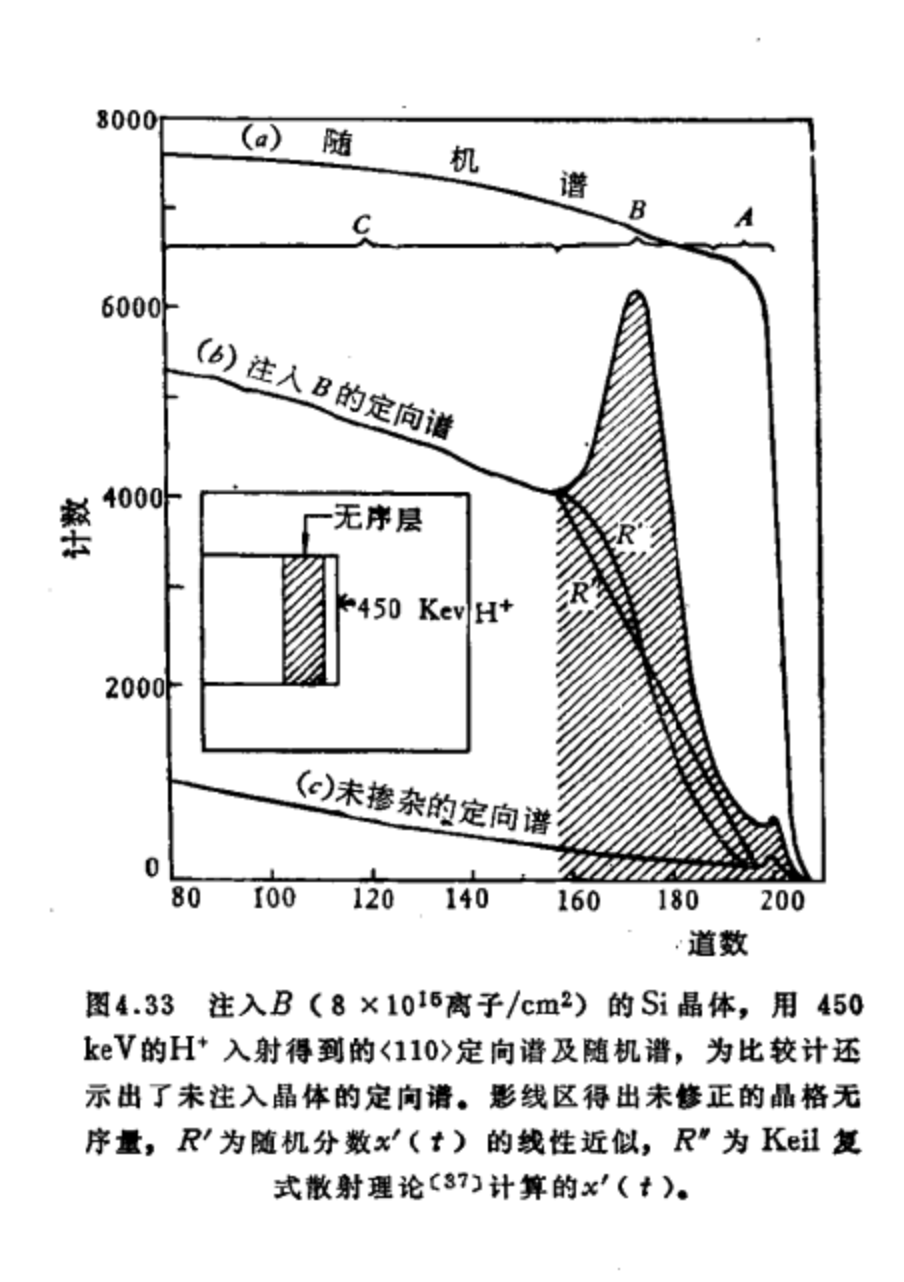 定向譜和隨機譜
定向譜和隨機譜