基本介紹
- 中文名:掩模陰影效應
- 外文名:mask shadowing effect
在極紫外光刻中,由於極紫外光幾乎對所有的物質均不透明,因此包括掩模在內的所有光學元件必須採用反射式的結構。不同於深紫外光刻(DUV)系統,為避免入射和出射光相互干涉,照明系統出射的光必須傾斜地照射到掩模上,並反射入物鏡系統中,且隨著曝光特徵尺寸的減小,物鏡系統數值孔徑NA的增大,該傾角越來越大。常規二元極紫外光刻掩模結構由鍍制有極紫外多層反膜的基底和攜帶曝光圖案信息的吸收層組成,吸收層一般為Cr或者TaN,厚度一般為40到70nm。針對10nm及以下技術節點的需求,該厚度與掩模圖案特徵尺寸相當,因此,光束的傾斜入射將會導致掩模的陰影效應,即掩模上靠近吸收層的光由於吸收層遮擋無法接收到光能、以及反射區的靠近吸收層的光由於吸收層的反射區吸收層遮擋無法進入投影系統,最終導致掩模的有效反射區減小,吸收區增大,使掩模曝光圖案尺寸與設計值產生偏差。
掩模陰影效應簡化示意圖如圖2所示,其中kin和kre分別為入射波失和反射波失,θ為入射角。
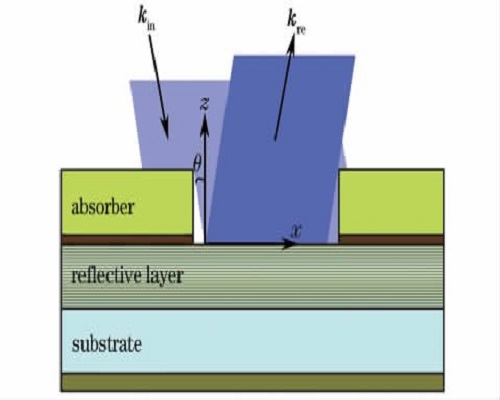 圖2 EUV光刻掩模陰影效應簡化示意圖
圖2 EUV光刻掩模陰影效應簡化示意圖解決陰影效應的方法有兩個:
(1)減小吸收層的厚度,較薄的吸收層可以有效地減小陰影區域;
(2)通過圖形修正,即在設計掩模版圖形時就考慮到陰影效應,有意地引入修正。
在幾何光學中,掩模陰影效應與入射光方向餘弦、吸收層厚度成線性關係,由於還存在複雜的電磁相互作用,嚴格計算需要採用時域有限差分(FDTD)法等算法。要減小陰影效應的影響,一是要通過計算,在掩模設計時加入對圖形設計的補償,二是要儘量減小吸收層的厚度,採用吸收率較大的材料作吸收層。