掩模誤差增強因子(Mask Error Enhancement Factor,MEEF)被定義為晶圓上光刻膠線寬(CDwafer)隨掩模上圖形線寬(CDmask)變化的斜率。
基本介紹
- 中文名:掩模誤差增強因子
- 外文名:Mask Error Enhancement Factor
- 英文縮寫:MEEF
掩模誤差增強因子(Mask Error Enhancement Factor,MEEF)被定義為晶圓上光刻膠線寬(CDwafer)隨掩模上圖形線寬(CDmask)變化的斜率,即

式中,掩模圖形的線寬(CDmask)已經按光刻機曝光圖形的縮小倍數折算成了晶圓上的尺寸,對於大多數光刻機是除以4,CDwafer隨CDmask的變化如圖1所示。當圖形尺寸遠大於光刻機的瑞利解析度(Rayleigh resolution limit,λ/NA)時,MEEF較小,基本上為1。也就是說,掩模上圖形線寬的誤差會1:1地反映到光刻膠圖形上,ΔCDwafer=ΔCDmask/4。隨著掩模版上圖形尺寸的減小(即k1減小),MEEF會增大。
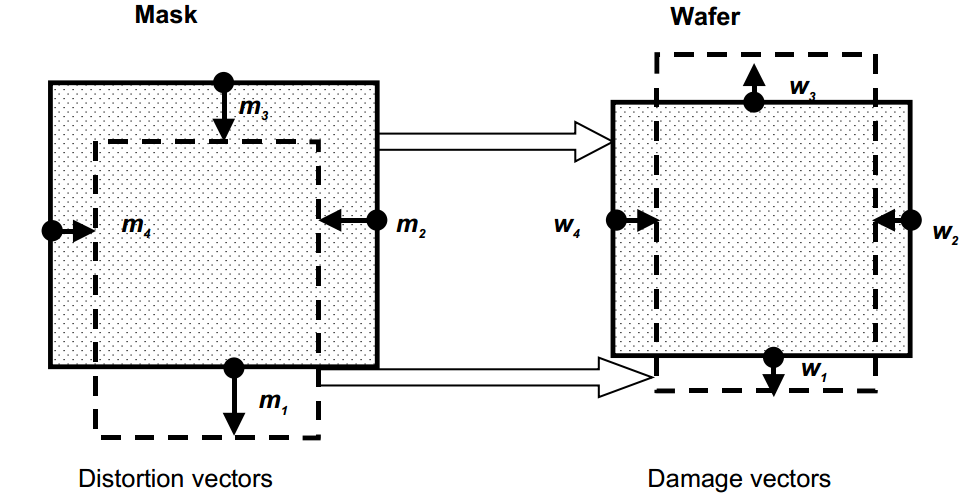
圖1 CDwafer隨CDmask的變化示意圖
掩模誤差增強因子(MEEF)用於放大掩模誤差。這可能導致鄰近效應和偏差問題,而且要比成像系統的正常減小因子要大得多。對掩模規格的經濟影響將會是嚴重的。文獻MEEF in Theory and Practice研究了黑暗特徵的MEEF理論描述:孤立的線,孤立的柱,和密集的1:1線/空間特徵。在一般情況下,MEEF的密集特徵是小於1的,而孤立特徵的MEEF總是大於1。這類在孤立和密集特性之間的“MEEF差距”可能有助於解釋光學鄰近效應修正(OPC)對疏密偏差的敏感性。