基本介紹
- 中文名:BGA封裝
- 外文名:Ball Grid Array Package
- 特點:厚度比QFP減少1/2以上等
- 分類:PBGA基板、CBGA基板
簡介
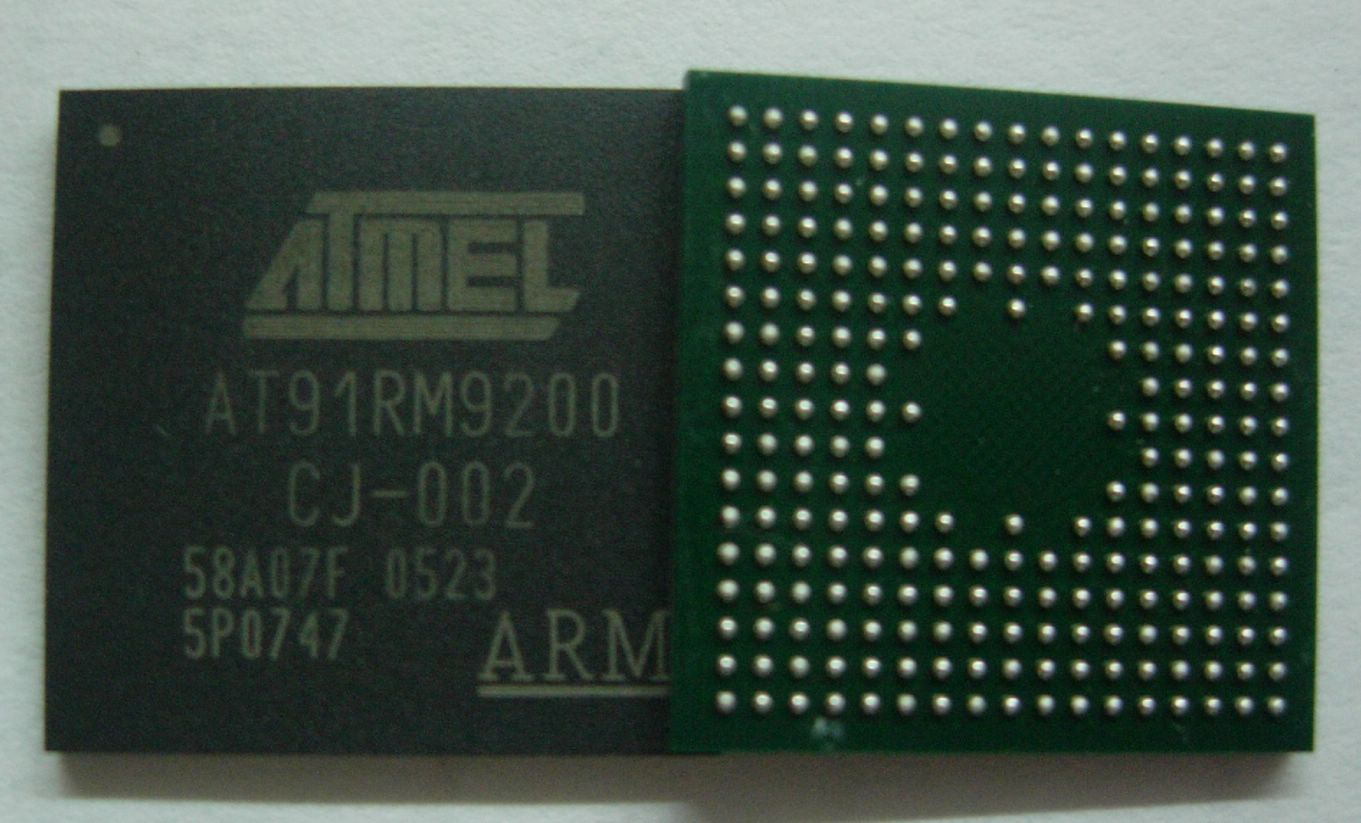
特點
 BGA封裝記憶體
BGA封裝記憶體分類
示例
 TinyBGA封裝記憶體
TinyBGA封裝記憶體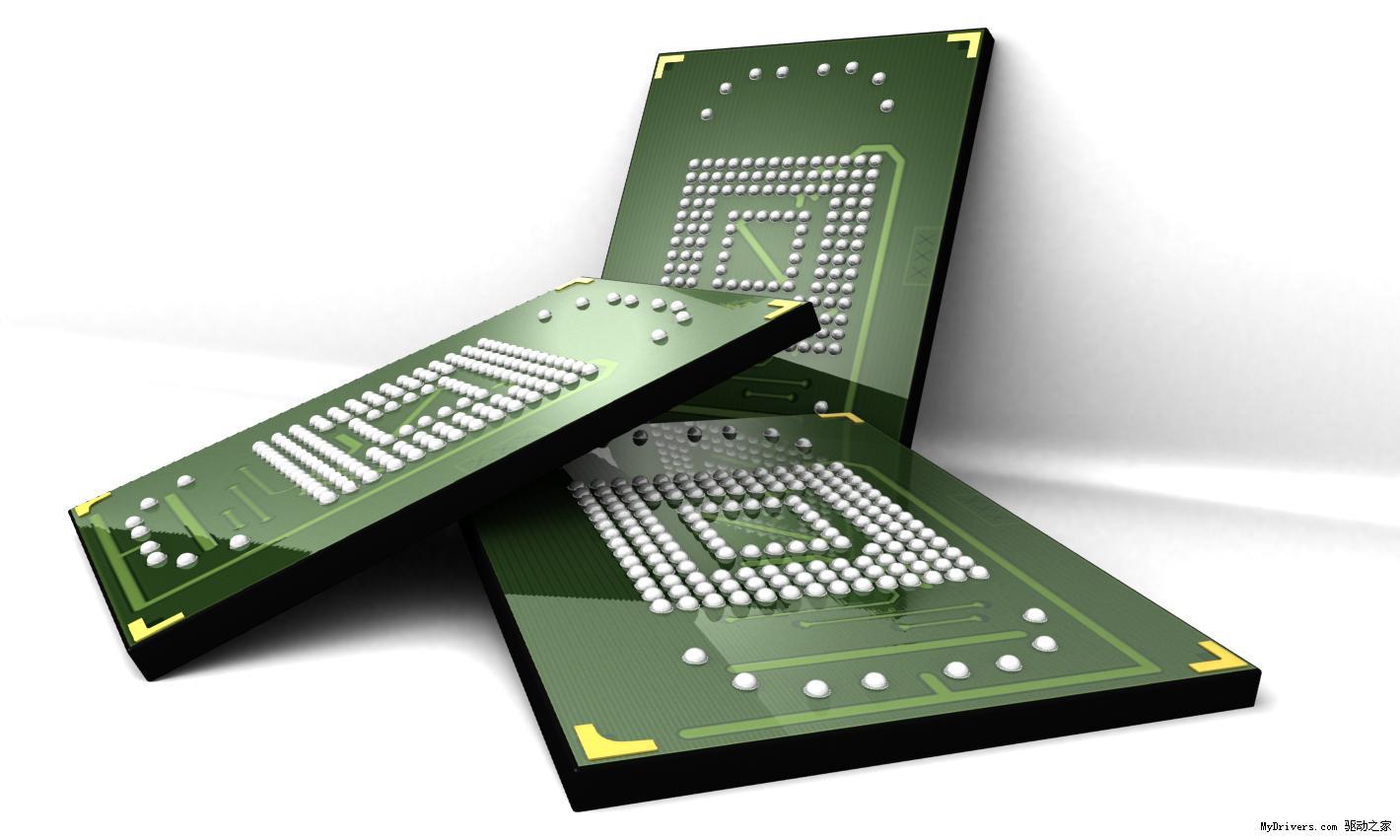
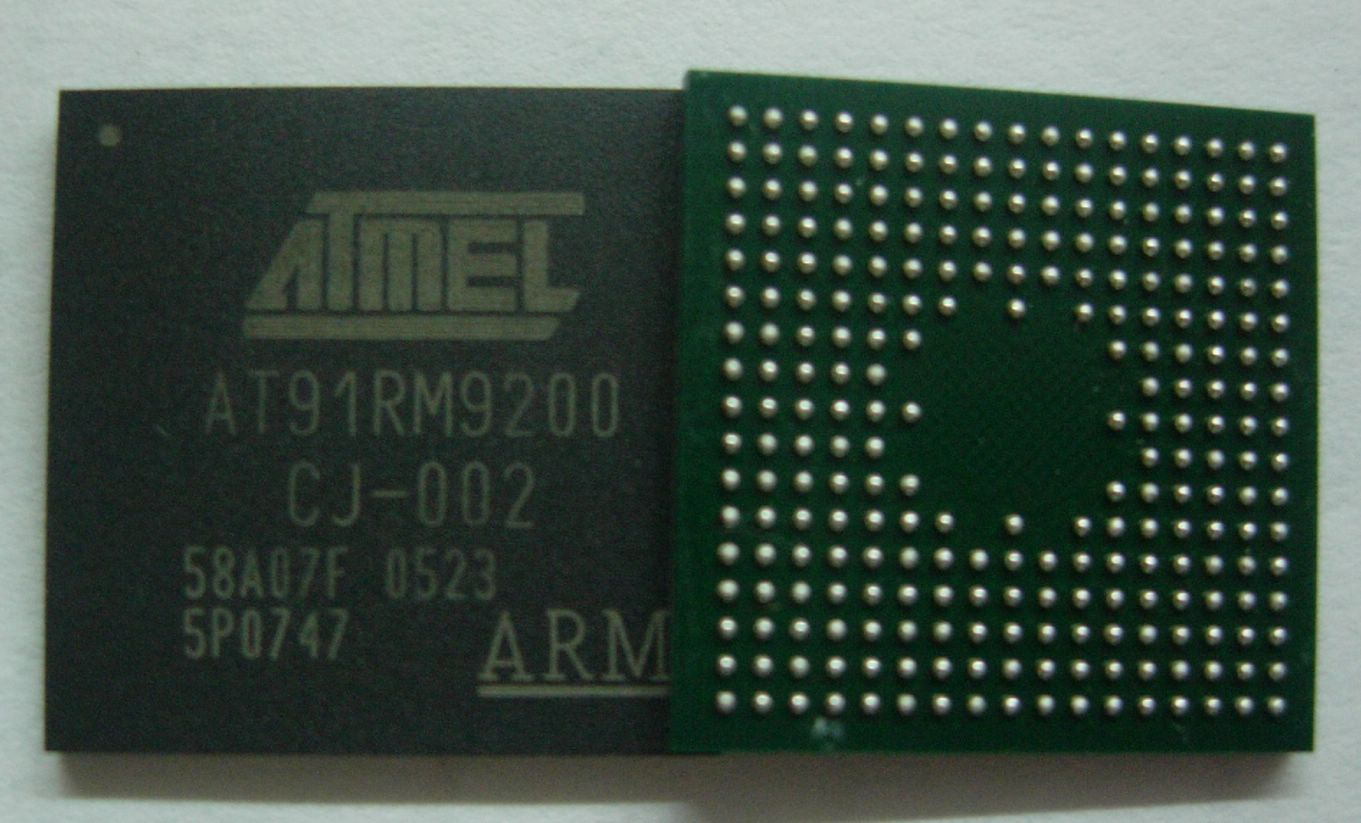
 BGA封裝記憶體
BGA封裝記憶體 TinyBGA封裝記憶體
TinyBGA封裝記憶體90年代隨著集成技術的進步、設備的改進和深亞微米技術的使用,LSI、VLSI、ULSI相繼出現,矽單晶片集成度不斷提高,對積體電路封裝要求更加嚴格,I/O引腳數急劇增加,...
BGA (Ball Grid Array)-球狀引腳柵格陣列封裝技術,高密度表面裝配封裝技術。在封裝底部,引腳都成球狀並排列成一個類似於格子的圖案,由此命名為BGA。目前主機板控制...
BGA的全稱Ball Grid Array(焊球陣列封裝),它是在封裝體基板的底部製作陣列焊球作為電路的I/O端與印刷線路板(PCB)互接。採用該項技術封裝的器件是一種表面貼裝...
所謂“封裝技術”是一種將積體電路用絕緣的塑膠或陶瓷材料打包的技術。以CPU為例,實際看到的體積和外觀並不是真正的CPU核心的大小和面貌,而是CPU核心等元件經過封裝...
FC-BGA(Flip Chip Ball Grid Array)這種被稱為倒裝晶片球柵格陣列的封裝格式,也是目前圖形加速晶片最主要的封裝格式。...
CPU封裝是採用特定的材料將CPU晶片或CPU模組固化在其中以防損壞的保護措施,一般必須在封裝後CPU才能交付用戶使用。CPU的封裝方式取決於CPU安裝形式和器件集成設計,從...
半導體封裝是指將通過測試的晶圓按照產品型號及功能需求加工得到獨立晶片的過程。封裝過程為:來自晶圓前道工藝的晶圓通過劃片工藝後被切割為小的晶片(Die),然後將切割...
CSP(Chip Scale Package)封裝,是晶片級封裝的意思。CSP封裝最新一代的記憶體晶片封裝技術,其技術性能又有了新的提升。CSP封裝可以讓晶片面積與封裝面積之比超過1:1....
所謂“封裝技術”是一種將積體電路用絕緣的塑膠或陶瓷材料打包的技術。以CPU為例,我們實際看到的體積和外觀並不是真正的CPU核心的大小和面貌,而是CPU核心等元件經過...
LGA全稱是Land Grid Array,直譯過來就是柵格陣列封裝,與英特爾處理器之前的封裝技術Socket 478相對應,它也被稱為Socket T。說它是“跨越性的技術革命”,主要在於...
即球柵陣列封裝技術。該技術的出現便成為CPU、主機板南、北橋晶片等高密度、高性能、多引腳封裝的最佳選擇。但BGA封裝占用基板的面積比較大。...
記憶體封裝是將記憶體晶片包裹起來,以避免晶片與外界接觸,防止外界對晶片的損害。空氣中的雜質和不良氣體,乃至水蒸氣都會腐蝕晶片上的精密電路,進而造成電學性能下降。不...
BGA返修台分光學對位與非光學對位,光學對位通過光學模組採用裂稜鏡成像;非光學對位則是通過肉眼將BGA根據PCB板絲印線及點對位,以達到對位返修。...
我們經常聽說某某晶片採用什麼什麼的封裝方式,在我們的電腦中,存在著各種各樣不同處理晶片,那么,它們又是是採用何種封裝形式呢?...
安裝半導體積體電路晶片用的外殼,起著安放、固定、密封、保護晶片和增強電熱性能的作用,而且還是溝通晶片內部世界與外部電路的橋樑——晶片上的接點用導線連線到封裝...
Fine-Pitch Ball Grid Array:細間距球柵陣列。FBGA(通常稱作CSP)是一種在底部有焊球的面陣引腳結構, 使封裝所需的安裝面積接近於晶片尺寸。BGA是英文Ball Grid ...
其實就是記憶體晶片所採用的封裝技術類型,封裝就是將記憶體晶片包裹起來,以避免晶片與外界接觸,防止外界對晶片的損害。空氣中的雜質和不良氣體,乃至水蒸氣都會腐蝕晶片上...
IC封裝,就是指把矽片上的電路管腳,用導線接引到外部接頭處,以便與其它器件連線。封裝形式是指安裝半導體積體電路晶片用的外殼。它不僅起著安裝、固定、密封、保護...
