高亮發光二極體(High brightness light emitting diodes,HBLED[1])綜合具備了高輸出、高效率和長壽命等優勢。製造商們正在開發能夠實現光通量更高、壽命更長、色彩更豐富而且單位功率發光度更高的器件。要確保其性能和可靠性,就必須在生產的每個階段實施精確的、成本經濟的測試。
基本介紹
- 中文名:高亮度LED測試
- 外文名:High brightness light emitting diodes,HBLED
- 特點:高輸出、高效率和長壽命
- 連線方式:可以採取串聯和/或並聯方式
定義概述,基本原理,測試類型,吞吐率,測試誤差,
定義概述
高亮發光二極體(High brightness light emitting diodes,HBLED[1])綜合具備了高輸出、高效率和長壽命等優勢。製造商們正在開發能夠實現光通量更高、壽命更長、色彩更豐富而且單位功率發光度更高的器件。要確保其性能和可靠性,就必須在生產的每個階段實施精確的、成本經濟的測試。
基本原理
雖然一個完整的測試程式可以包括數百個點,但對一個有限的樣本的探查一般就足以提供優值。許多HBLED測試需要以一個已知的電流信號源驅動器件並相應測量其電壓,或者反過來。同時具備了可同步動作的信號源和測量功能可以加速系統的設定並提升吞吐率。測試可以在管芯層次(圓片和封裝)或者模組/子組件水平上進行。在模組/子組件水平上,HBLED[2]可以採取串聯和/或並聯方式;於是一般需要使用更高的電流,有時達50A或者更高,具體則取決於實際套用。有些管芯級的測試所用的電流在5~10A的範圍內,具體取決於管芯的尺寸。圖1示出了典型的二極體的電I-V特性曲線[3]。
圖1. 典型的HBLED DC I-V曲線和測試點(未按比例繪出) 圖1 典型的HBLED DC I-V曲線和測試點
圖1 典型的HBLED DC I-V曲線和測試點
 圖1 典型的HBLED DC I-V曲線和測試點
圖1 典型的HBLED DC I-V曲線和測試點免費領取《克服高亮度LED特性分析與測試挑戰》CD[4]
測試類型
正向電壓測試
要理解新的結構單元材料,如石墨烯、碳納米管[5]、矽納米線[6]或者量子點,在未來的電子器件中是如何發揮其功效的,就必須採用那些能在很寬範圍上測量電阻、電阻率、遷移率和電導率的計測手段。這常常需要對極低的電流[7]和電壓進行測量。對於那些力圖開發這些下一代材料並使之商業化的工程師而言,在納米尺度上進行精確的、可重複的測量的能力顯得極為重要。
光學測試
光學測量中也需要使用正向電流偏置[8],因為電流與HBLED的發光量密切相關。可以用光電二極體或者積分球來捕捉髮射的光子,從而可以測量光功率。可以將發光變換為一個電流,並用電流計或者一個信號源-測量單元的單個通道來測量該電流。
反向擊穿電壓測試
對HBLED施加的反向偏置電流可以實現反向擊穿電壓[9](VR)的測試。該測試電流的設定應當使所測得的電壓值不再隨著電流的輕微增加而顯著上升。在更高的電壓下,反向偏置電流的大幅增加所造成的反向電壓的變化並不顯著。VR的測試方法是,在一段特定時間內輸出低反向偏置電流,然後測量HBLED兩端的電壓降。其結果一般為數十伏特。
漏電流測試
當施加一個低於擊穿電壓的反向電壓時,對HBLED兩端的漏電流[10](IL)的測量一般使用中等的電壓值。在生產測試中,常見的做法是僅確保漏電流不不至於超過一個特定的閾值。
吞吐率
過去,HBLED的生產測試的所有環節都由單台PC來控制。換而言之,在測試程式的每個要素中,必須針對每次測試配置信號源和測量裝置,並在執行預期的行動後,將書記返回給PC。控制PC根據通過/不通過的標準進行評估,並決定DUT應歸入哪一類。PC傳送指令和結果返回PC的過程將耗費大量的時間。
最新一代的智慧型儀器,包括吉時利公司最新的大功率2651A[11]系統信號源/測量儀(SourceMeter),由於可以最大限度減少通信的流量,從而可以大幅度提升測試吞吐率。測試程式的主體嵌入到儀器中的一個Test Script處理器[12](TSP®)中,該處理器是一個用於控制測試步驟的測試程式引擎,內置通過/不通過標準、計算和數字I/O的控制。一個TSP可以將用戶定義的測試程式存放到存儲器中,並根據用戶需要來執行該程式,從而減少了測試程式中每個步驟的建立和配置時間。
單器件的LED測試系統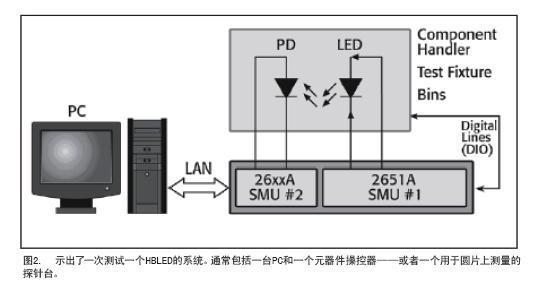 圖2
圖2
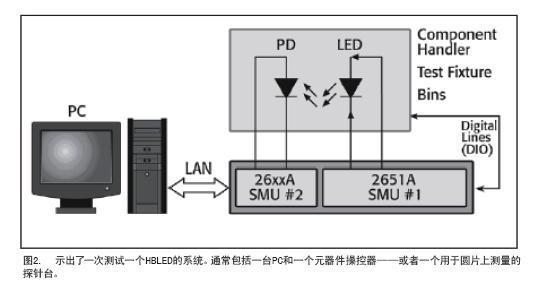 圖2
圖2元器件操控器將單個HBLED(或者一組HBLED)運送到一個測試夾具上,夾具可以禁止環境光,且內帶一個用於光測量的光電探測器(PD)[13]。需要使用兩個SMU:SMU#1向HBLED提供測試信號,並測量其電回響;SMU#2則在光學測量過程中檢測光電探測器。
測試程式可以被編程設定為,在一根來自於元器件操控器的數位訊號線[作為“測試啟動”(SOT)[14]]控制下啟動。當儀器探測到該信號時,測試程式啟動。一旦執行完畢,則讓元器件操縱器的一條數位訊號線發出“測試完畢”的標誌。此外,儀器的內建智慧型可以執行所有的通過/不通過操縱並通過儀器的數字I/O連線埠傳送數字指令至元器件操縱器,以便讓HBLED能根據通過/不通過標準來對HBLED進行分類。於是可以通過編程讓兩個動作同時執行:數據傳送至PC進行統計處理,而同時一個新的DUT[15]運送到測試夾具上。
測試誤差
多個HBLED器件的測試
老煉(burn-in)等套用需要對多個器件同時進行測量。
結的自加熱[16]是HBLED生產測試中最主要的誤差源之一。隨著結溫不斷升高,電壓降,或者更重要的是,漏電流,也隨之上升,因此如何最大限度縮短測試時間就極為重要。智慧型測試儀器可以簡化對器件的配置,並縮短其上升時間(該時間是指測試開始前任何電路電容實現穩定的時間)以及積分時間(該量決定了A-D轉換器[17]採集輸入信號的時間長短)。新型的SMU儀器[18],例如吉時利2651A,具有A-D轉換器,這些器件的採樣速度高達s/點,比高性能的積分式A-D轉換器快50倍。於是,更快的測量速度可以進一步縮短總的測試時間。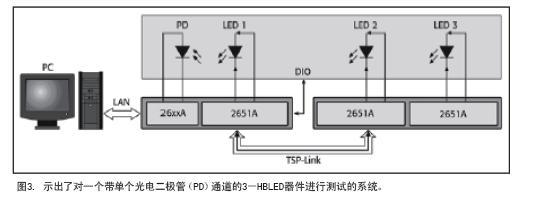 圖3
圖3
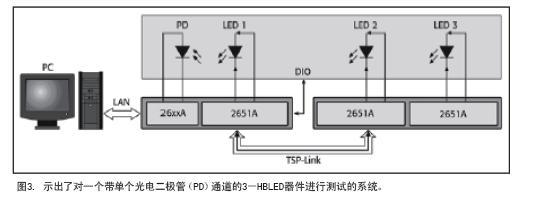 圖3
圖3脈衝測量技術的使用可以最大限度縮短測試時間和結的自加熱現象。當前具備高脈衝寬度解析度的SMU可以精確地控制對器件施加功率的時間長短。脈衝化的工作也可以讓這些儀器的輸出電流遠超出其DC輸出能力。
[

