表面貼裝技術,就是SMT(Surface Mounted Technology的縮寫),是目前電子組裝行業里最流行的一種技術和工藝。
基本介紹
- 中文名:表面貼裝技術
- 外文名:Surface Mounted Technology
- 同義詞:表面安裝技術;表面組裝技術
- 特點:組裝密度高、體積小、重量輕
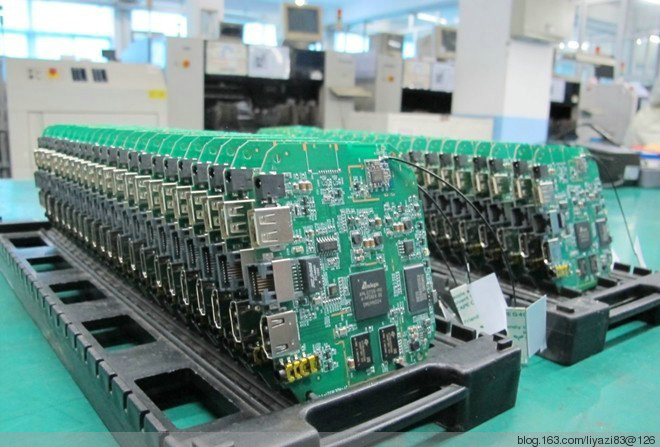
表面貼裝技術,就是SMT(Surface Mounted Technology的縮寫),是目前電子組裝行業里最流行的一種技術和工藝。
表面貼裝技術,就是SMT(Surface Mounted Technology的縮寫),是目前電子組裝行業里最流行的一種技術和工藝。...
《表面貼裝技術(SMT)》2013年5月由人民郵電出版社出版教材。作者是路文娟 陳華林 。本書可供高等職業院校電子工藝與管理及相關專業教學使用,也可供SMT培訓組織等...
IPC-A-610D和IPC-7711/7721授權認證培訓師。 國家級〈〈表面貼裝技 〉〉考評員。 87年開始從事THT電子組裝(主要是軍品電子組件的工藝和製程管理)。89年開始...
SMD:它是Surface Mounted Devices的縮寫,意為:表面貼裝器件,它是SMT(Surface Mount Technology)元器件中的一種。在電子線路板生產的初級階段,過孔裝配完全由人工來...
SMT是表面組裝技術(表面貼裝技術)(Surface Mount Technology的縮寫),稱為表面貼裝或表面安裝技術。是目前電子組裝行業里最流行的一種技術和工藝。它是一種將無引腳...
SMT貼片指的是在PCB基礎上進行加工的系列工藝流程的簡稱,PCB(Printed Circuit Board)為印刷電路板。SMT是表面組裝技術(表面貼裝技術)(Surface Mounted Technology的...
扁平封裝。表面貼裝型封裝之一。QFP 或SOP(見QFP 和SOP)的別稱。部分半導體廠家採用此名稱。17、flip-chip倒焊晶片。裸晶片封裝技術之一,在LSI 晶片的電極區...
表面安裝技術,簡稱SMT,作為新一代電子裝聯技術已經滲透到各個領域,SMT產品具有結構緊湊、體積小、耐振動、抗衝擊,高頻特性好、生產效率高等優點。SMT在電路板裝聯...
第1章表面貼裝技術概述1 1表面貼裝技術簡介1 1 1表面貼裝技術對貼片元器件的要求1 1 2表面貼裝技術常用術語1 1 3貼片元器件分類...
扁平封裝。表面貼裝型封裝之一。QFP 或SOP(見QFP 和SOP)的別稱。部分半導體廠家採用此名稱。17. flip-chip倒焊晶片。裸晶片封裝技術之一,在LSI 晶片的電極區...
SMT生產線也叫表面組裝技術(SurfaceMountTechnology簡稱SMT)是由混合積體電路技術發展而來的新一代電子裝聯技術,以採用元器件表面貼裝技術和回流焊接技術為特點,成為...
在20世紀70年代的表面貼裝技術(Surface Mount Technology,簡稱SMT),是指在印製電路板焊盤上印刷、塗布焊錫膏,並將表面貼裝元器件準確的貼放到塗有焊錫膏的焊盤上...
表面貼裝技術,主要利用貼裝機是將一些微小型的零件貼裝到PCB板上,其生產流程為:PCB板定位、印刷錫膏、貼裝機貼裝、過回焊爐和製成檢驗。隨著科技的發展,SMT也...
現代電子工藝與設計、電子元器件、印製電路技術、軟釺焊技術、電子裝聯技術、表面貼裝技術、調試與檢測以及電子技術檔案等內容,是電子工藝技術領域比較系統全面的參考...
