二元掩模(Binary Intensity Mask,BIM),也稱為雙極型掩模,是指由透光與不透光兩種部分組成的光掩模版。
基本介紹
- 中文名:二元掩模
- 外文名:Binary Intensity Mask
- 英文縮寫:BIM
二元掩模版是使用最多的一種掩模版,被廣泛用於365nm(I線)至193nm的浸沒式光刻。二元掩模是相對於移相掩模而言的。最常用的二元掩模遮光材料是Cr,因為其易於沉積在石英玻璃上,粘合性好,物理化學性質穩定,且便於使用硝酸鈰銨刻蝕液的濕法化學刻蝕。
常見的二元掩模(Cr掩模版)的製造流程示意圖如圖1所示,具體步驟如下:
- 掩模基板是石英玻璃,使用物理方法(PVD)沉積一層均勻的Cr薄膜;
- 在Cr沉積厚度達到要求值後,開始少量引入氧氣,O2與表面的Cr發生反應;
- 逐步增大O2的輸入量,使薄膜中O的含量形成梯度。Cr的厚度一般是55nm左右,CrOx的厚度是 18nm左右,一共是73nm左右;
- 旋塗光刻膠或電子膠,使用光束或者電子束曝光工藝產生圖形;
- 進行刻蝕工藝。
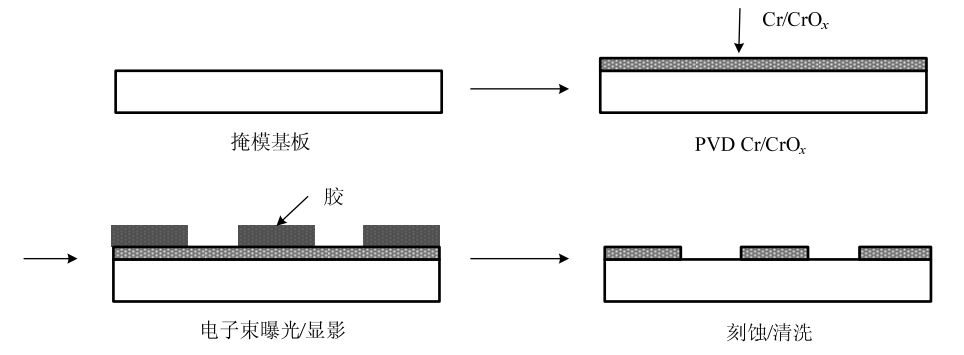
圖1 二元掩模(Cr掩模版)的製造流程示意圖
隨著掩模上圖形尺寸越來越小,Cr層越厚,光波與Cr相互作用越強,導致產生掩模三維效應。為了降低掩模三維效應,Cr的厚度已經被減少到不透光的極限,無法進一步減薄。在32nm技術節點之後,具有更高光密度的MoSi被用作吸收層的材料,取代Cr。掩模製造商依然在探索新型掩模材料,例如有的廠商提出使用鉭(Ta)作為掩模板的吸光層。